共用設備検索結果
中分類から探す
粒径測定装置 ゼータ電位・粒径測定システム(ゼータ電位、粒径・粒度分布) (Particle Size & Zeta-potential Analyzer)
- 設備ID
- NU-020
- 設置機関
- 名古屋大学
- 設備画像
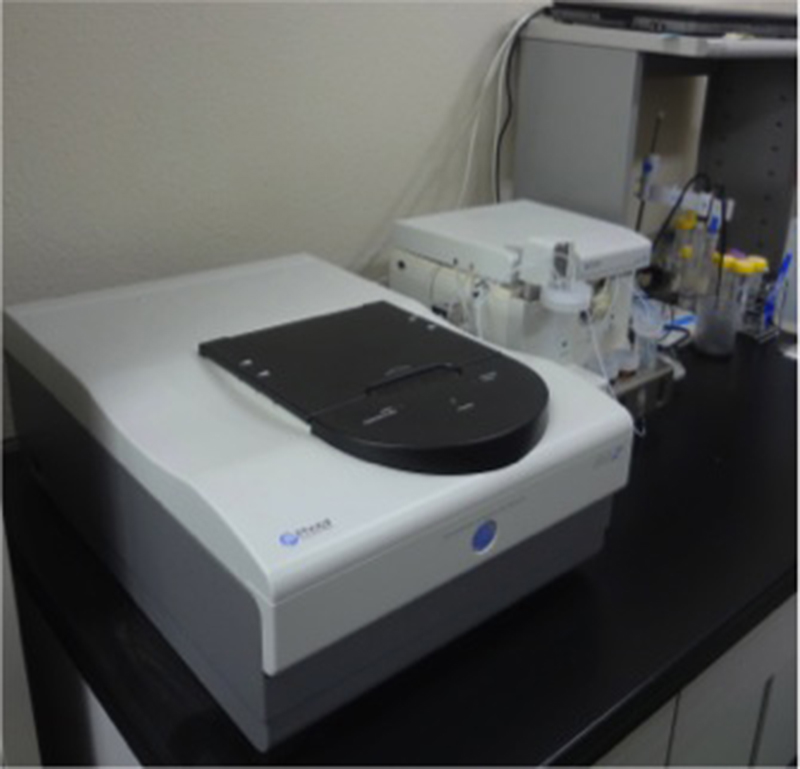
- メーカー名
- 大塚電子(株) (Otsuka Electronics)
- 型番
- ELSZ-2
- 仕様・特徴
- ・測定濃度範囲 :0.001 % ~ 10 %
・ゼータ電位 :-200 ~ 200 mV
・電気移動度 :-20×10-4~20×10-4cm2/V・s
・粒子径 :0.6 nm ~ 7000 nm
・温度 :10~90 ℃
・測定可能サンプル:微粒子分散液
・平板試料用セル(オプション)を用いた平板
・フィルム状サンプル測定にも対応しています。
・pHタイトレーター装備
・光学系:レーザードップラー法
低誘電率セル購入済み
小型微細形状測定機 (Surface profiler)
- 設備ID
- NU-220
- 設置機関
- 名古屋大学
- 設備画像
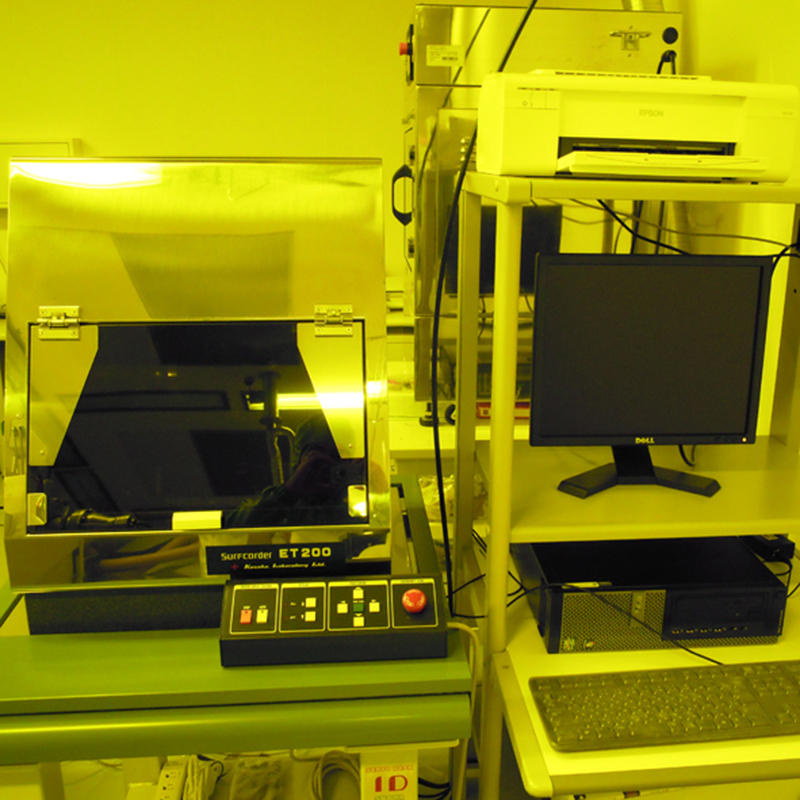
- メーカー名
- 小坂研究所 (Kosaka Laboratory)
- 型番
- ET200
- 仕様・特徴
- ・最大サンプルサイズ:φ160×厚さ48mm
・再現性 :1σ 1nm以内
・測定範囲 :Z:600 µm,X:100mm
・分解能 :Z:0.1 nm,X:0.1 µm
・測定力:10 µN〜500 µN
赤外透過評価検査・非接触厚み測定機 (Infrared MEMS Analyzer)
- 設備ID
- KT-227
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- (株)モリテックス (MORITEX Corporation)
- 型番
- IRise-T
- 仕様・特徴
- 赤外線により、非接触にて対象物の観察(内部観察)を行い、かつシリコンウェハ上の薄膜の厚みを測定することができる。
・基板 最大Φ8インチウェハー
・画像分解能 0.26μm/画素
・厚さ分解能 0.01μm以下( 5~150μm )
分光エリプソメーター (Spectral Ellipsometer)
- 設備ID
- KT-311
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- 大塚電子(株) (Otsuka Electronics Co., Ltd.)
- 型番
- FE-5000
- 仕様・特徴
- ・分光エリプソスペクトルの多波長同時測定
・基板(バルク)光学定数(n、k)が直接解析可能
・角度可変測定により、薄膜のより詳細な解析に対応
・測定膜厚範囲 1nm~1μm
・測定波長範囲 300nm~800nm
・サンプルサイズ 200mmx 200mm以上
ゼータ電位・粒径測定システム (Zeta Potential & Particle Size Analyzer)
- 設備ID
- KT-313
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- 大塚電子(株) (Otsuka Electronics Co., Ltd.)
- 型番
- ELSZ-2Plus
- 仕様・特徴
- 希薄から濃厚系試料のゼータ電位・粒子径測定が可能
・測定範囲 ゼータ電位:-200~200mV
・電気移動度:-20×10-4~20×10-4cm2/V・s
・粒子径:0.6nm~7μm
ダイナミック光散乱光度計 (Dynamic Light Scattering Spectrophotometer)
- 設備ID
- KT-314
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- 大塚電子(株) (Otsuka Electronics Co., Ltd.)
- 型番
- DLS-8000DH
- 仕様・特徴
- ・動的光散乱法
粒径分布、拡散係数分布を測定
・静的光散乱法
第二ビリアル係数・重量平均分子量・慣性半径の見積もり、重量平均分子量
・動的光散乱法:粒径分布、拡散係数分布測定
・静的光散乱法:第二ビリアル係数・重量平均分子量測定・慣性半径の見積もり
触針式段差計(CR) (Stylus Profilometer)
- 設備ID
- KT-332
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- Veeco社(株)アルバック (Veeco Instruments Inc.ULVAC, Inc.)
- 型番
- Dektak150
- 仕様・特徴
- (株)アルバック社製 Dektak150
垂直分解能(最高) 0.1nm
測定距離 50μm~55mm
サンプルステージサイズ 直径 150mm
触針式段差計(加工評価室) (Stylus Profilometer)
- 設備ID
- KT-333
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- Veeco社(株)アルバック (Veeco Instruments Inc.ULVAC, Inc.)
- 型番
- Dektak150
- 仕様・特徴
- (株)アルバック社製 Dektak150
垂直分解能(最高) 0.1nm
測定距離 50μm~55mm
サンプルステージサイズ 直径 150mm
ウエハプロファイラ (Optical Wafer Profiler)
- 設備ID
- KT-334
- 設置機関
- 京都大学
- 設備画像
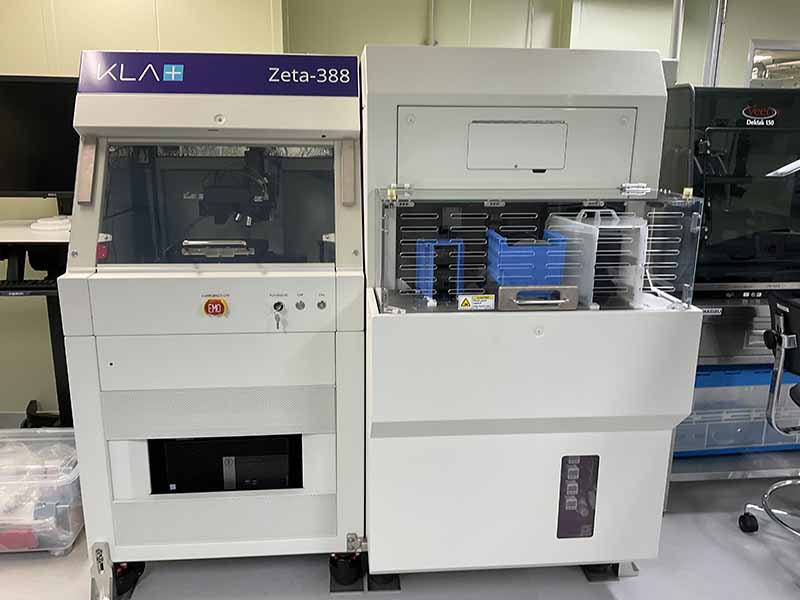
- メーカー名
- ケーエルエー・テンコール(株) (KLA Corporation)
- 型番
- Zeta-388
- 仕様・特徴
- 非接触の3D表面形状測定装置。完全自動計測の為のハンドラを備えている。マルチモード光学系によって、透明・不透明基板の表面粗さ、段差及び膜厚測定が可能。
ゼータ電位・粒径・分子量測定装置群 (Zeta-potential and particle analyzer system)
- 設備ID
- KU-513
- 設置機関
- 九州大学
- 設備画像

- メーカー名
- 大塚電子 (Otsuka Electronics)
- 型番
- ELSZ-2
- 仕様・特徴
- 【ゼータ電位/粒径測定システム:ELSZ-2】
・粒子径測定範囲(0.6-7000nm)
・ゼータ電位測定範囲(-200-200mV)
・測定濃度範囲:粒径0.00001-40%
・ゼータ電位濃度範囲:0.001-40%
・(希薄、濃厚試料対応)
・温調機能搭載、ゼータ電位の低誘電率溶媒測定対応
・平板試料用セルを用いた基板・フィルムのゼータ電位測定可能