共用設備検索結果
中分類から探す
エリプソメーター (Ellipsometer)
- 設備ID
- TT-016
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- ガ-トナ- (Gartner Sci. Corp.)
- 型番
- LSE
- 仕様・特徴
- ・シリコン酸化膜あるいはSiN膜等の単層あるいは2層膜の膜厚測定
・φ6インチ以下基板
分光エリプソメーター (Spectroscopic Ellipsometer)
- 設備ID
- NR-702
- 設置機関
- 奈良先端科学技術大学院大学 (NAIST)
- 設備画像
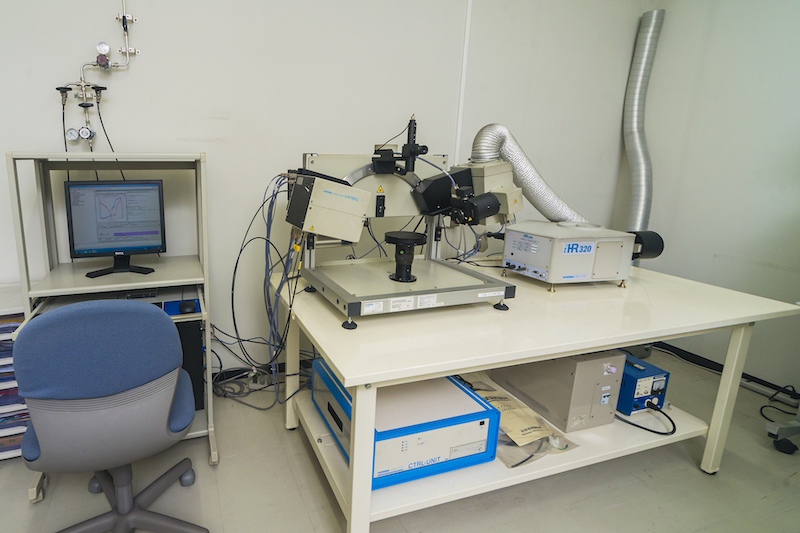
- メーカー名
- 堀場ージョバンイボン (HORIBA JOBIN YVON)
- 型番
- UVISEL ER AGMS-NSD
- 仕様・特徴
- ・波長範囲: 0.6 eV 〜 6.0 eV(206 nm 〜2066 nm )
・スポット径: 約 5 mm * 2 mm
分光エリプソメーター (Spectroscopic ellipsometer)
- 設備ID
- RO-531
- 設置機関
- 広島大学
- 設備画像
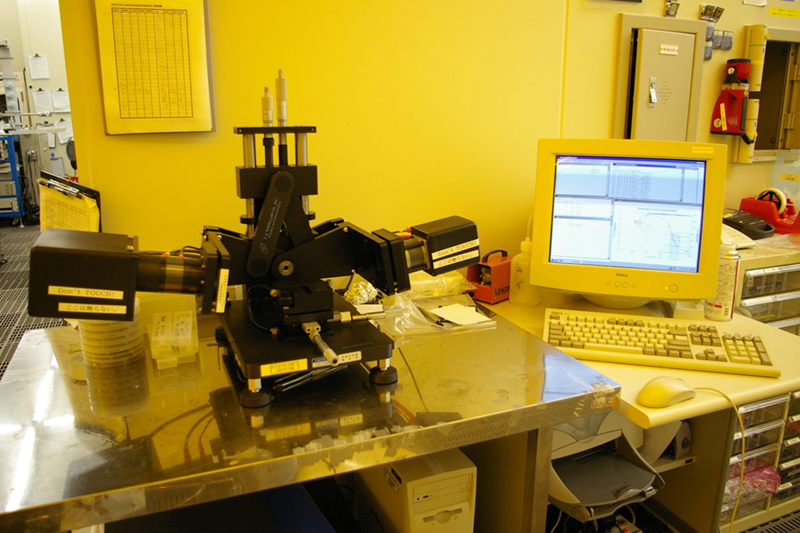
- メーカー名
- J.A. Woollam Japan (J.A. Woollam Japan)
- 型番
- M2000-D
- 仕様・特徴
- 測定可能最小膜厚10nm,分光波長範囲193~1000nm、
エリプソメータ (Film thickness measuring system)
- 設備ID
- GA-012
- 設置機関
- 香川大学
- 設備画像

- メーカー名
- 溝尻光学 (Mizojiri-opt)
- 型番
- DHA-XA/M8
- 仕様・特徴
- 膜厚と屈折率を測定可能
処理物:~12インチウェハ 光源波長:632.8nm(He-Neレーザー)
入射角:55°~75°,90°
入射角設定単位:0.01°
最小分解能:1Å
分布計測分解能:0.01mm
分光エリプソメーター [M2000] (Spectroscopic Ellipsometer [M2000])
- 設備ID
- NM-655
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![分光エリプソメーター [M2000]](data/facility_item/1687417245_11.jpg)
- メーカー名
- ジェー・エー・ウーラム・ジャパン株式会社 (J.A.Woollam Co., Inc.)
- 型番
- M2000
- 仕様・特徴
- ・波長範囲:250 ~ 1000 nm
・補償子:回転式
・入射角:自動制御、45~90°