共用設備検索結果
"膜厚測定"で検索した結果 10件
フリーワード検索
中分類から探す
光干渉式膜厚測定装置 (Film thickness measurement instruments)
- 設備ID
- GA-016
- 設置機関
- 香川大学
- 設備画像
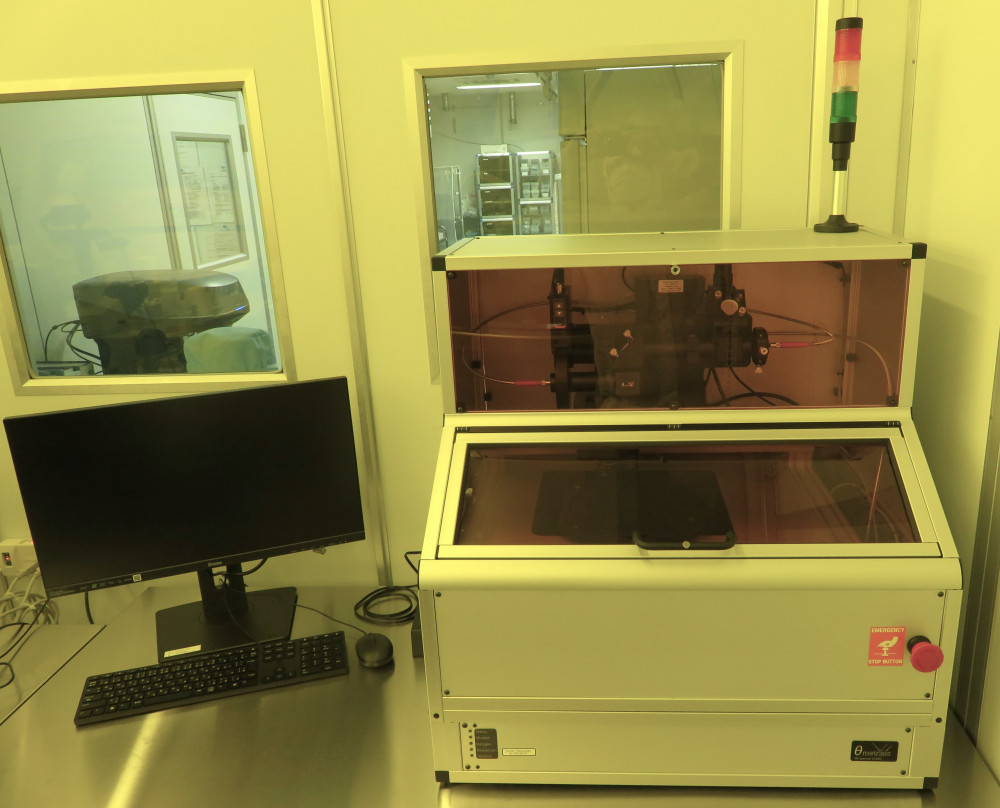
- メーカー名
- シータメトリシス (ThetaMetrisis)
- 型番
- FR-Scanner-AIO-Mic-XY200
- 仕様・特徴
- 測定膜厚範囲(SiO2):10nm – 80μm(10X)
測定精度:0.2% or 2nm
測定波長範囲:380nm~1020nm
多層膜測定:4層まで可能
測定スポット径:10,25,50,100μm
光源:ハロゲンランプ
サンプルサイズ:Max.200 x 200 mm
光学フィルター:Y-48、R-60
その他:自動マッピング
顕微分光膜厚計 [F54-XY-200-UV] (Optical Film Mapper [F54-XY-200-UV])
- 設備ID
- NM-624
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![顕微分光膜厚計 [F54-XY-200-UV]](data/facility_item/NM-624.jpg)
- メーカー名
- フィルメトリクス株式会社 (FILMETRICS)
- 型番
- F54-XY-200-UV
- 仕様・特徴
- ・用途:反射分光膜厚測定
・光源:重水素ハロゲンランプ
・波長:190-1100nm
・スポット径:10 μm以下
・測定膜厚範囲:5nm以下~30μm
・最大試料サイズ:φ8inch
・その他:自動マッピング、顕微式
膜厚計 (Film thickness measurement)
- 設備ID
- TU-302
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- ナノメトリクス (Nanometrics)
- 型番
- NanoSpec3000
- 仕様・特徴
- サンプルサイズ:小片~6インチ
赤外透過評価検査・非接触厚み測定機 (Infrared MEMS Analyzer)
- 設備ID
- KT-227
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- (株)モリテックス (MORITEX Corporation)
- 型番
- IRise-T
- 仕様・特徴
- 赤外線により、非接触にて対象物の観察(内部観察)を行い、かつシリコンウェハ上の薄膜の厚みを測定することができる。
・基板 最大Φ8インチウェハー
・画像分解能 0.26μm/画素
・厚さ分解能 0.01μm以下( 5~150μm )
分光エリプソメーター (Spectral Ellipsometer)
- 設備ID
- KT-311
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- 大塚電子(株) (Otsuka Electronics Co., Ltd.)
- 型番
- FE-5000
- 仕様・特徴
- ・分光エリプソスペクトルの多波長同時測定
・基板(バルク)光学定数(n、k)が直接解析可能
・角度可変測定により、薄膜のより詳細な解析に対応
・測定膜厚範囲 1nm~1μm
・測定波長範囲 300nm~800nm
・サンプルサイズ 200mmx 200mm以上
ウエハプロファイラ (Optical Wafer Profiler)
- 設備ID
- KT-334
- 設置機関
- 京都大学
- 設備画像
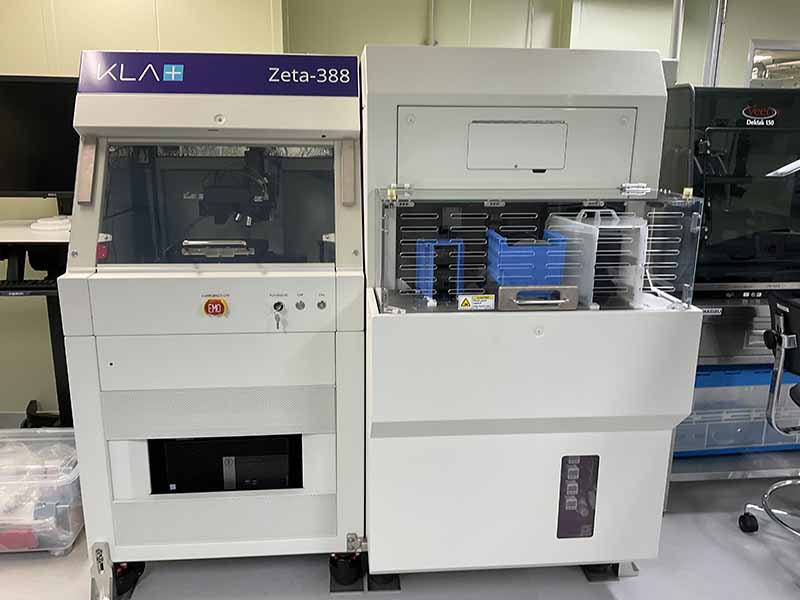
- メーカー名
- ケーエルエー・テンコール(株) (KLA Corporation)
- 型番
- Zeta-388
- 仕様・特徴
- 非接触の3D表面形状測定装置。完全自動計測の為のハンドラを備えている。マルチモード光学系によって、透明・不透明基板の表面粗さ、段差及び膜厚測定が可能。
光学干渉式膜厚計 ( Film thickness measurement instruments)
- 設備ID
- HK-626
- 設置機関
- 北海道大学
- 設備画像
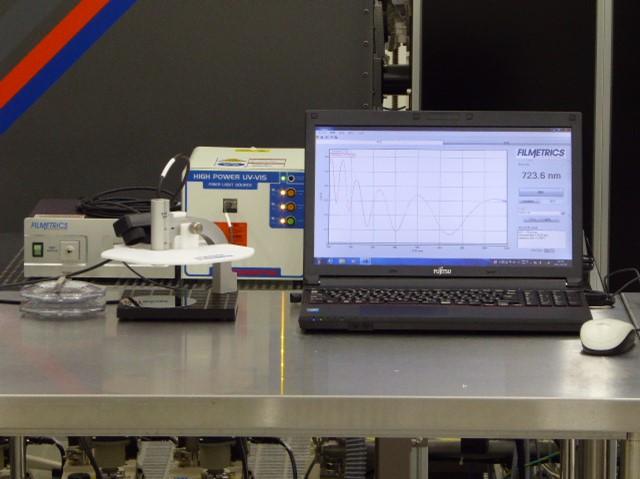
- メーカー名
- フィルメトリクス (Filmetrics)
- 型番
- F20-UV
- 仕様・特徴
- 膜厚測定範囲:1nm - 40µm
測定波長域:190-1100nm
触針式表面形状測定器(Dektak) (Stylus profilometer (Dektak))
- 設備ID
- CT-017
- 設置機関
- 公立千歳科学技術大学
- 設備画像

- メーカー名
- ブルカー (Bruker)
- 型番
- Dektak XT
- 仕様・特徴
- ・200 mmφ対応
・測定再現性 1σ=4 Å以下
接触式膜厚測定器 (Stylus Profiler)
- 設備ID
- OS-126
- 設置機関
- 大阪大学
- 設備画像
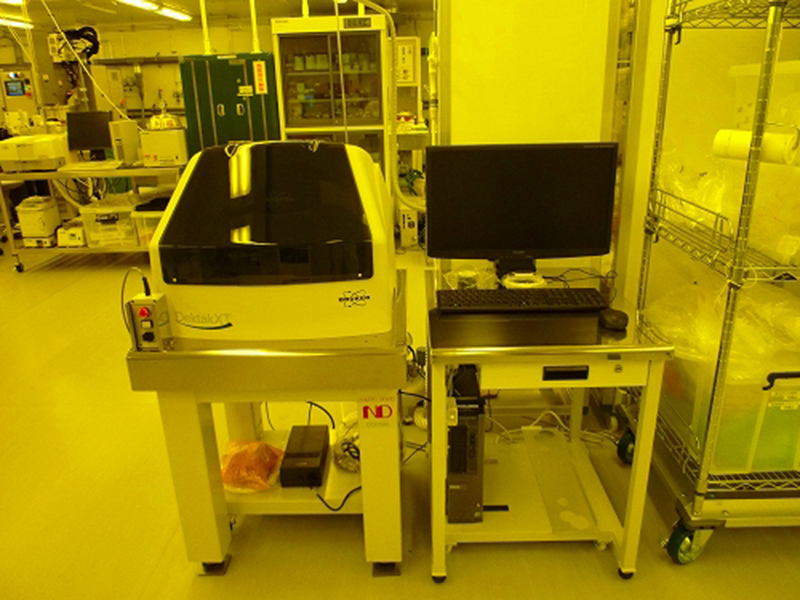
- メーカー名
- ブルカージャパン株式会社 (Bruker Japan K.K.)
- 型番
- DektakXT
- 仕様・特徴
- 【特徴】
10nm以下の段差を測定できる触針式の膜厚測定器です。
3D機能を備えたプロファイリングシステムを搭載しており、3Dマッピングが可能です。
【仕様】
試料ステージ:150mmφ
分解能:0.4nm
垂直測定レンジ:1 mm
膜厚測定再現性(1σ):5Å
走査距離上限:55mm
触針圧:1mg~15mg
干渉式膜厚計 (Spectroscopic reflectometer)
- 設備ID
- RO-532
- 設置機関
- 広島大学
- 設備画像
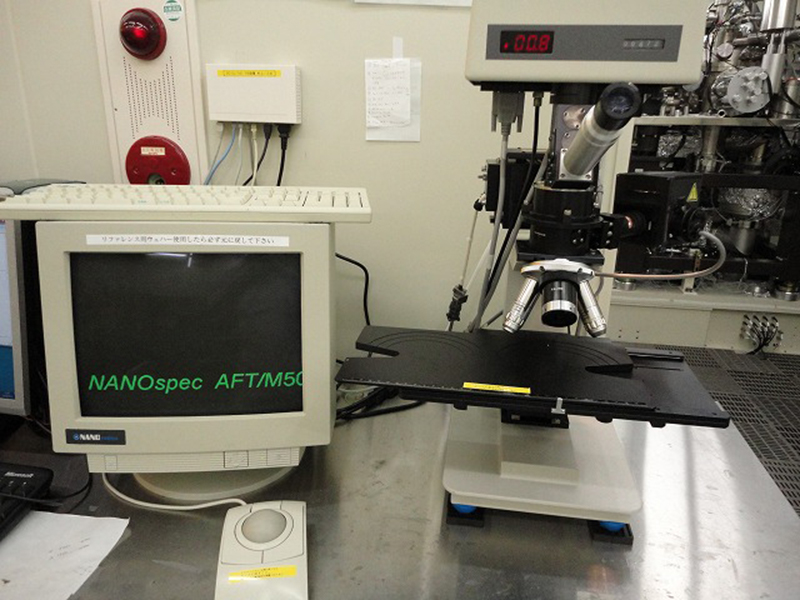
- メーカー名
- ナノメトリクスジャパン (Nanometrics Inc)
- 型番
- AFT 5000
- 仕様・特徴
- 可視光及び紫外光光源、多層膜対応解析ソフト搭載。
"膜厚測定"で検索した結果 10件