共用設備検索
共用設備検索結果
"微小加工装置"で検索した結果 66件
- 66件中 51~60件
- <
- 1
- 2
- 3
- 4
- 5
- 6
- 7
- >
- 設備ID
- BA-018
- 設置機関
- 筑波大学
- 設備画像

- メーカー名
- 日立ハイテク (Hitachi High-Tech)
- 型番
- IM4000PLUS
- 仕様・特徴
- 断面ミリングと平面ミリングに対応したハイブリッドタイプのイオンミリング装置
<断面ミリングホルダ>
使用ガス:Ar(アルゴン)ガス
加速電圧:0~6kV
最大ミリングレート(材料Si):500μm/hr以上
最大試料サイズ:20(W)×12(D)×7(H)mm
試料移動範囲:X ±7mm 、 Y 0~+3mm
<平面ミリングホルダ>
使用ガス:Ar(アルゴン)ガス
加速電圧:0~6kV
最大試料サイズ:Φ50 × 25(H) mm
試料移動範囲:X 0~+5mm
- 設備ID
- AT-032
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
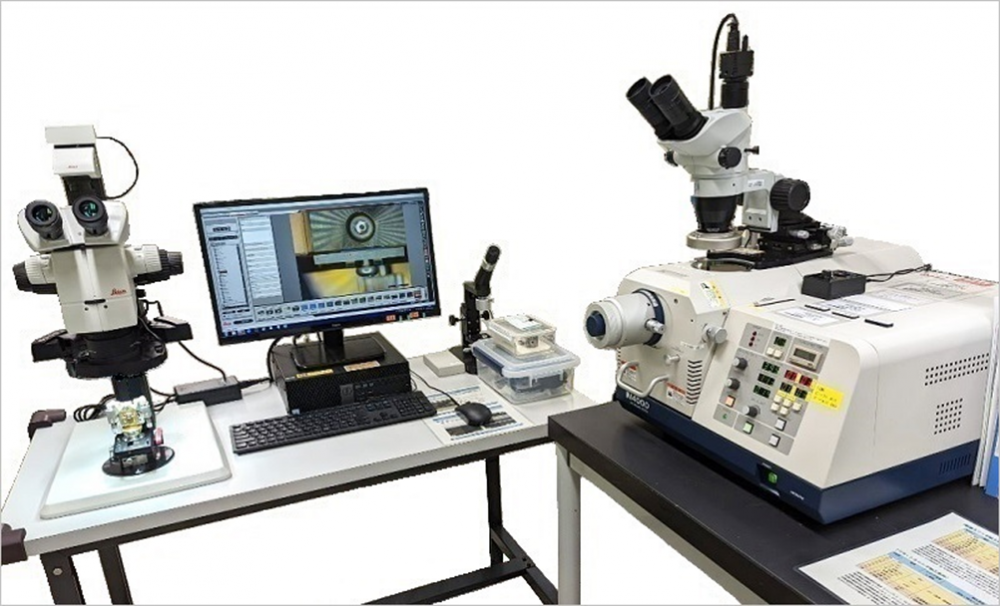
- メーカー名
- 日立ハイテクノロジーズ (Hitachi High-Tech)
- 型番
- IM4000
- 仕様・特徴
- ・型式:IM4000
・試料サイズ:15mm(W)×15mm(D)×7mm(H)
・イオンガン:冷陰極ペニング型
・使用ガス:アルゴン
・加速電圧:1~6kV
・放電電圧:1.5kV
・断面ミリングレート:100~300µm/h (加速電圧6kV時) ※材料により異なる
・スイング角度:OFF~±40°
- 設備ID
- AT-033
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
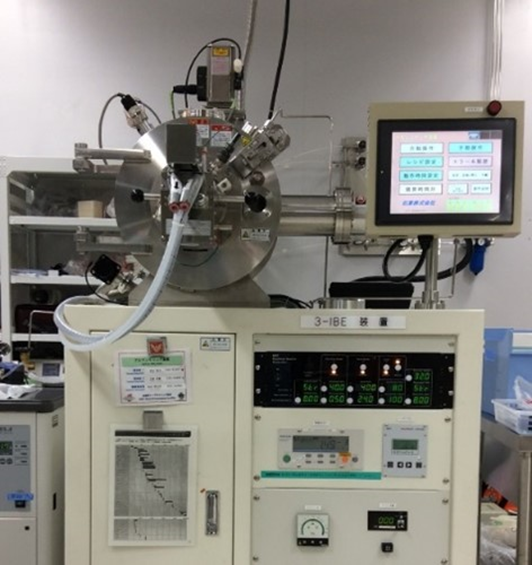
- メーカー名
- 伯東 (Hakuto)
- 型番
- 3-IBE
- 仕様・特徴
- 形式:3-IBE カウフマン型DCイオン源
試料サイズ:最大4インチ
ミリングガス:Ar
ビーム加速電圧:100~1200V
イオン入射角:-90°~90°(0°が試料表面に垂直入射)
- 設備ID
- AT-034
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- 日立ハイテクノロジーズ (Hitachi High-Tech)
- 型番
- FB-2100
- 仕様・特徴
- ・型式:FB-2100
・試料サイズ: 18mmφ以下, 高さ10mm以下
・イオン源:ガリウム液体金属イオン源
・加速電圧:2kV, 5kV, 10kV~40 kV (低加速電圧対応)
・像分解能:6 nm (SIM)
・ビーム径:3µm, 1.3µm, 600 nm, 320 nm, 120 nm, 60 nm, 10 nm
・イオンビーム電流:0.1nA~68nA (大電流対応)
・デポジションガス:タングステンカルボニル
・マニュピレータシステム:シングルプローブ
・試料ステージ制御:5軸チルトステージ
・ステージ傾斜角度:最大45°
- 設備ID
- AT-098
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
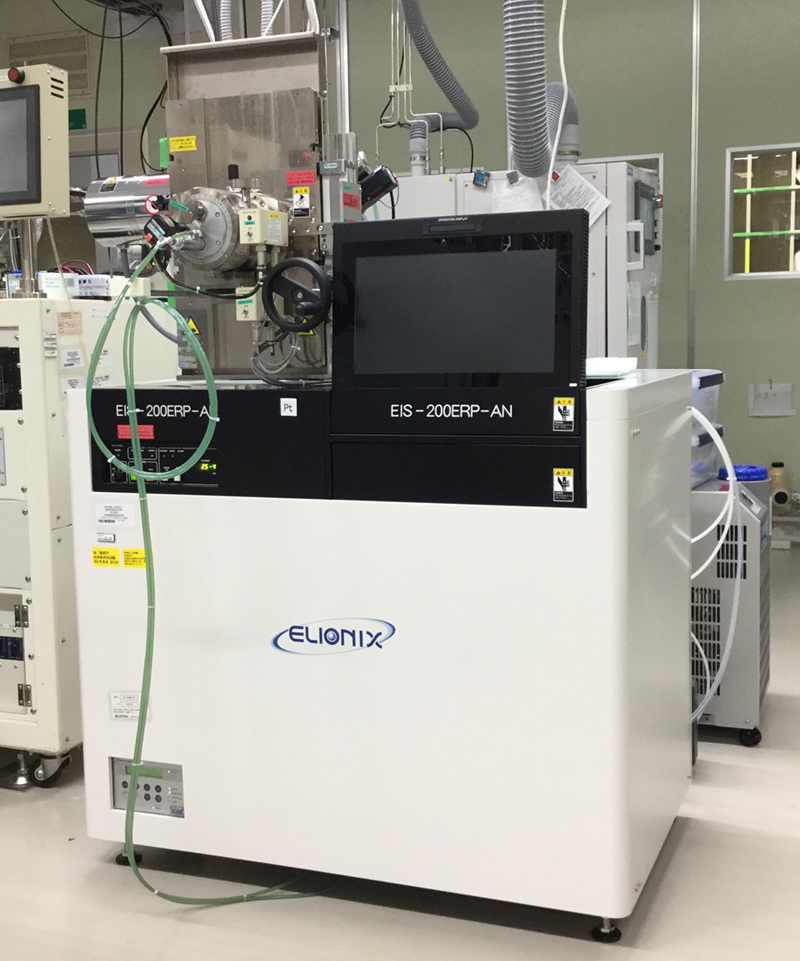
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- EIS-200ERP
- 仕様・特徴
- ・型式:EIS-200ERP
・試料サイズ:75 mmφ
・イオンソース:ECR方式
・ガス種:Ar (最大流量5sccm)
・圧力:0.01 Pa
・加速電圧:30~3000 V
・マイクロ波:最大100 W
・材料ターゲットサイズ:100 mmφ
- 設備ID
- WS-010
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- 株式会社 日立ハイテク (Hitachi High-Tech Corporation)
- 型番
- NB-5000
- 仕様・特徴
- FIB加工中の同時SEM観察可能
~80万倍, 試料サイズ最大30mmΦ
エネルギー分散型X線元素分析機能(EDAX)
・ シリコンドリフトディテクター (SDD検出器)
・ エネルギー分解能: 133eV以下
・ 検出元素:B~U
・ 定性分析/定量分析/マッピング機能搭載
STEM機能付き(薄膜化した後の高精度観察が可能)
- 設備ID
- IT-023
- 設置機関
- 東京工業大学
- 設備画像
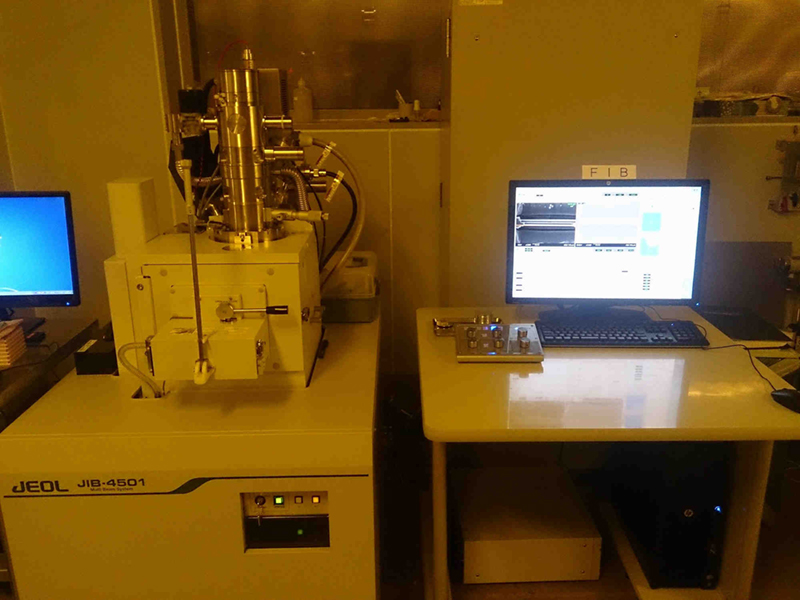
- メーカー名
- 日本電子 (JEOL)
- 型番
- JIB-4501
- 仕様・特徴
- FIB部分 Ga 液体金属イオン源、加速電圧 1-30kV,ビーム電流最大60nA以上 SEM部分 加速電圧0.3-30kV 分解能 3nm以下
- 設備ID
- JI-016
- 設置機関
- 北陸先端科学技術大学院大学(JAIST)
- 設備画像
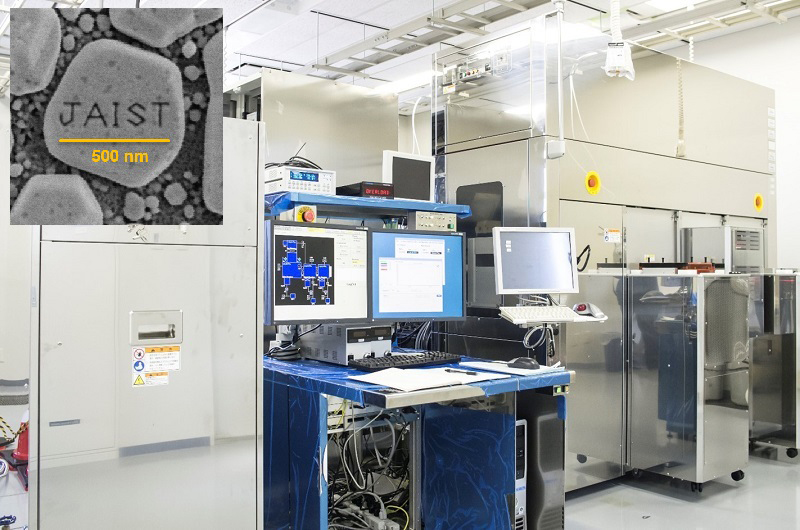
- メーカー名
- 日立ハイテクサイエンス (Hitachi High-Tech Science)
- 型番
- MR-GFIS
- 仕様・特徴
- N2イオンビームによる低汚染のFIB加工
最少加工幅:約10nm
- 設備ID
- SH-007
- 設置機関
- 信州大学
- 設備画像
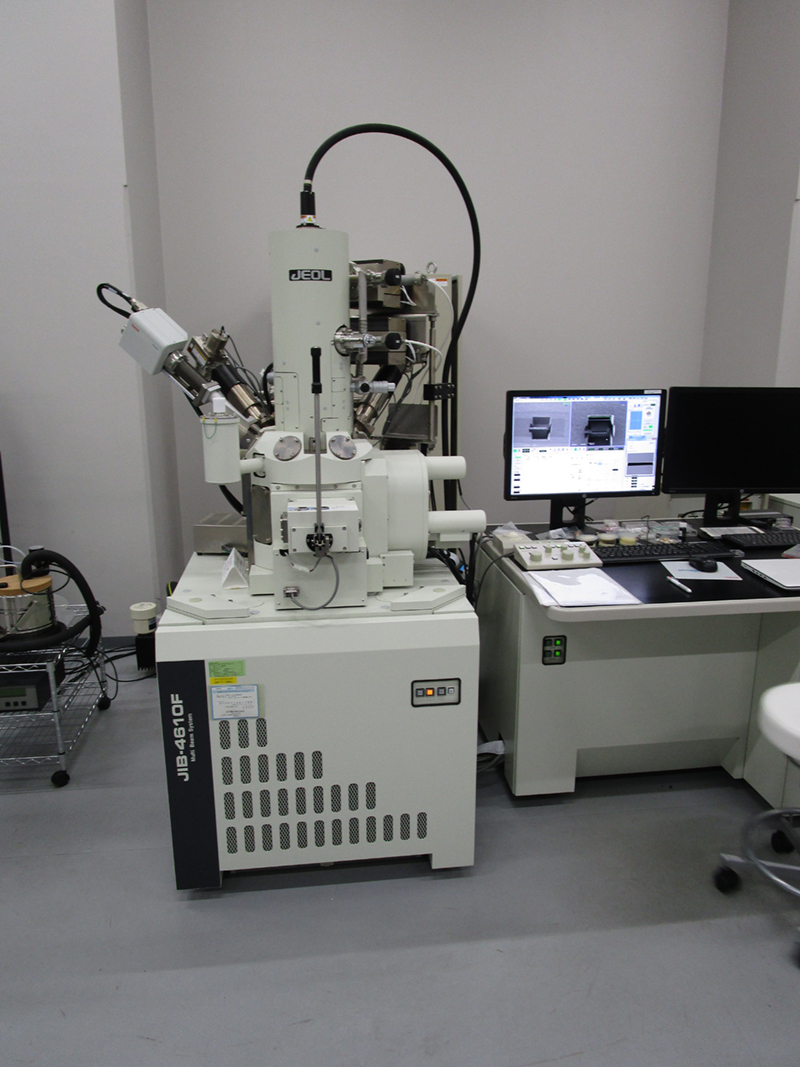
- メーカー名
- 日本電子 (JEOL)
- 型番
- JIB-4610F
- 仕様・特徴
- FE-SEM 加速電圧 0.1~30kV
FIB 分解能4nm 加速電圧 1~30kV
Cryoオプション付き ピックアップシステム付き
- 設備ID
- NI-001
- 設置機関
- 名古屋工業大学
- 設備画像
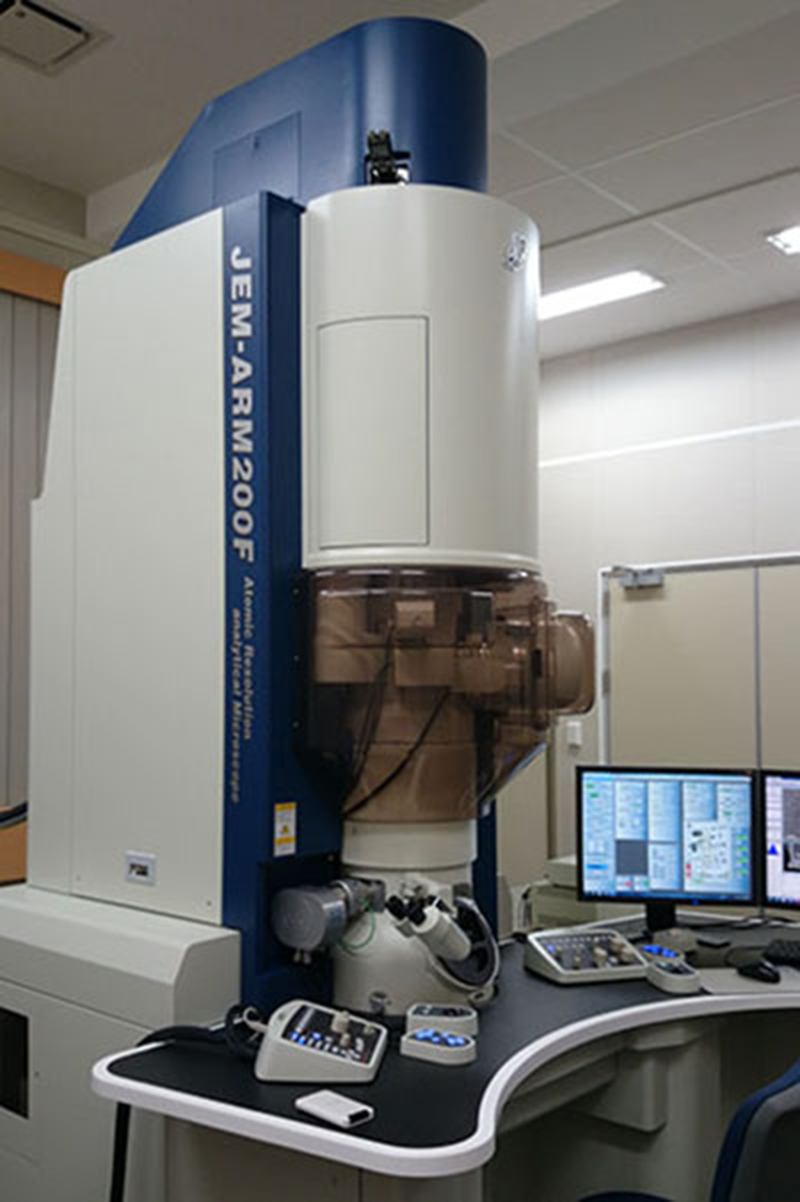
- メーカー名
- 日本電子/ガタン (JEOL/Gatan, Inc./Gatan, Inc.)
- 型番
- JEM-ARM200F/PIPS II/Model 656
- 仕様・特徴
- ●走査透過電子顕微鏡(JEM-ARM200F)
加速電圧:80kV・200kV,電子銃:冷陰極電界放出型
EDS、EELS、デジタルCCDカメラシステム付設
●イオンミリング装置(PIPS II)
高精度で無機化合物、金属、複合材料などをAr+イオンにより研磨できる。イオン銃加速電圧:0.1~7kV 冷却ステージあり
●ディンプルグラインダー(Model 656)
イオンミリングの前処理として固体板状試料に3mmΦ以下のくぼみをつけることができる。
"微小加工装置"で検索した結果 66件
- 66件中 51~60件
- <
- 1
- 2
- 3
- 4
- 5
- 6
- 7
- >