共用設備検索結果
"イオンミリング(断面加工)"で検索した結果 9件
フリーワード検索
大気非暴露対応冷却クロスセクションポリッシャ (Cooling cross section polisher for non-exposure to atmosphere)
- 設備ID
- UT-158
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- IB-19520CCP
- 仕様・特徴
- イオン加速電圧 2~8kV
ミリングスピード 500μm/h以上 (加速電圧8kV)
試料スイング機能±30°自動スイング
自動加工開始モード 〇
自動冷却加工開始モード /
自動室温復帰モード 〇
試料ステージ冷却到達温度 -120°C以下
冷却温度設定範囲 -120~0°C
試料冷却-100°C到達時間 60分以内
試料冷却保持時間 8時間以上
クライオイオンスライサ― (CRYO ION SLICER)
- 設備ID
- KT-409
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- 日本電子 (JEOL)
- 型番
- IB-09060CIS
- 仕様・特徴
- 1.アルゴンビーム薄片化装置(電圧1~8kV)
2.試料傾斜角最大±6度
3.クライオステージ(-120℃)
薄膜断面試料作製装置 (Ion Slicer)
- 設備ID
- TU-518
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- 日本電子 (JEOL)
- 型番
- EM-09100IS
- 仕様・特徴
- ・イオン加速電圧 1~8 kV
・イオン照射角度 0~6°
クロスセクションポリッシャー(CP) (Cross Section Polisher)
- 設備ID
- UT-153
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JEOL SM-090010JEOL SM-090020
- 仕様・特徴
- □ 主な特徴
表面に対して垂直な断面が制作可能。
□ 主な仕様
イオン加速電圧:2 ~ 6 kV
イオンビーム径半値幅:500 μm(加速電圧:6kV, 試料:Si)
ミリングスピード:1.3 μm/min以上(加速電圧:6kV, 試料:Si)
最大搭載試料サイズ:11mm×9mm×2mm
試料移動範囲:X軸±3mm Y軸:±3mm
試料角度調節範囲:±5°
使用ガス:アルゴンガス
SEM用断面試料作製装置 (Cross section polisher)
- 設備ID
- NU-253
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- JEOL (JEOL)
- 型番
- SM-09010
- 仕様・特徴
- ・イオン加速電圧:2~6 kV
・イオンビーム径:500 μm(半値幅)
・最大搭載試料サイズ:幅11 mm × 長さ10 mm × 厚さ2 mm
・試料移動範囲:X軸:±3 mm,Y軸:±3 mm
イオンミリング (Ion Milling System)
- 設備ID
- BA-018
- 設置機関
- 筑波大学
- 設備画像

- メーカー名
- 日立ハイテク (Hitachi High-Tech)
- 型番
- IM4000PLUS
- 仕様・特徴
- 断面ミリングと平面ミリングに対応したハイブリッドタイプのイオンミリング装置
<断面ミリングホルダ>
使用ガス:Ar(アルゴン)ガス
加速電圧:0~6kV
最大ミリングレート(材料Si):500μm/hr以上
最大試料サイズ:20(W)×12(D)×7(H)mm
試料移動範囲:X ±7mm 、 Y 0~+3mm
<平面ミリングホルダ>
使用ガス:Ar(アルゴン)ガス
加速電圧:0~6kV
最大試料サイズ:Φ50 × 25(H) mm
試料移動範囲:X 0~+5mm
クロスセクションポリッシャー(ALD付帯) (Cross Section Polisher)
- 設備ID
- AT-032
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
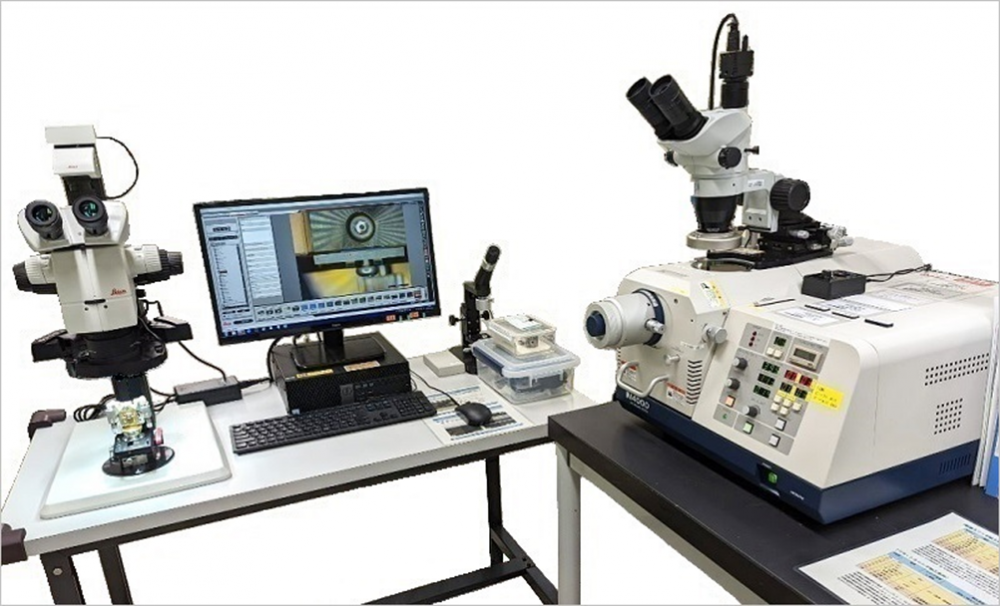
- メーカー名
- 日立ハイテクノロジーズ (Hitachi High-Tech)
- 型番
- IM4000
- 仕様・特徴
- ・型式:IM4000
・試料サイズ:15mm(W)×15mm(D)×7mm(H)
・イオンガン:冷陰極ペニング型
・使用ガス:アルゴン
・加速電圧:1~6kV
・放電電圧:1.5kV
・断面ミリングレート:100~300µm/h (加速電圧6kV時) ※材料により異なる
・スイング角度:OFF~±40°
アルゴンミリング装置 (Argon Ion Milling System)
- 設備ID
- AT-033
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
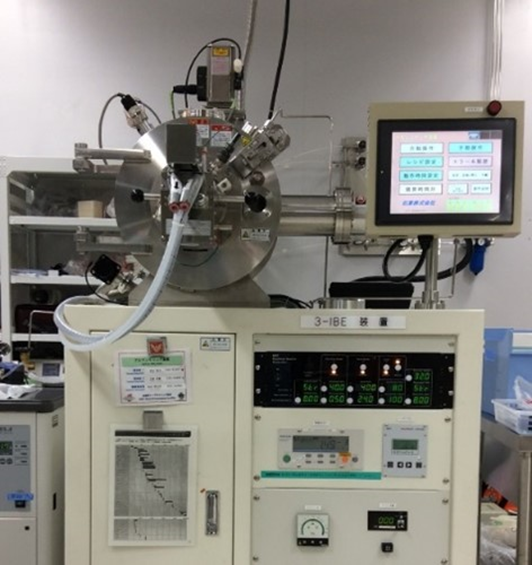
- メーカー名
- 伯東 (Hakuto)
- 型番
- 3-IBE
- 仕様・特徴
- 形式:3-IBE カウフマン型DCイオン源
試料サイズ:最大4インチ
ミリングガス:Ar
ビーム加速電圧:100~1200V
イオン入射角:-90°~90°(0°が試料表面に垂直入射)
ECRスパッタ成膜・ミリング装置 (ECR sputter deposition and milling system)
- 設備ID
- AT-098
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
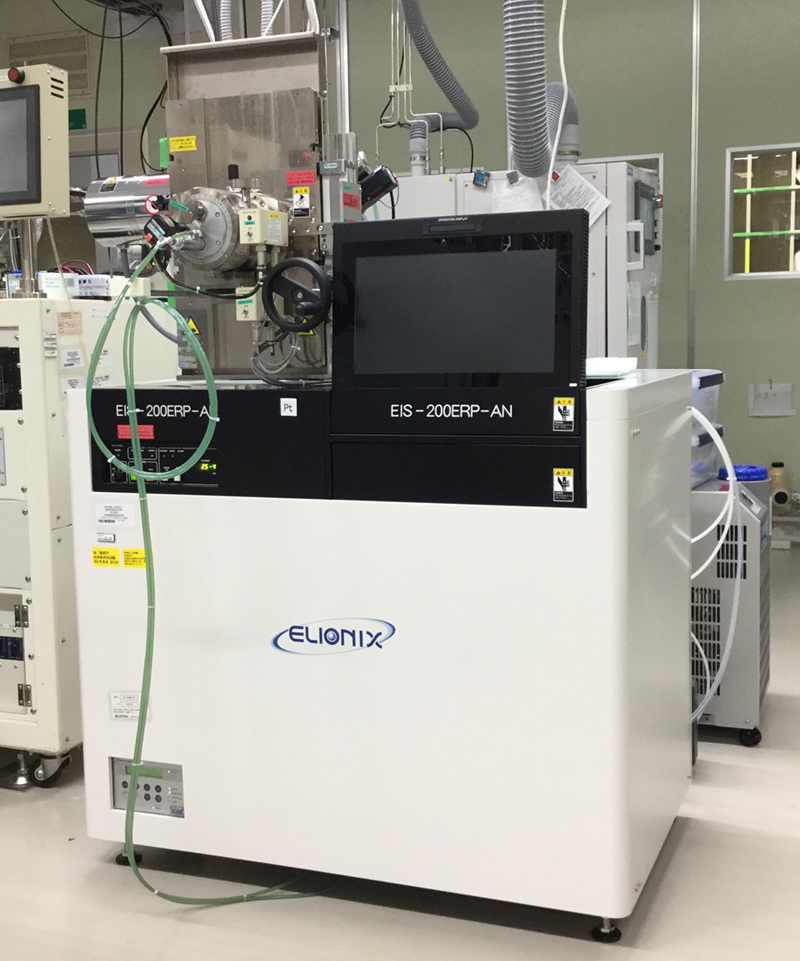
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- EIS-200ERP
- 仕様・特徴
- ・型式:EIS-200ERP
・試料サイズ:75 mmφ
・イオンソース:ECR方式
・ガス種:Ar (最大流量5sccm)
・圧力:0.01 Pa
・加速電圧:30~3000 V
・マイクロ波:最大100 W
・材料ターゲットサイズ:100 mmφ
"イオンミリング(断面加工)"で検索した結果 9件