共用設備検索
共用設備検索結果
- 設備ID
- AT-004
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
![電界放出形走査電子顕微鏡[S4800_FE-SEM]](data/facility_item/1651474199_14.jpg)
- メーカー名
- 日立ハイテクノロジーズ (Hitachi High-Tech)
- 型番
- S4800
- 仕様・特徴
- ・型式:S-4800
・試料サイズ:15~150 mmφ
・電子銃:冷陰極電界放出型電子銃
・加速電圧:0.5~30 kV
・分解能:1.0 nm(加速電圧15 kV, WD = 4 mm)
・試料ステージ制御:5軸モーター制御
・可動範囲:X,Y:0~110 mm、Z:1.5~40 mm、R:360°、T:-5~70°
・検出器:2次電子検出器、エネルギー分散型X線検出器(EDX)
- 設備ID
- AT-005
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- 日立ハイテクノロジーズ (Hitachi High-Tech)
- 型番
- S-3500N
- 仕様・特徴
- ・型式:S-3500N(日立ハイテク)
・試料サイズ:15~150 mmφ
・電子銃:熱電子放出型Wヘアピンフィラメント
・加速電圧:0.3~30 kV
・分解能:高真空二次電子像:3.0 nm
・低真空反射電子像:5 nm
・低真空モードでの真空度設定:1~270 Pa
・試料ステージ:五軸モーター駆動
・可動範囲:100 mm×50 mm
・元素分析:エネルギー分散型X線検出器(EDX)
- 設備ID
- AT-046
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
![走査プローブ顕微鏡SPM_1[NanoscopeⅣ/Dimension3100]](data/facility_item/AT-046.jpg)
- メーカー名
- デジタルインスツルメンツ (Veeco/Digital Instruments )
- 型番
- NanoscopeⅣ/Dimension3100
- 仕様・特徴
- ・型式:NanoscopeⅣ/Dimension3100(Veeco社製)
・試料サイズ:150 mm以内(面範囲)、12 mm(高さ範囲)
・試料固定:真空チャック
・測定範囲:90 μm×90 μm(面範囲)、6 μm以内(高さ範囲)
・測定精度:最大2%(最大レンジ幅)
- 設備ID
- AT-047
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
![走査プローブ顕微鏡SPM_2[SPM-9600/9700]](data/facility_item/AT-047.jpg)
- メーカー名
- 島津製作所 (SHIMADZU)
- 型番
- SPM-9700
- 仕様・特徴
- ・型式:SPM-9700
・試料サイズ:24mmφ×8mm
・試料固定:マグネットによる固定
・スキャナ走査範囲:125μm×125μm×7μm
・分解能: 0.2nm(水平)、0.01nm(垂直)
・測定モード:ダイナミック、コンタクト、位相、電流、表面電位(KFM)
- 設備ID
- AT-048
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
![ナノサーチ顕微鏡SPM_3[SFT-3500]](data/facility_item/1651474557_14.jpg)
- メーカー名
- 島津製作所 (SHIMADZU)
- 型番
- SFT_3500
- 仕様・特徴
- ・型式:SFT_3500
・試料サイズ:6インチφ、最大高さ:54.5mm
・ステージストローク:100×100mm
LSM部
・観察視野:2,560μm~21μm
・対物レンズ:5×, 20×, 100× (光学ズーム 1×~6×)
SPM部
・最大走査範囲:30μm(X,Y)、4μm(Z)
・垂直分解能:0.1nm程度
・検出方式:光てこ方式
・測定モード:ダイナミックモード(タッピングモード)、コンタクトモード、位相モード、表面電位モード[KFM]、電流モード
- 設備ID
- AT-107
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
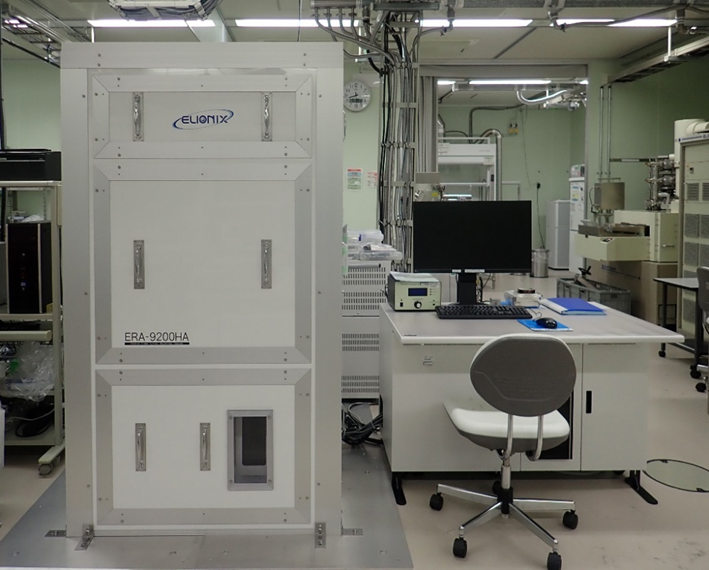
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ERA-9200
- 仕様・特徴
- ・型式:ERA-9200
・試料サイズ:4インチφ, 16mmt
・電子銃:ZrO/W熱電界放射型
・加速電圧:1~30 kV
・リタ―ディング電圧:3kV
・分解能:0.4nm以下(30kV)、0.5nm以下(15kV)、0.7nm以下(1kV)
・可動範囲:30×50mm(X-Y)、1~30mm(Z)、-5~45°(Tilt)
・検出器:2次電子検出器(4本)
- 設備ID
- AT-504
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- (1) RSPM1: 日本電子、(2) RSPM2: SII(現・日立ハイテクサイエンス) ((1) RSPM1: JEOL, (2) RSPM2: SII (Hitachi Hitech Scinece))
- 型番
- (1) RSPM1:日本電子(JEOL)社製JSPM5400、(2) RSPM2:SIIナノテクノロジー(現・日立ハイテクサイエンス)社E-SWEEP/S-Image
- 仕様・特徴
- (1) RSPM1
分光(赤外)原子間力顕微鏡、走査型トンネル顕微鏡
・型式: NEA SNOM
・設置室名: 2-1D棟125室
・測定機能: AM-AFM、コンタクトモード、高分解能赤外分光
・測定環境: 大気中
・試料サイズ:(10mm角)や厚さの制限有
・空間分解能<100nmのナノ赤外分光(Nano-FTIR)
(2) RSPM2
E-SWEEP/NEX(高速原子間力顕微鏡)
・測定機能: AM-AFM、コンタクトモード、STM、KFM、Conductive-AFM
・制御装置: 1台のNanonaviをS-ImageおよびE-SWEEPで切り替えて利用
・測定環境: 大気中、恒湿度雰囲気(20~70%)、液中、真空中(10E-5[Torr])
・温度範囲(E-SWEEP): -100 ℃ ~ 300 ℃(ヒータのみ、制御なし)
・試料サイズ: 最大15 mm角程度
・液中リアルタイム測定可能(毎秒10フレーム)
前処理装置等
・標準試料: 探針評価、スケール、段差等
・付帯設備
研磨機、プラズマクリーナ、白色干渉計、反射分光膜厚計、化学ドラフト、フーリエ赤外分光計(ATRのみ)、レーザードップラー干渉計(カンチレバーのばね定数校正)
- 設備ID
- AT-506
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- ・検出器:産総研自主開発 ・顕微鏡:JEOL (・Detector: AIST Original ・SEM: JEOL)
- 型番
- ・検出器:産総研自主開発 ・顕微鏡:JSM-IT800SHLs
- 仕様・特徴
- 高感度、高分解能の超伝導検出器を搭載した、蛍光X線検出器付走査型電子顕微鏡。
電子線で試料上を走査する際に放出される蛍光X線を測定することにより、主に軽元素の分布状態を評価できる。半導体エネルギー分散型検出器、シンチレーション型反射電子検出器も搭載。試料を冷却しながらの計測も可能。大気非暴露搬送、装置内での昇華、割断、コーティングが可能。
・蛍光X線エネルギー範囲:
40 eV-4 keV(超伝導)、200 eV- 20 keV(半導体)
・エネルギー分解能:
~7 eV@400 eV X-ray(超伝導)、
<56 eV@C-Ka (半導体)
・計数率:200 kcps
・走査型電子顕微鏡:JEOL JSM-IT800SHLs
・加速器電圧範囲:10 V-30 kV
・最大サンプルサイズ:Φ100 ㎜、Φ10 ㎜(冷却時)
・2次電子最高空間分解能:0.6 nm程度@15 kV, 1.1 nm程度@1 kV
・試料最低冷却温度:-190℃以下
・機械式ヘリウム3冷凍機を用いて簡単に冷却でき、長時間の測定可能
- 設備ID
- WS-011
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- 株式会社 日立ハイテク (Hitachi High-Tech Corporation)
- 型番
- S-4800
- 仕様・特徴
- 試料サイズ最大20mm角
セミインレンズ方式による高分解能(~x600k)
EDAXによる元素分析
- 設備ID
- WS-012
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- 株式会社 日立ハイテク (Hitachi High-Tech Corporation)
- 型番
- SU8240
- 仕様・特徴
- 二次電子分解能
0.8nm (加速電圧15kV、WD=4mm、倍率270kx)
1.1nm (照射電圧1kV、WD=1.5mm、倍率200kx)
照射電圧 0.01~30kV
倍率 20~1,000,000倍
可動範囲:X 0~110mm,Y 0~80mm,R 360°
Z 1.5~40mm,T -5~70°
IM4000形イオンミリング装置付き(サンプルの断面ミリングと平面ミリング可能)
EDS System付き(元素分析可能)
"走査型顕微鏡"で検索した結果 114件
- 114件中 71~80件
- <
- 1
- ...
- 5
- 6
- 7
- 8
- 9
- 10
- 11
- 12
- ...
- 12
- >
![電界放出形走査電子顕微鏡[S4800_FE-SEM]](data/facility_item/1651474199_14.jpg)

![走査プローブ顕微鏡SPM_1[NanoscopeⅣ/Dimension3100]](data/facility_item/AT-046.jpg)
![走査プローブ顕微鏡SPM_2[SPM-9600/9700]](data/facility_item/AT-047.jpg)
![ナノサーチ顕微鏡SPM_3[SFT-3500]](data/facility_item/1651474557_14.jpg)