共用設備検索結果
中分類から探す
走査電子顕微鏡(JSM-6510) (Scanning Electron Mocroscope(JSM-6510))
- 設備ID
- NM-232
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- 日本電子 (JEOL)
- 型番
- JSM-6510
- 仕様・特徴
- ・Wフィラメント電子銃
・加速電圧:0.5~30 kV
・二次電子分解能:3.0 nm(加速電圧30 kV)、 8.0 nm (加速電圧3 kV)、 15.0 nm(加速電圧1 kV)
・倍率:5~30万倍
・最大試料サイズ:φ150 mm
・操作ナビ画面にナビゲーション表示
・試料交換手順はフロー式で初心者でも簡単に試料交換可能
電界放出形走査電子顕微鏡(JSM-6500F) (Field Emission Scanning Electron Microscope (JSM-6500F))
- 設備ID
- NM-231
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- 日本電子 (JEOL)
- 型番
- JSM-6500F
- 仕様・特徴
- ・電界放出形電子銃
・加速電圧:0.5~30 kV
・二次電子像分解能:1.5 nm(加速電圧15 kV)、 5.0 nm(加速電圧1 kV)
・倍率:10~50万倍
・最大試料サイズ:φ100 mm
・反射電子検出器搭載
・EDS付属(JED-2300)
エネルギー分解能:133 eV以下
検出可能元素:B~U
電界放出形走査電子顕微鏡(SU8000) (FE-SEM (SU-8000))
- 設備ID
- NM-227
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- 日立ハイテク (Hitachi High-Tech)
- 型番
- SU-8000
- 仕様・特徴
- ・対物レンズ:セミインレンズ型
・加速電圧:0.5~30 kV
・二次電子像分解能:1.0 nm(加速電圧15 kV)、1.4 nm(リターディングモード:照射電圧1 kV)
・倍率:20~80万倍
・反射電子検出器搭載
・STEM(BF)検出器搭載
・EDS付属(Bluker FlatQUAD)
ショットキー電界放出型走査電子顕微鏡(JSM-7001F) (Schottky FE-SEM (JSM-7001F))
- 設備ID
- NM-226
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- 日本電子 (JEOL)
- 型番
- JSM-7001F
- 仕様・特徴
- ・加速電圧:0.5~30 kV
・二次電子像分解能:1.2 nm (加速電圧30 kV)、3.0 nm (加速電圧1 kV)
・倍率:10~1百万倍
・最大試料サイズ:φ100 mm
・反射電子検出器搭載
・加熱ステージ(最高1000℃)
・EDS付属(JED-2300)
・EBSD:TSL OIM
・格子歪み測定プログラムCrossCourt Ver.3、Ver.4+
高分解能走査型電子顕微鏡 (High resolutiion scanning electron microscopy)
- 設備ID
- NU-263
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- 日本電子 (JEOL)
- 型番
- JSM-IT800
- 仕様・特徴
- ・加速電圧:0.01kV~30kV
・ステージバイアス電圧:0〜-5kV
・分解能:0.5nm(15kV),0.7nm(1kV)
・倍率:~2,000,000
・最大試料サイズ:170mmφ x 45mm
・EDS分析元素範囲:Be〜Cf
ショットキー走査型電子顕微鏡 (Scanning Electron Microscope)
- 設備ID
- UE-022
- 設置機関
- 電気通信大学
- 設備画像

- メーカー名
- 日立 (Hitachi High-Tech)
- 型番
- SU 5000
- 仕様・特徴
- 加速電圧: 0.5~30kV(0.1kVステップ)、二次電子像分解能:1.2nm(加速電圧30kV, WD=5.0mm)
FIB/SEM精密微細加工装置(Helios 650) (FIB/SEM microfabrication instrument)
- 設備ID
- NM-517
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
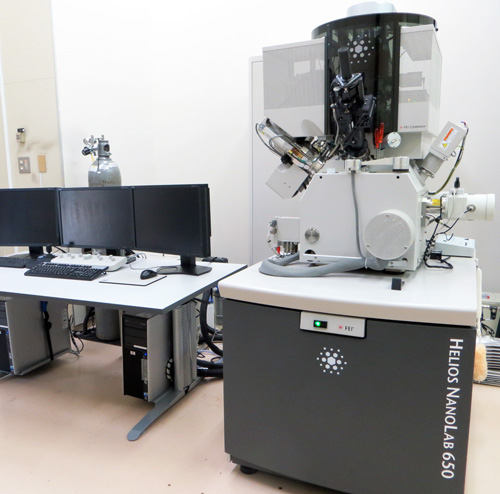
- メーカー名
- 日本エフイー・アイ株式会社 (FEI Company Japan Ltd.)
- 型番
- Helios 650
- 仕様・特徴
- 1. SIM像分解能5nm(@30kV)、最大電流65nA
2. SEM像分解能1.5nm(@1kV)、最大電流26nA
3. E-beam: 350V~30 kV、I-Beam: : 500V~30 kV
4. 試料ステージ: XY150 mm、Z10 mm、T: -9°~+57°、R: 360°
5. Ptデポ
6. サンプルリフトアウトシステム
【特徴】
1.集束イオンビーム(FIB)加工が可能 2.走査型電子顕微鏡(SEM)観察が可能 3.カラム内で加工薄片をリフトアウト(マイクロサンプリング)可能
デュアルビーム走査電子顕微鏡 (Dual Beam FIB-SEM)
- 設備ID
- KT-408
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- 日本電子 (JEOL)
- 型番
- JIB-4700F
- 仕様・特徴
- 1.SEM装置(0.1~30kV)
2.FIB装置(1~30kV)
3.EDS検出器
4.EBSD検出器
5.クライオステージ
6.WとCのガス吹付装置
卓上走査型電子顕微鏡装置群 (Tabletop scanning electron microscope (SEM))
- 設備ID
- NM-006
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- 日立ハイテク (Hitachi High-Tech)
- 型番
- Miniscope TM4000PlusII Miniscope TM3000
- 仕様・特徴
- 【TM4000PlusII】
・倍率:10倍~10万倍
・加速電圧 : 5 kV、10 kV、15 kV、20 kV
・画像信号 : 反射電子, 二次電子
・真空モード:導電体(反射電子のみ)、標準、帯電軽減
・EDX:あり
【TM3000】
・倍率:15倍~3万倍
・加速電圧 : 5 kV、15 kV
・画像信号 : 反射電子のみ
・観察モード:通常、帯電軽減
・EDX:あり
微細組織3次元マルチスケール解析装置 (Orthogonal FIB-SEM)
- 設備ID
- NM-302
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
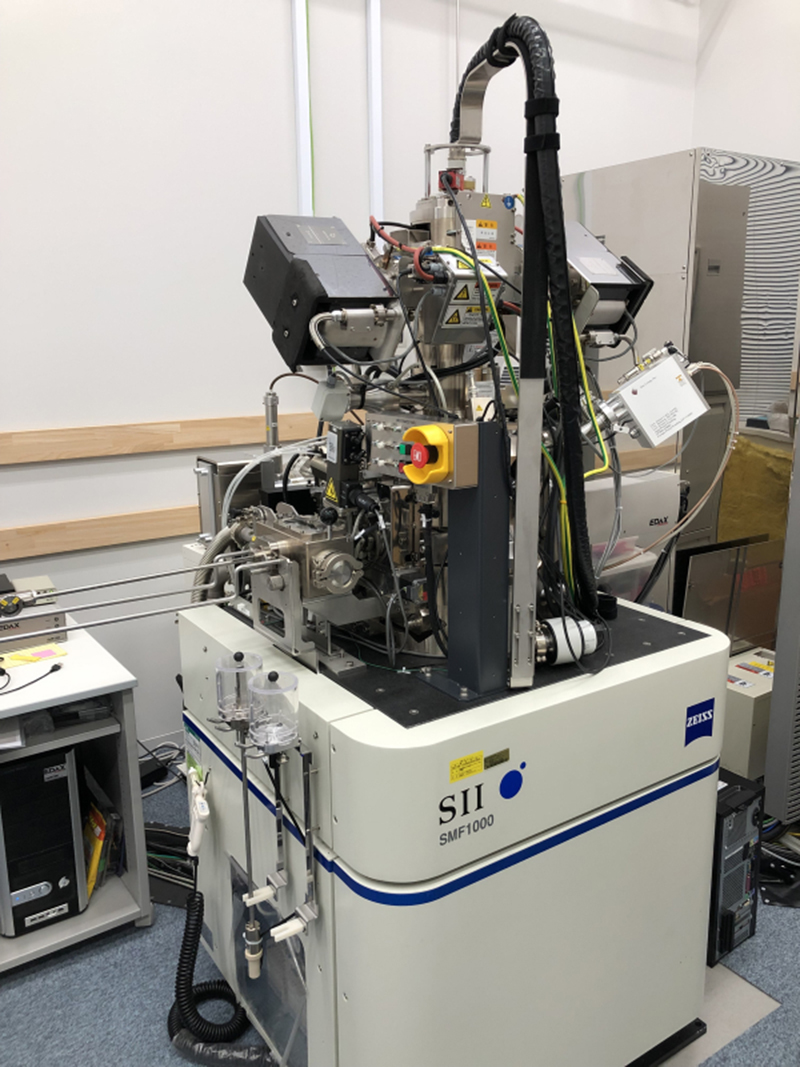
- メーカー名
- 日立ハイテク (Hitachi High-Tech)
- 型番
- SMF-1000
- 仕様・特徴
- 最高1nmピッチで制御可能で,加工と観察を繰り返すこと(シリアルセクショニング)で3D像再構築が可能.更にEBSDを併用した3D-EBSDやTEM試料作製も対応可能.
・SEM:ZEISS Gemini
・EDS:EDAX
・EBSD:EDAX TSL Hikari
・Ar-ion gun
・Depo. gas:Carbon