共用設備検索
共用設備検索結果
- 設備ID
- UT-606
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- サムコ (SAMCO)
- 型番
- RIE-10NR
- 仕様・特徴
- 8”装置。SF6, CHF3, CF4, Ar, O2によるエッチングが可能。ヘリウム背圧冷却が不要
- 設備ID
- UT-607
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- FEI (FEI)
- 型番
- 400ACE
- 仕様・特徴
- LSI配線を効率的に修正するための装置です。DCG P2Xを置き換えました。ガスを利用した金属配線カット、絶縁膜堆積、金属配線堆積が可能。大規模集積回路(VLSI)の配線修正を最も得意とする装置です。それ以外の利用は東大拠点では微細構造解析で公開しているXvision 200TBの利用がお勧めです。(案内します)
- 設備ID
- UT-608
- 設置機関
- 東京大学
- 設備画像
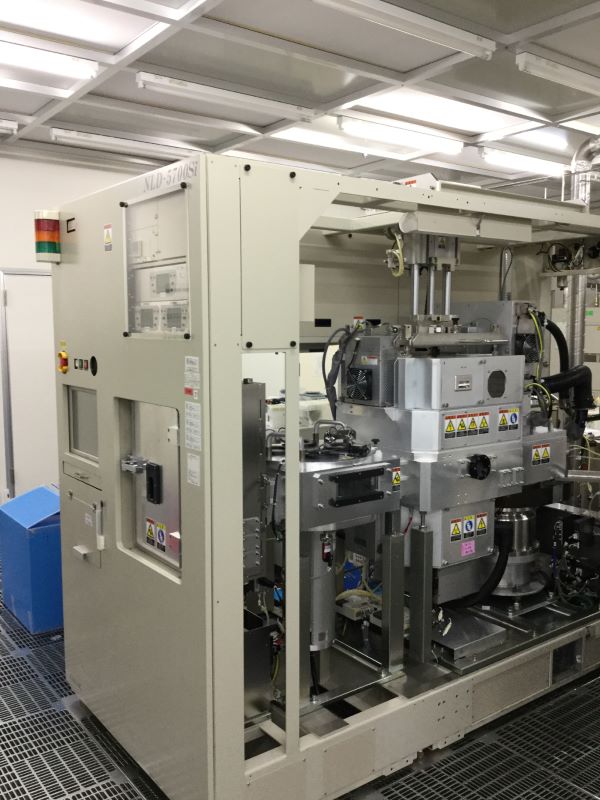
- メーカー名
- アルバック (ULVAC)
- 型番
- NLD-5700Si
- 仕様・特徴
- ガラスの深掘りが可能なニュートラルループディスチャージ(NLD)エッチング装置。当面は技術補助のみ。
- 設備ID
- UT-609
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- サムコ株式会社 (SAMCO Inc.)
- 型番
- VPE-4F
- 仕様・特徴
- MEMSの中空構造が得られるXeF2ガスを用いドライエッチング装置
- 設備ID
- UT-610
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子㈱ (JEOL)
- 型番
- IB15930CP
- 仕様・特徴
- アルゴンプラズマにより断面出しが容易になる。位置合わせ顕微鏡あり。電子顕微鏡撮影用サンプル作製に最適。
- 設備ID
- UT-700
- 設置機関
- 東京大学
- 設備画像
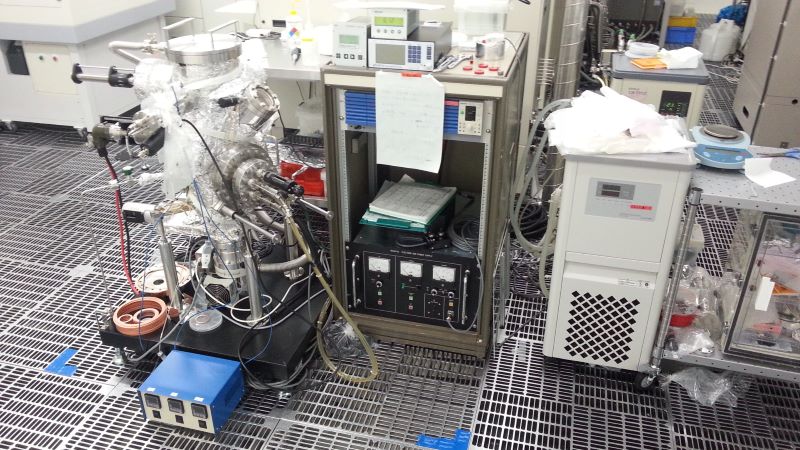
- メーカー名
- 自作 (DIY)
- 型番
- NSPⅡ
- 仕様・特徴
- 東大拠点で独自設計・自作した蒸着装置で、いわゆる抵抗加熱蒸着と電子線(EB)加熱蒸着との両方がが可能。
主な材料はAu,Cr,Al。
- 設備ID
- UT-701
- 設置機関
- 東京大学
- 設備画像
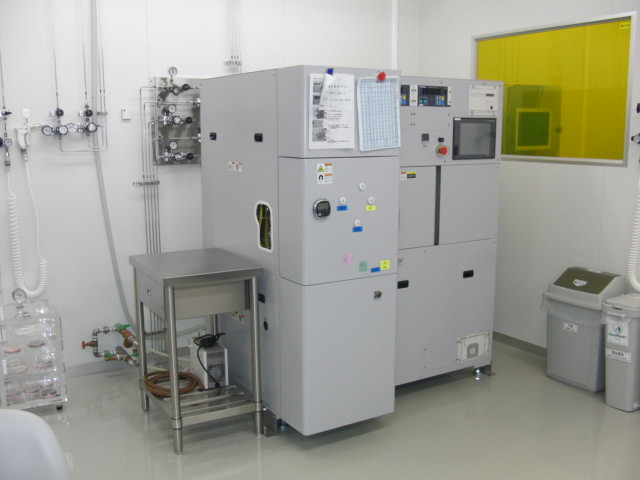
- メーカー名
- 芝浦メカトロニクス (SHIBAURA MECHATRONICS)
- 型番
- CFS-4EP-LL
- 仕様・特徴
- ターゲット材をアルゴンプラズマによってスパッタリングし、基板に製膜するスパッタリング装置です。
ターゲット材は日々変動するので都度相談ください。φ200以下のシリコン、ガラス専用。
- 設備ID
- UT-702
- 設置機関
- 東京大学
- 設備画像
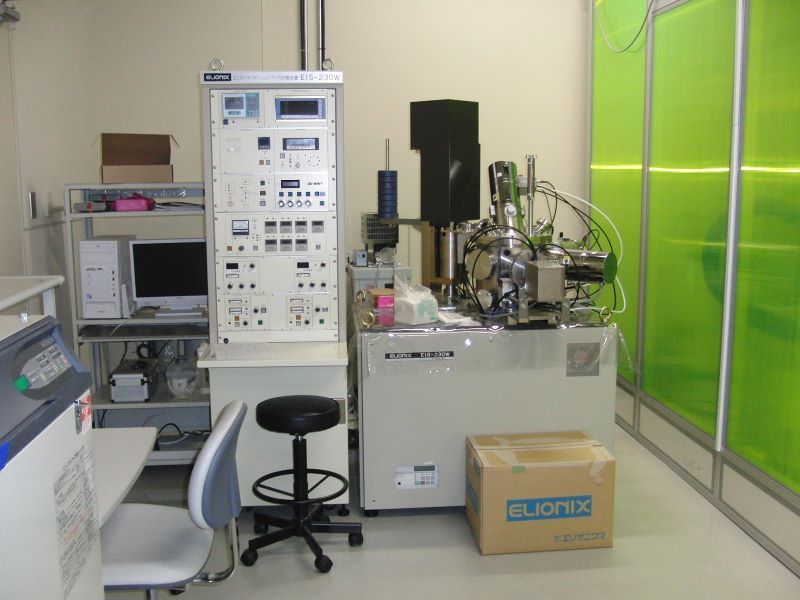
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- EIS-230W
- 仕様・特徴
- ターゲット材をアルゴンプラズマによってスパッタリングし、基板に製膜するスパッタリング装置です。
109と比較して高周波の高密度プラズマを用いているところが違いです。
ターゲット材は日々変動するので都度相談ください。φ100以下の基板用
- 設備ID
- UT-703
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- アルバック (ULVAC)
- 型番
- SIH-450
- 仕様・特徴
- 4インチウエーハ8枚、8インチウエーハ2枚導入可能。
6インチターゲット2枚、4インチターゲット1枚が可能。RFとDCスパッタリングが可能。
Al,SiO2,TiN,Taターゲットがあります。その他のターゲット導入も相談に乗ります(在庫がない場合注文から導入まで数ヶ月かかることもありますので相談はお早めに。)
- 設備ID
- UT-704
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 芝浦メカトロニクス (SHIBAURA MECHATRONICS)
- 型番
- CFS-4ES
- 仕様・特徴
- ターゲット超豊富です。サンプルサイズ: 8inch
ターゲットサイズ: 3inch ターゲット種類 : Ag, Al,Al2O3,Al-Nd, Au,AuGeNi, AuZnNi, Cr, Cu, GaN,ITO, IZO, Ni,Pt, SiO2, Si3N4,Ta, TbFeCo, Ti,TiO2,Pd ※, ZAO, Zn, ZnO
"東京大学"で検索した結果 115件
- 115件中 61~70件
- <
- 1
- ...
- 4
- 5
- 6
- 7
- 8
- 9
- 10
- 11
- ...
- 12
- >