共用設備検索
共用設備検索結果
- 設備ID
- UT-506
- 設置機関
- 東京大学
- 設備画像
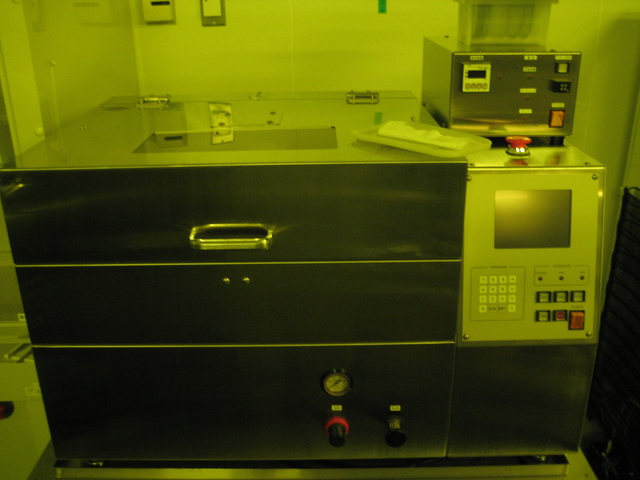
- メーカー名
- アクテス京三 (Actes Kyosan)
- 型番
- ADE-3000S(Big)
- 仕様・特徴
- ZEP520電子線用レジストの自動現像装置
- 設備ID
- UT-507
- 設置機関
- 東京大学
- 設備画像
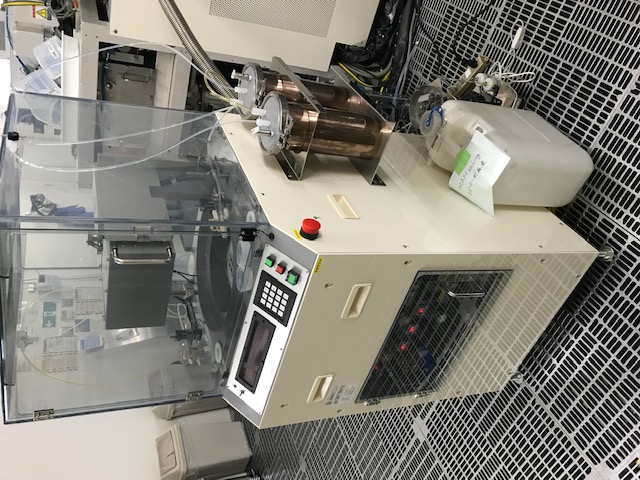
- メーカー名
- アクティブ (ACTIVE)
- 型番
- ACT-300AⅡS
- 仕様・特徴
- 厚膜のレジストを塗布できるスプレーコーター
- 設備ID
- UT-508
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- GenISys (GenISys GmbH)
- 型番
- Beamer
- 仕様・特徴
- 電子線描画時に生じる近接効果を補正して設計通りのレズストパターンを電子線で描画するためのパターン補正システム。グレースケール露光用のデータ生成が可能。
- 設備ID
- UT-509
- 設置機関
- 東京大学
- 設備画像
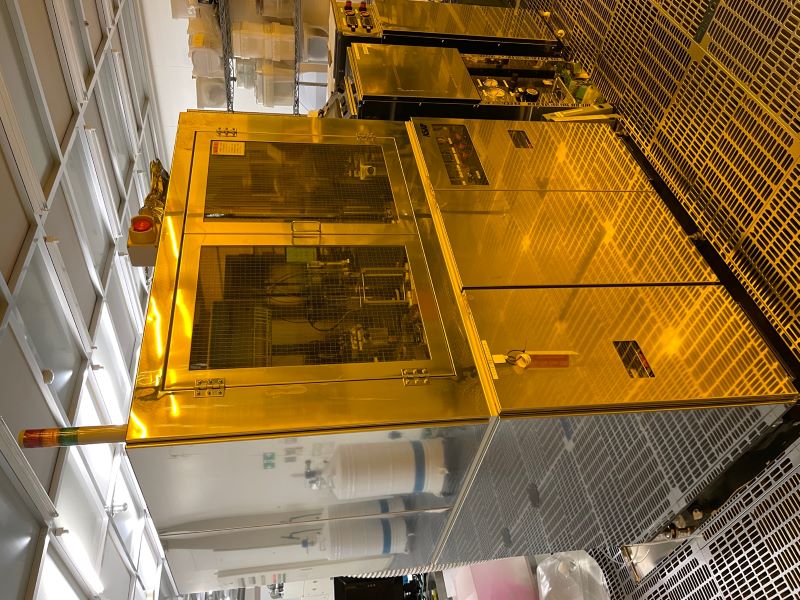
- メーカー名
- エイ・エス・エイ・ピイ (ASAP)
- 型番
- LOA34-8-5-09
- 仕様・特徴
- リフトオフを自動で行い成功確立が上がります。
- 設備ID
- UT-600
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- アルバック (ULVAC)
- 型番
- CE-300I
- 仕様・特徴
- 誘導性結合プラズマ(ICP)エッチング装置で、こちらは汎用装置。
4”丸型ウエーハの入る装置。
利用可能ガスは、アルゴン、SF6、CF4、CHF3、O2。
主に酸化膜のエッチングや、イオンミリングによる金属のエッチングに利用。
- 設備ID
- UT-601
- 設置機関
- 東京大学
- 設備画像
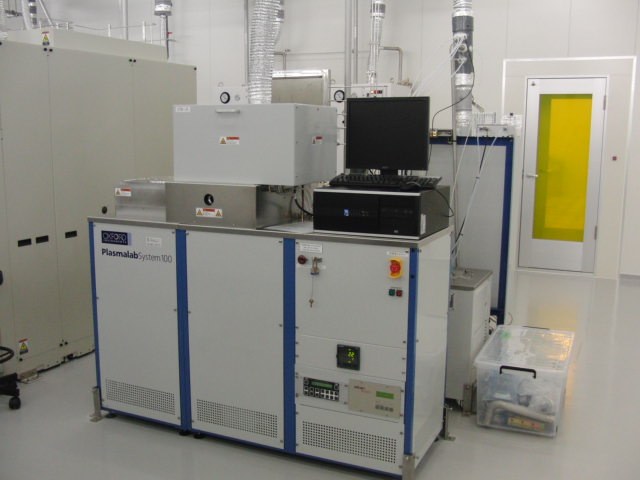
- メーカー名
- オックスフォード・インストゥルメンツ (Oxford Instruments)
- 型番
- Plasma Pro 100 ICP-180
- 仕様・特徴
- 誘導結合プラズマ(ICP)によるエッチング装置です。
化合物半導体基板(GaAs,InP,GaN等)を得意とします。4”丸型ウエーハ導入可能。
導入ガス種:Ar,O2,H2,CH4,N2,Cl2,SF6,He
- 設備ID
- UT-602
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- IDONUS (IDONUS)
- 型番
- 仕様・特徴
- 8インチ装置、Vapor HF専用、気相フッ化水素(HF水溶液を蒸発)によって、選択的にシリコン酸化膜をエッチングし、MEMSデバイスの可動構造体、中空構造を形成するための装置です。独自構造によって、フッ酸に直接触れることなく、安全に利用することができます。静電チャックによって、任意形状の基板をチャック下エッチングのほか、4,6,8インチの丸ウエーハは機械的クランプを行えます。
- 設備ID
- UT-603
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- アルバック (ULVAC)
- 型番
- NE-550
- 仕様・特徴
- CE-300Iの上位機種(ULVACのフラッグシップモデル)です。大津・八井研究室の協力により利用可能になりました。SiO2、ガラスのエッチングも可能です。
4”装置 塩素・フッ素系汎用。 Cl2, BCl3, Ar, O2, CF4,CHF3, SF6, C3F8
- 設備ID
- UT-604
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- SPTS (SPTS)
- 型番
- MUC-21 ASE-Pegasus
- 仕様・特徴
- 高密度プラズマにより(ICPパワー3kWまで。1800W常用)、低ダメージ、高速にてエッチングが可能です。(例:EBレジストを用い、scalloping100nm程度で100μm開口のトレンチを20分エッチングして深さ135μm可能)。4”装置。100nmクラスの開口可能。特殊レシピ有。また、SF6による「ドライリリース」や、C4F8による酸化膜エッチングなど、組み合わせで便利に使えるレシピも利用できます。
- 設備ID
- UT-605
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- アルバック (ULVAC)
- 型番
- CE-S
- 仕様・特徴
- オペレーションの容易さで評判のCE-300Iの後継機。
8”装置(任意サンプル貼り付けエッチング可能)
Cl2, BCl3, SF6, CHF3, Ar, O2によるエッチングが可能ですが、主に使い分けとしてCl系のエッチングを行っています。
"東京大学"で検索した結果 115件
- 115件中 51~60件
- <
- 1
- ...
- 3
- 4
- 5
- 6
- 7
- 8
- 9
- 10
- ...
- 12
- >