共用設備検索結果
CADデータ連動3次元機能融合デバイス評価用前処理システム (Preprocessing system for device evaluation that integrates 3D functions linked with CAD data)
- 設備ID
- UT-152
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日立ハイテクノロジーズ (Hitachi High-Tech)
- 型番
- XVision200TB
- 仕様・特徴
- □ 主な特徴
・デバイス評価用前処理システム
・透過電子顕微鏡用薄膜試料作製にも対応
□ 主な仕様
・ FIB分解能:4nm@30kV、最大電流45nA
・ SEM分解能:3nm@5kV、加速電圧1~30kV
・ 最大8インチステージ
・ Arビーム照射
・ W,C,絶縁膜デポ XeF,有機系エッチングガス
・ CADデータオーバレイ表示
・ レーザー顕微鏡と共通の座標系
クロスセクションポリッシャー(CP) (Cross Section Polisher)
- 設備ID
- UT-153
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JEOL SM-090010JEOL SM-090020
- 仕様・特徴
- □ 主な特徴
表面に対して垂直な断面が制作可能。
□ 主な仕様
イオン加速電圧:2 ~ 6 kV
イオンビーム径半値幅:500 μm(加速電圧:6kV, 試料:Si)
ミリングスピード:1.3 μm/min以上(加速電圧:6kV, 試料:Si)
最大搭載試料サイズ:11mm×9mm×2mm
試料移動範囲:X軸±3mm Y軸:±3mm
試料角度調節範囲:±5°
使用ガス:アルゴンガス
イオンスライサー (Ion slicer)
- 設備ID
- UT-154
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- EM09100IS
- 仕様・特徴
- □ 主な仕様
・イオン加速電圧:1~8 kV
・傾斜角:最大6°(0.1°刻み)
・試料ガス:アルゴン
□ 主な特長
冊状試料にイオン研磨処理を行い、薄膜試料を作製
無機微小結晶構造解析装置 (X-ray Single Crystal Diffractometer)
- 設備ID
- UT-201
- 設置機関
- 東京大学
- 設備画像
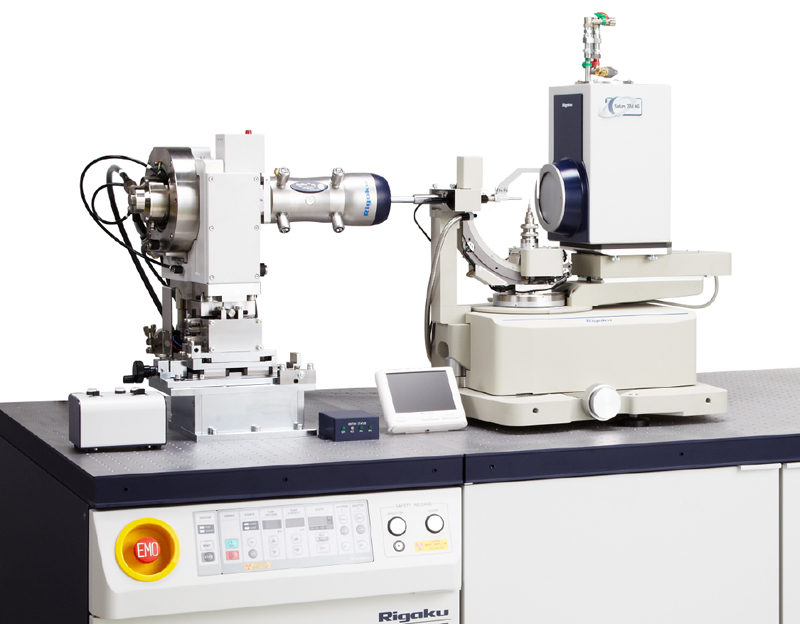
- メーカー名
- リガク㈱ (Rigaku Co.)
- 型番
- VariMax Dual
- 仕様・特徴
- □ 主な特長
・ これまで放射光でないと回折強度測定が困難であった数十μm角以下の低分子およびタンパ質結晶や一片が10μm以下の結晶などの微小結晶の構造解析が可能
・ 高輝度X線源と湾曲型人工多層膜ミラーの組み合わせにより、結晶位置に高輝度X線を導くことが可能
・ Mo/Cu両方の線源を使用可能であり無機・有機化合物の構造解析を線源に依存することなく測定可能
□ 主な仕様
・ X線源:1.2kW発生装置 / 実効輝度31kW/mm2/ Mo・Cuターゲット
・ X線光学素子(VariMax Dual):湾曲型人工多層膜ミラー Mo・Cu両波長に対応した光学素子
・ 検出器:高感度・広ダイナミックレンジ2次元検出器により迅速な測定が可能
・シャッターを開放のまま、ゴニオメーター連続駆動をしてのシームレス測定が可能
・結晶を-180℃までの冷却が可能
高輝度In-plane型X線回折装置 (XRD)
- 設備ID
- UT-202
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- ㈱リガク (Rigaku Co.)
- 型番
- SmartLab(9kW)
- 仕様・特徴
- □ 主な特長
・ 高輝度X線源 及び In-Planeアームを搭載した試料水平配置高精度ゴニオメータを使用したX線回折装置。
・ 粉末試料測定に適した集中法光学系,薄膜試料の測定に適している多層膜ミラーを用いた平行ビーム光学系によるX線反射率測定,逆格子マップ測定,ロッキングカーブ測定などを簡単なユニット交換で組み替えて利用することが可能。
・ インプレーンアームの搭載により、極薄膜の評価や完全極点測定が可能。
□ 主な仕様
・ X線源:9kW回転対陰極X線発生装置A/Cuターゲット
・ 光学系:集中法・多層膜平行ビーム法・薄膜高分解平行ビーム法・インプレーン光学系
・ 検出器:HyPix-3000
粉末X線回折装置 (XRD)
- 設備ID
- UT-203
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- ㈱リガク (Rigaku Co.)
- 型番
- SmartLab (3kW)
- 仕様・特徴
- □ 主な特長
・ 粉末試料測定に適した集中法光学系,薄膜試料の測定に適している多層膜ミラーを用いた平行ビーム光学系。
・ In-Planeアームを搭載した試料水平配置高精度ゴニオメータを使用したX線回折装置。
・ 900℃までの高温測定用アタッチメントも用意している。
□ 主な仕様
・ X線源:3 kW封入型X線管/Cuターゲット
・ 光学系:集中法・多層膜平行ビーム法・インプレーン光学系
・ 検出器:シンチレーション検出器:1次元半導体検出器
・SmartLab用AntonPaarDHS900アタッチメント
多機能走査型X線光電子分光分析装置(XPS) (rX-ray Photoelectron Spectroscopy)
- 設備ID
- UT-301
- 設置機関
- 東京大学
- 設備画像
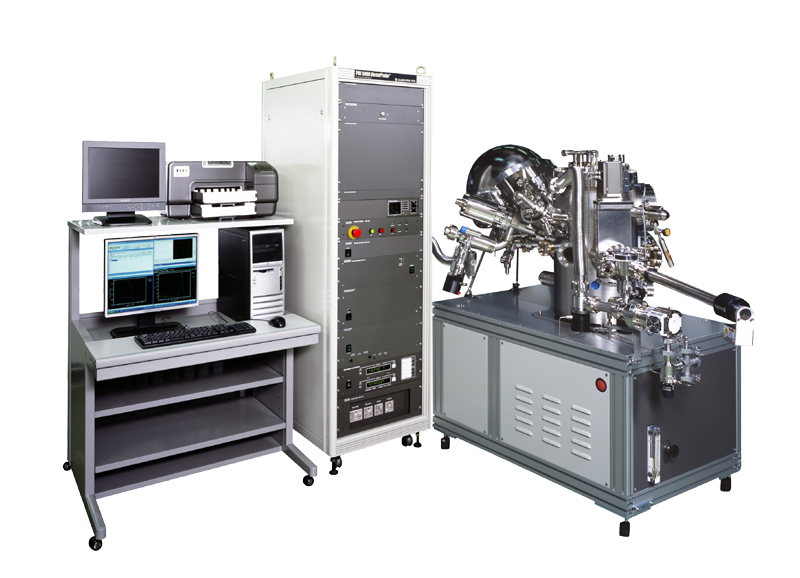
- メーカー名
- アルバックファイ㈱ (ULVAC-PHI, Inc. )
- 型番
- PHI 5000 VersaProbe
- 仕様・特徴
- □ 主な特長
・ 走査型マイクロフォーカスX線源による微小領域分析(最小分析領域10μm)
・ SXI(Scanning X-ray Image)により、正確・迅速に微小な分析位置を特定
・ 低エネルギー電子とイオンの同時照射により、絶縁物試料を容易に帯電中和
・ 5軸(X、Y、Z、Tilt、Rotation)モータ駆動による多点分析
□ 主な仕様
・ 最小ビーム径:10μm以下
・ 最高エネルギー分解能:0.5eV以下(Ag3d 5/2)
・ 最大感度:1,000,000cps(Ag3d 5/2の半値幅1.0eVのとき)
・ 到達圧力:6.7×10-8Pa以下
電子スピン共鳴装置 (Electron spin resonator)
- 設備ID
- UT-302
- 設置機関
- 東京大学
- 設備画像
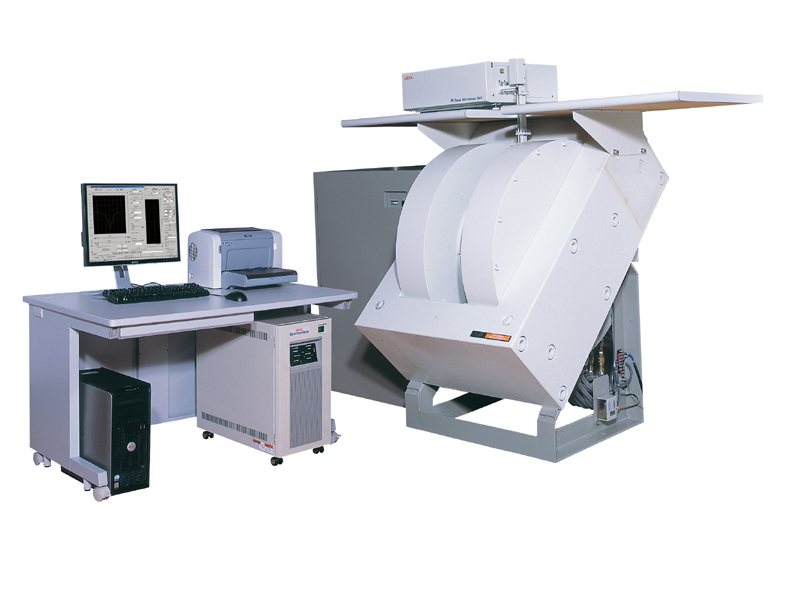
- メーカー名
- 日本電子株式会社 (JEOL)
- 型番
- JES-FA300
- 仕様・特徴
- □ 主な仕様
・ 測定帯域
Xバンド約9GHz/Qバンド約35GHz
・最低計測可能温度 10K以下
□主な用途
・電界誘起キャリア密度・ダイナミクスの評価
・磁気共鳴やg値の磁場依存性の評価
分光エリプソメータ (M-2000DI-T)
- 設備ID
- UT-303
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- ジェー・エー・ウーラム・ジャパン (J.A.Woollam)
- 型番
- M-2000U
- 仕様・特徴
- □ 主な仕様
・測定波長:193~1690nm
・チャンネル数:690同時計測
・回転補償子型
極限環境下電磁物性計測装置 (Physical Property Measurement System(PPMS))
- 設備ID
- UT-304
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本カンタム・デザイン (Quantum Design Japan)
- 型番
- PPMS-14LHattt
- 仕様・特徴
- □ 主な仕様
・14 T超伝導マグネット
・温度制御 1.9K~400K
・試料空間 25.4mm
□主な用途
・電気輸送特性評価
・磁気特性評価
・熱輸送特性評価など