共用設備検索
共用設備検索結果
- 設備ID
- UT-005
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JEM-ARM200F Thermal FE STEM
- 仕様・特徴
- □ 主な仕様
・ 分解能:STEM明視野格子像 0.136nm
STEM暗視野格子像 0.082nm
TEM格子像 0.10nm
TEM粒子像 0.19nm
・ 倍率: STEM像 200~150,000,000倍
TEM像 50~2,000,000倍
・ 収差補正装置:照射系球面収差補正装置 組み込み
・ 検出器:エネルギー分散形X線分析装置 (SDD)、電子線エネルギー損失分光器(EELS)、
軽元素対応像検出器、CCD検出器(2k×2k,4k×2k)
- 設備ID
- UT-006
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JEM-2800
- 仕様・特徴
- □ 主な特長
電子顕微鏡観察を自動化。コントラスト&ブライトネス、試料高さ、結晶方位あわせ、フォーカス、非点補正を自動調整。TEM、STEM、SEM、電子線回折の観察モードを瞬時に切り替え可能。高性能光学系採用により高分解能観察と高速分析を両立している。
□ 主な仕様
・分解能:二次電子像≦0.5nm,走査透過像 0.2nm,透過像(格子像) 0.1nm
・倍率:二次電子像 ×100~×150,000,000 走査透過像×100~×150,000,000 TEM像×500~×20,000,000
・ 電子銃:ショットキー型電界放出電子銃 加速電圧 200kV・100kV
・ 試料系:試料傾斜 X軸±25゜Y軸±30゜
・ 分析:EDS、EELS検出器を装備
- 設備ID
- UT-007
- 設置機関
- 東京大学
- 設備画像
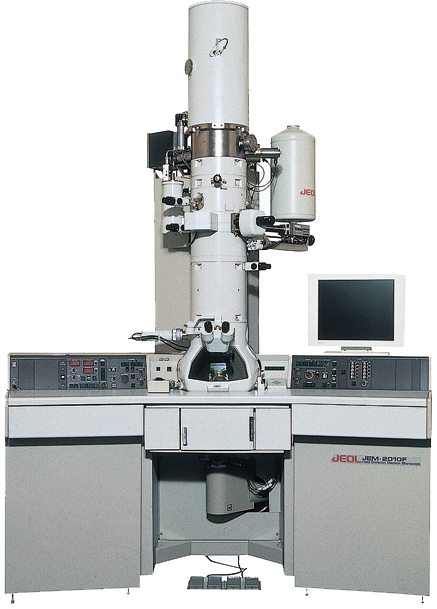
- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JEM-2010F
- 仕様・特徴
- □ 主な仕様
(1)本体
加速電圧:80,100,120,160,200kV
電子線源:熱電界放射型
分解能:0.192nm(粒子像)
試料最大傾斜角:±20°
試料移動:モーター駆動
排気方式:スパッターイオン、油拡散ポンプ
(2)画像記録 Gtan社 UltraScan
(3)分析装置
2)エネルギー分散型分光器(EDS)
- 設備ID
- UT-009
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JEM-2010HC
- 仕様・特徴
- □ 主な仕様
(1)本体
加速電圧 : 80、100、120、160、200kV
電子線源 : 単結晶LaB6
試料最大傾斜角 : ±30°
試料移動 : モーター駆動(X、Y、Z)
排気方式 : ターボ分子ポンプ(TMP)
(2)画像記録 シートフィルムおよびデジタル画像
(3)分析機能:EDS
- 設備ID
- UT-010
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JEM-2100F
- 仕様・特徴
- □ 主な仕様
・ ショットキー型FE電子銃装備
・ 分解能<0.31nm
・ EDS、EELS検出器装備
・ TEM/STEM 3次元トモグラフィ機能装備
・ 極低温観察用クライオトランスファホルダ装備
・ CCD検出器(4k×4k,1k×1k)
・加速電圧:200kV、120kV
- 設備ID
- UT-011
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JEM-1400
- 仕様・特徴
- □ 主な仕様
・ 分解能<0.38nm
・ オートフォーカス及び自動モンタージュ機能(自動つなぎ合わせ及び自動コントラスト補正)
・ 自動モンタージュは縦5枚×横5枚(合計2500万画素)が可能で、分解能を維持したままの大面積観察・超高速スクリーニングに対応可能。
・加速電圧:120kV
- 設備ID
- UT-101
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JSM-7500FA
- 仕様・特徴
- □ 主な特長
ジェントルビーム機能を搭載し加速電圧1kVで1.4nmの高分解能
□ 主な仕様
・二次電子像分解能:1.0nm(15kV)、1.4nm(1kV)
・倍率:×25~×1,000,000
・加速電圧:0.1kV~30kV
- 設備ID
- UT-102
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JSM-7800F Prime
- 仕様・特徴
- □ 主な仕様
(1)本体
加速電圧:0.5~30 kV
0.5~2.9 kVは10 Vステップ
2.9~30 kVは100 Vステップ
二次電子分解能:1.0 nm(加速電圧15kV, 通常時)
1.5 nm(加速電圧1kV, 通常時)
0.7 nm(加速電圧15kV, GB時)
1.2 nm(加速電圧1kV, GB時)
0.7 nm(加速電圧1kV, GBSH時)
倍率:×25 ~ 1,000,000
プローブ電流:10-12 ~ 2×10-7 A
(2)エネルギー分散形X線分析装置(JEOL JED-2300F)
検出器:シリコンドリフト検出器
エネルギー分解能:129 eV
検出可能元素:Be ~ U
(3)カソードルミネッセンス測定装置(HORIBA MP-32S)
波長測定領域:185 nm ~ 900 nm(PMT)
200 nm ~ 1100 nm(CCD)
※ 光経路が空気中であるため、紫外領域の感度は低減される
(4)半導体反射電子検出器(RBEI)
(5)走査透過型電子検出器(STEM)
- 設備ID
- UT-103
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JSM-7000F
- 仕様・特徴
- □ 主な仕様
(1)本体
加速電圧:0.5~30kV 0.5~2.9kVは10Vステップ可変
2.9~30kVは100Vステップ可変
二次電子分解能:1.2nm(加速電圧30kV),3.0nm (加速電圧1kV)
倍率:×10(WD40)~500,000
プローブ電流:10-12~2×10-7A
(2)結晶方位測定装置(株式会社TSLソリューションズ)
ソフトウェアー OIM Ver7.3.1
(3)高感度反射電子検出器
(4)走査透過電子検出器(STEM)
- 設備ID
- UT-104
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JSM-6510LA
- 仕様・特徴
- □ 主な仕様
(1)本体
加速電圧:0.5~30kV 0.5~3.0kVは100Vステップ可変 3~30kVは1kVステップ可変
二次電子分解能:
高真空モード:3.0nm(加速電圧30kV),15.0nm(加速電圧1kV)
低真空モード:4.0nm(加速電圧30kV)
倍率:×5~300,000
プローブ電流:1pA~1μA
試料室圧力調整範囲:10~270Pa
(2)エネルギー分散型X線分析装置(日本電子)
検出器:エクストラミニカップEDS検出器
エネルギー分解能129eV以下
検出可能元素 Be~U
分析時分解能:3.0nm(加速電圧15kV・プローブ電流15nA・WD10mm)
(3)反射電子検出器(Si P-N複合型半導体検出器)
"東京大学"で検索した結果 115件
- 115件中 21~30件
- <
- 1
- 2
- 3
- 4
- 5
- 6
- 7
- 8
- ...
- 12
- >