共用設備検索結果
ウエーハレベルボンディング装置SB8 Gen2 (Substrate Bonder)
- 設備ID
- UT-917
- 設置機関
- 東京大学
- 設備画像
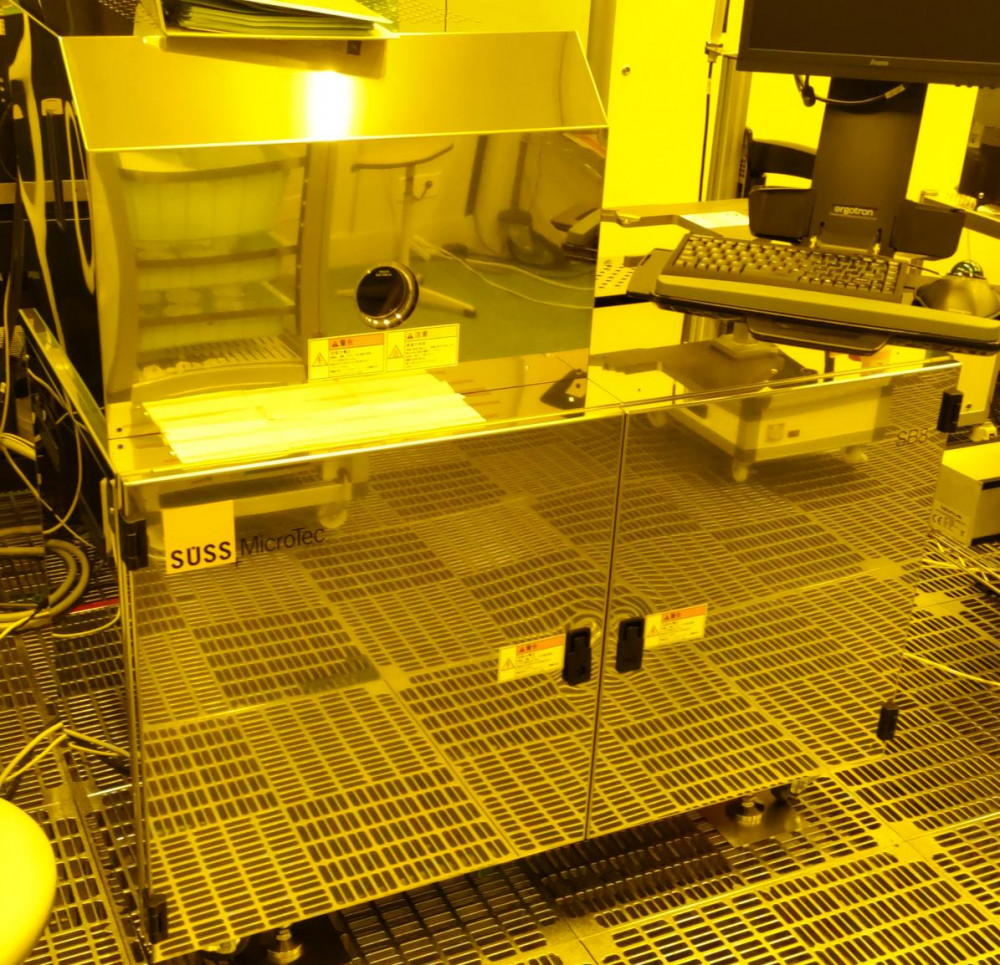
- メーカー名
- ズースマイクロテック (Suss MicroTec)
- 型番
- SB8 Gen2
- 仕様・特徴
- ウエーハ同士を接合する装置。位置合わせはマスクアライナーMA6(UT-504)で行う。MEMSプロセスや三次元配線形成に用いられる装置。
最大加熱温度:550℃、温度均一性:±1.5℃
温度再現性:±3℃、最大加熱速度:30K/分
最大冷却速度:25K/分、最大加圧力:20kN
圧力均一性:±2%
精密研磨装置PM-6 (C.M. Polisher)
- 設備ID
- UT-916
- 設置機関
- 東京大学
- 設備画像
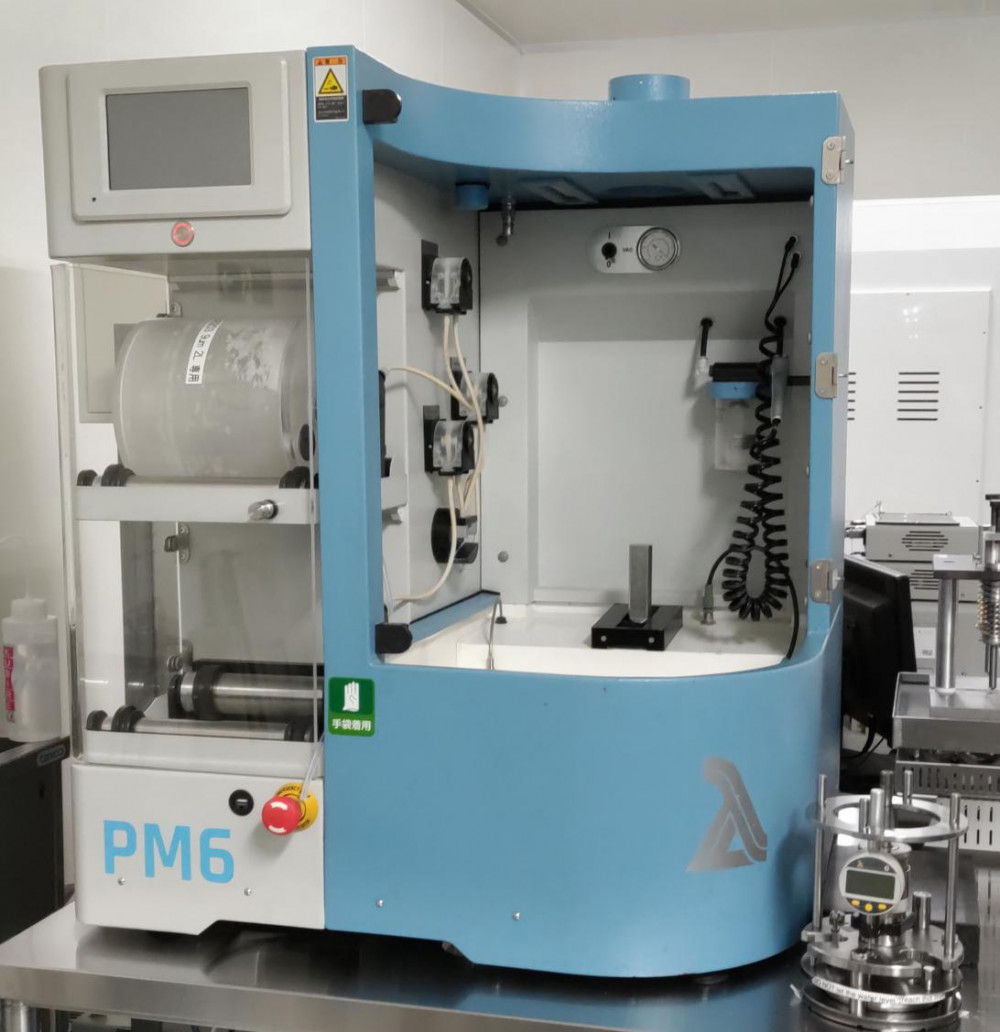
- メーカー名
- ロジテック (Logitec)
- 型番
- PM-6
- 仕様・特徴
- 化学研磨装置
対象物を精密に研磨する装置。研磨剤によって、高速に粗く削る(ラッピング)ことも、低速に平坦性を確保する(ポリッシング)ことも可能。4”丸型ウエーハまで研磨可能。
回転機構:1軸タイプ
最大サンプル径:4インチ
大面積走査プローブ顕微鏡Dimension ICON (Large-Area Scanning Probe Microscope Dimension ICON)
- 設備ID
- UT-863
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- ブルカージャパン (Bruker Japan)
- 型番
- Dimension ICON
- 仕様・特徴
- ステージ径φ210mm、駆動範囲150×180mm
スキャナ、光学顕微鏡範囲:90×90×10μm
測定モード:形状(コンタクト、タッピング、ピークフォースタッピング)機械特性等プローブ測定が可能(UT-861 L-TraceIIの後継機。近日中に完全置換予定)
全反射蛍光X線分析装置TXRF-3760 (Total internal reflection fluorescence X-ray analyzer)
- 設備ID
- UT-862
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- (株)リガク (Rigaku Corporation)
- 型番
- TXRF 3760
- 仕様・特徴
- ウェーハ表面上の汚染を非破壊・非接触で高感度に分析。
液体窒素フリー検出器を備えた3ビームTXRFシステム。
ナトリウムからウランまでの元素検出が可能。
解析に時間と経験を要するため、当面技術代行(代行料が上乗せになる)にての公開。
LL式高密度汎用スパッタリング装置(2024) (LL-type High-density General Purpose Sputtering System)
- 設備ID
- UT-716
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 芝浦メカトロニクス (SHIBAURA MECHATRONICS)
- 型番
- CFS-4EP-LL !-Miller (2024)
- 仕様・特徴
- 真空引きが速く、通常10分程度でスパッタリング開始が可能。また、膜質の安定も期待できる。ターゲットはCFS-4ESと共通。 デフォルトはPt/Au/Cr/Tiを装着。それ以外のターゲットは支援員の技術補助で交換を行う。UT-711と互換。
サイドスパッタ方式、スパッタターゲット:3inchx3、ホルダーサイズ:Φ220mm、到達圧力:5x10E-4 Pa以下、RF50W(DC)、加熱温度:最大300℃
2インチ3元電子線蒸着装置 (2-inch 3-target Electron Beam (EB) Evaporator)
- 設備ID
- UT-715
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- アルバック (ULVAC)
- 型番
- BB7873
- 仕様・特徴
- ウエーハサイズ2インチもしくはそれ以下のチップサンプルに対応可能。一般的なEB蒸着装置です。ロードロックを備えており、試料交換時間が短い。到達真空度は10E-5 Pa台。膜厚計、試料加熱ランプあり。
枚様式HMDS処理装置APPS-30 (Single-wafer type HMDS surface treatment machine)
- 設備ID
- UT-512
- 設置機関
- 東京大学
- 設備画像
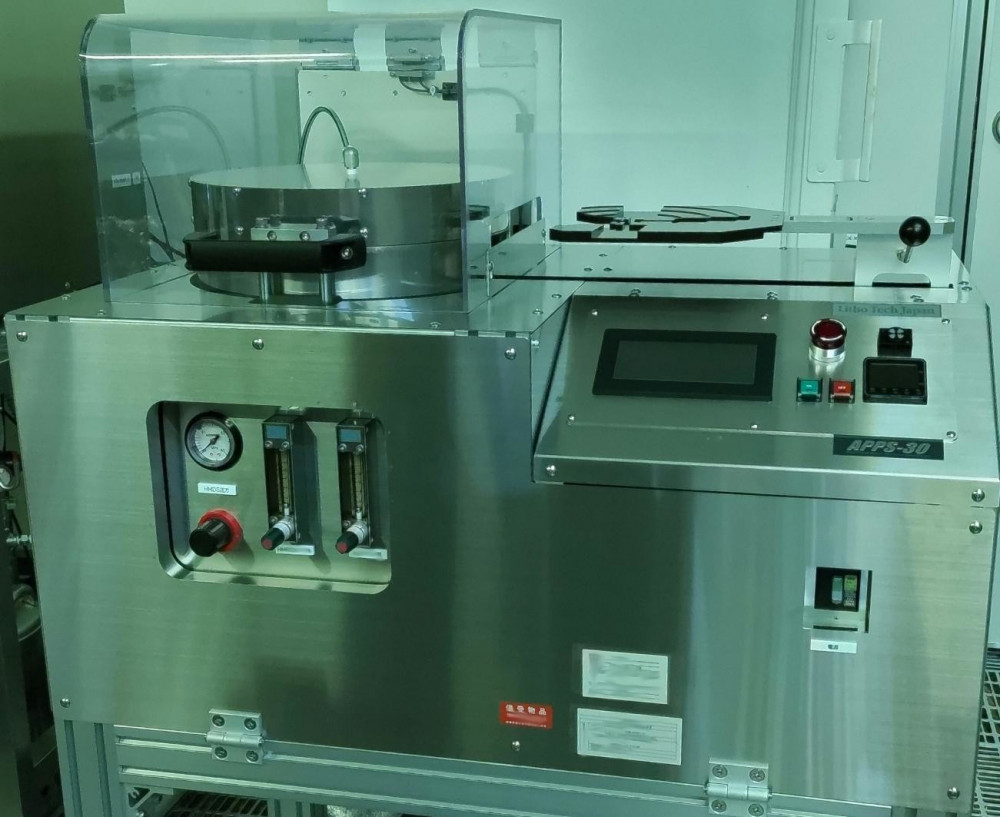
- メーカー名
- リソテックジャパン (Litho Tech Japan)
- 型番
- APPS-30
- 仕様・特徴
- シリコン表面(シラノールSi-O基)をHMDSでメチル基に置換疎水化し、レジスト現像時の密着性を改善する表面処理。スピンコーターを共用してHMDSを塗布すると、発生するアンモニアによって、レジストによっては悪影響が出る。本装置はHMDS塗布専用装置なので悪影響の心配が無い。
基板サイズ:2インチ~300mmウエハ
ベーク温度:60~150℃
HMDS供給:内臓バブリングシステム
レーザー直接描画装置DWL66+2024 (Laser Drawing System DWL66+2024)
- 設備ID
- UT-511
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- ハイデルベルグ (Heidelberg)
- 型番
- DWL66+ (2024,375nm)
- 仕様・特徴
- 波長375nm(半導体レーサー 70mW) 小片アライメントオプション、両面アライメント機能付き。最小リソグラフィサイズ 0.3μm、重ねリソグラフィ精度±3σで500 nm以下(解像度による)、 128階調の「グレイスケールリソグラフィー」により,フォトレジストの立体形状段差をある程度自由に作れる。また、GenISys社の変換ソフトウェア「BEAMER」を使うと、形状を得るために、近接効果の影響を計算して露光補正が可能。
自動フォトマスクエッチング装置AEP-3000S (Auto Photomask Etching Machine)
- 設備ID
- UT-510
- 設置機関
- 東京大学
- 設備画像
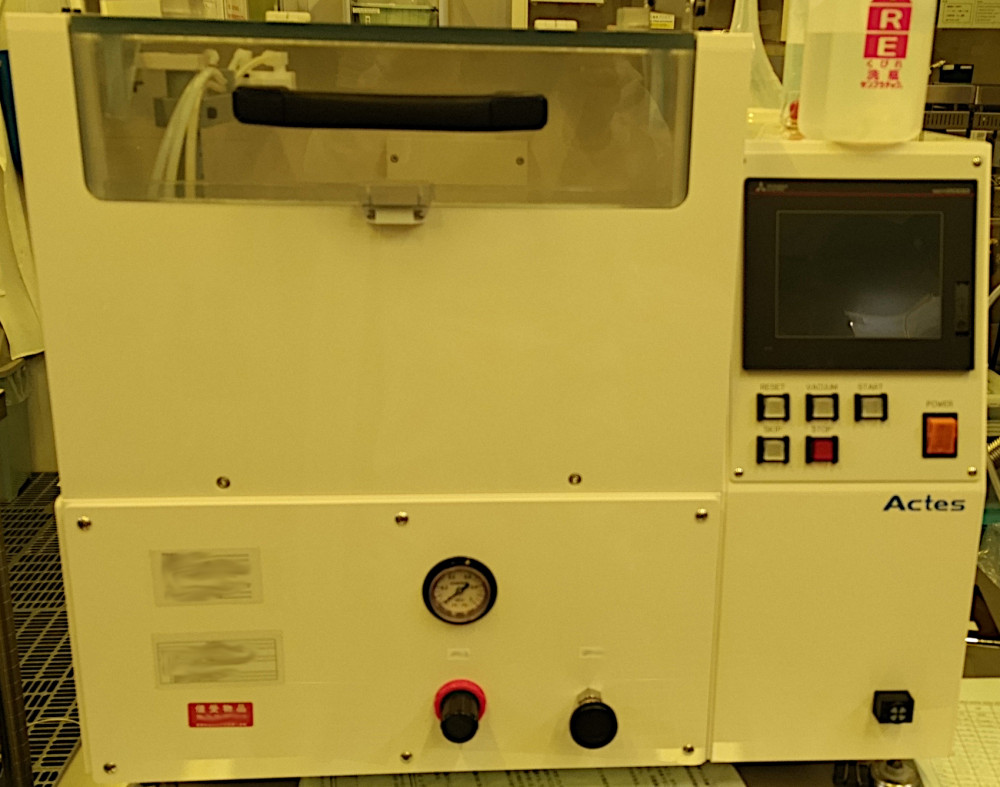
- メーカー名
- アクテス京三(株) (ActesKyosan Inc)
- 型番
- AEP-3000S
- 仕様・特徴
- 東京大学の電子線描画装置を用いて5009サイズのフォトマスクを作製するために使用する自動クロムエッチング装置。
試料サイズ:Φ2ーΦ6インチ、または100x100mm
プログラム設定:1プログラム最大99ステップ、50プログラム保存可能
回転数: 0-3000rpm
開店時間: 0-999sec
ノズル:薬液 2系等、リンス 1系統
大気非暴露対応冷却クロスセクションポリッシャ (Cooling cross section polisher for non-exposure to atmosphere)
- 設備ID
- UT-158
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- IB-19520CCP
- 仕様・特徴
- イオン加速電圧 2~8kV
ミリングスピード 500μm/h以上 (加速電圧8kV)
試料スイング機能±30°自動スイング
自動加工開始モード 〇
自動冷却加工開始モード /
自動室温復帰モード 〇
試料ステージ冷却到達温度 -120°C以下
冷却温度設定範囲 -120~0°C
試料冷却-100°C到達時間 60分以内
試料冷却保持時間 8時間以上