共用設備検索結果
光干渉式膜厚測定装置 (Film thickness measurement instruments)
- 設備ID
- GA-016
- 設置機関
- 香川大学
- 設備画像
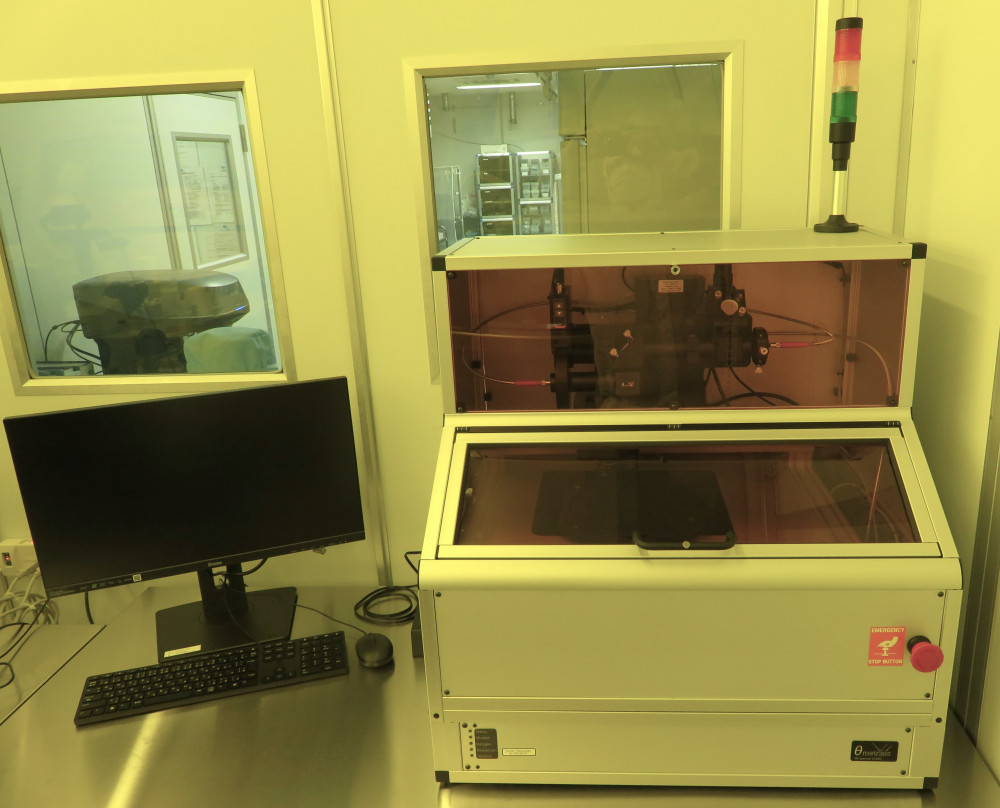
- メーカー名
- シータメトリシス (ThetaMetrisis)
- 型番
- FR-Scanner-AIO-Mic-XY200
- 仕様・特徴
- 測定膜厚範囲(SiO2):10nm – 80μm(10X)
測定精度:0.2% or 2nm
測定波長範囲:380nm~1020nm
多層膜測定:4層まで可能
測定スポット径:10,25,50,100μm
光源:ハロゲンランプ
サンプルサイズ:Max.200 x 200 mm
光学フィルター:Y-48、R-60
その他:自動マッピング
ウエハスピン現像装置 (Wafer spin developer )
- 設備ID
- GA-015
- 設置機関
- 香川大学
- 設備画像
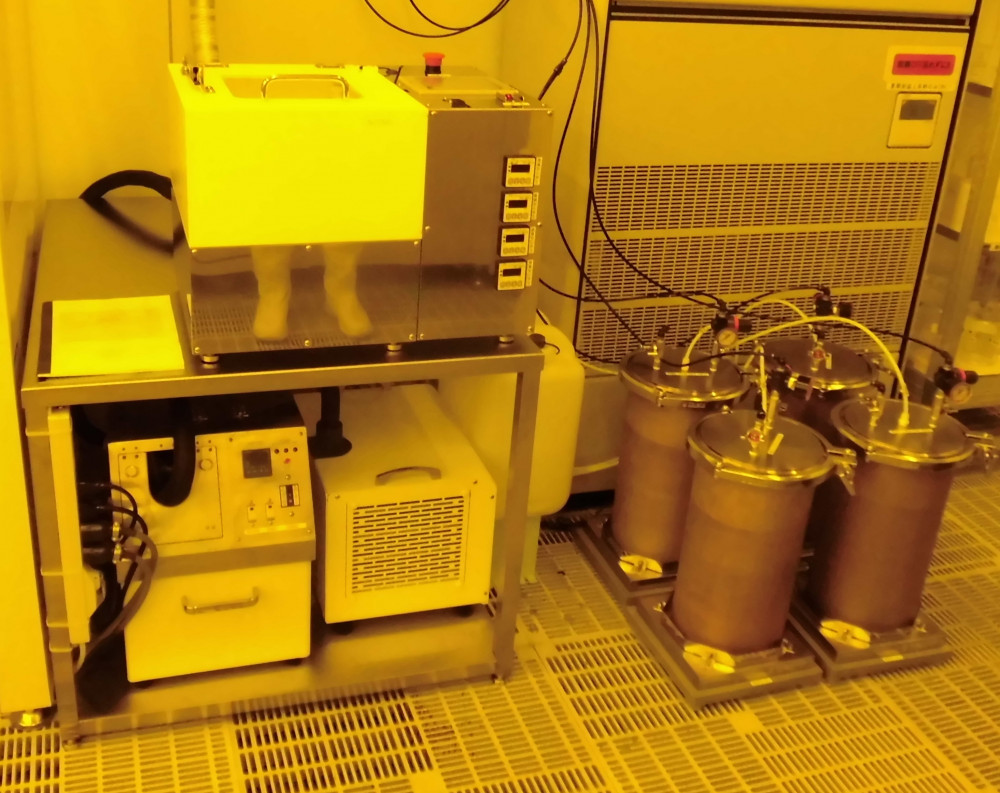
- メーカー名
- 滝沢産業 (TAKIZAWA SANGYO)
- 型番
- AD-1200(無機用),AD-1200(有機用)
- 仕様・特徴
- 基板サイズ:φ4"以下
基板ホルダー:真空吸着式
基板回転数:0~3000rpm 可変式
処理時間:999sec/stop(1sec単位)
使用薬液:無機系アルカリ液対応と有機溶剤対応
処理方法:スプレースイングアーム式
電子線描画装置 (Electron beam lithography system)
- 設備ID
- GA-001
- 設置機関
- 香川大学
- 設備画像

- メーカー名
- エリオニクス (Elionix)
- 型番
- ELS-7500EX
- 仕様・特徴
- 加速電圧:50kV、30kV、20kV
描画可能な最小線幅10nm
フィールドつなぎ精度50nm 以下
描画対象:6インチまで対応可能
所要時間:線幅1μm/2インチウエハ;5~6時間
線幅10nm/2インチウエハ;4日間
マスクレス露光装置 (Mask-less exposure system)
- 設備ID
- GA-002
- 設置機関
- 香川大学
- 設備画像

- メーカー名
- 大日本科研 (Jpn.Sci.Eng.)
- 型番
- MX-1204
- 仕様・特徴
- DMDによるパターン生成露光、
光源:LD(波長375±5nm)
描画方法:直接描画
描画対象:150mm角、
最小描画精度:最小線幅1μm程度、
アライメント精度±0.15μm
スピンコータ- (Spin-coater)
- 設備ID
- GA-003
- 設置機関
- 香川大学
- 設備画像

- メーカー名
- ミカサ (MIKASA)
- 型番
- MS-B150
- 仕様・特徴
- 回転塗布式 1ヘッド
真空吸着方式
試料サイズ:最大154mmφ1mmt
回転数:300–7000r.p.m
回転精度:±1r.p.m
回転時間:最大999.9sec(合計)
回転制御:プログラム方式・最大100段入力可
デュアルイオンビ-ムスパッタ装置 (Dual ion beam sputtering system)
- 設備ID
- GA-004
- 設置機関
- 香川大学
- 設備画像
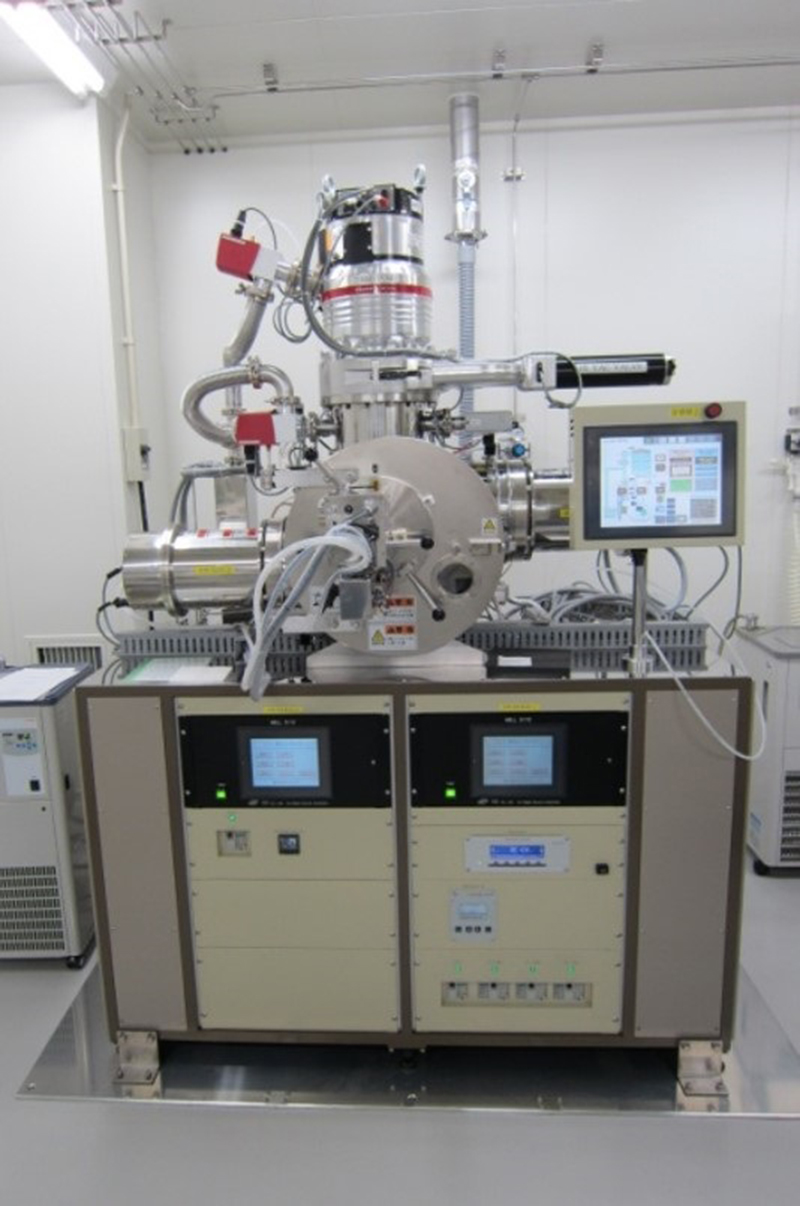
- メーカー名
- ハシノッテク (Hashino-tech)
- 型番
- 10W-IBS
- 仕様・特徴
- 4in-IBS
熱陰極型イオン源:2基(:50~1000eV)
基板加熱温度:最大700゜C
膜形成中のイオン同時照射機能
イオンビ-ムエッチング機能
【ビームガン1:エッチング用】
イオン銃:熱陰極型
イオン化ガス:Ar
ビーム電圧:100~1200V
ビーム電流:50~300mA
加速電圧:75~500V
イオン流密度:0.3~0.6mA/cm2 (500V加速時)
ビーム有効径:φ4インチ(分布測定可能)
真空度:~8x10-5Pa
試料寸法:φ4インチまで
【ビームガン2:デポジション用】
イオン銃:熱陰極型
イオン化ガス:Ar
ビーム電圧:100~1200V
ビーム電流:50~300mA
加速電圧:75~500V
ターゲット:Au、Cr、Tiほか
ステージ角度:ターゲットに対し-90~+90℃設定可
ステージ位置:上下50mm調整可
真空度:~8x10-5Pa
試料寸法:φ4インチまで
触針式表面形状測定器 (Stylus-type surface shape measuring system)
- 設備ID
- GA-005
- 設置機関
- 香川大学
- 設備画像

- メーカー名
- アルバック (ULVAC)
- 型番
- Dektak8
- 仕様・特徴
- 測定分解能:最小:0.1nm
垂直分解能/レンジ:1Å/65kÅ、10Å/655kÅ、40Å/2620kÅ
サンプルサイズ:直径210mm
測定長さ:50μm〜50mm
最大サンプリング数:30,000点
測定加重:1〜15mg
自動多点測定数:最高200点
サンプル観察:
トップビュー(低倍率カラー)10mm
サイドビュー(高倍率カラー)1mm
測定再現性:1nm以下
白色干渉式非接触三次元形状測定器 (White light interference type non-contact three-dimensional shape measuring system)
- 設備ID
- GA-007
- 設置機関
- 香川大学
- 設備画像

- メーカー名
- ブルカー・エイエックスエス (Bruker)
- 型番
- NT91001A-in motion
- 仕様・特徴
- in-situ駆動観察
測定方式:垂直走査型干渉方式
位相シフト干渉方式
分解能:X,Y方向:1μm
Z方向:0.1~1nm
試料ステージ:6インチ
レーザー式非接触三次元形状測定器 (Laser non-contact three-dimensional shape measuring system)
- 設備ID
- GA-008
- 設置機関
- 香川大学
- 設備画像
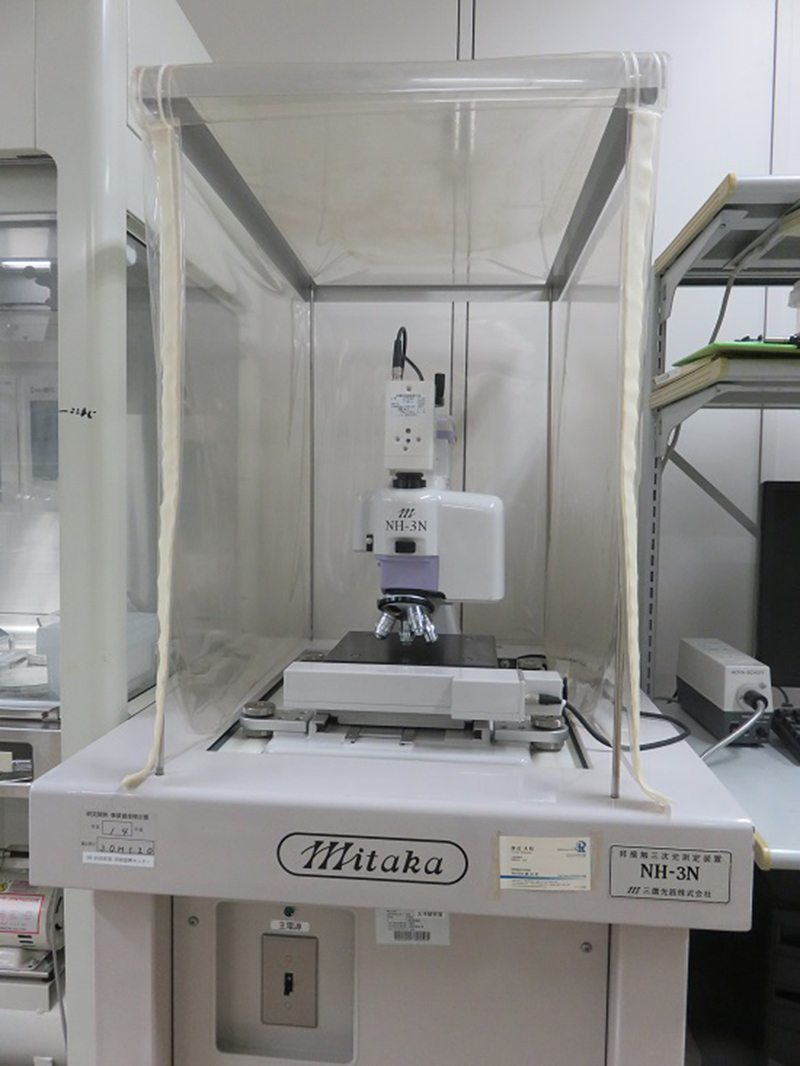
- メーカー名
- 三鷹光器 (Mitaka Kohki)
- 型番
- NH-3N
- 仕様・特徴
- 計測方法:レーザープローブ方式
計測範囲:150mm×150mm×10mm(X、Y、Z)
測定分解能:0.1×0.1×0.01μm
デジタルマイクロスコープ (Digital microscope)
- 設備ID
- GA-009
- 設置機関
- 香川大学
- 設備画像

- メーカー名
- ハイロックス (Hirox)
- 型番
- KH-7700
- 仕様・特徴
- 有効画素数 : 201万画素
最高解像度 : 3000万画素
倍率 : ~400倍