共用設備検索
共用設備検索結果
"広島大学"で検索した結果 56件
- 56件中 31~40件
- <
- 1
- 2
- 3
- 4
- 5
- 6
- >
- 設備ID
- RO-412
- 設置機関
- 広島大学
- 設備画像
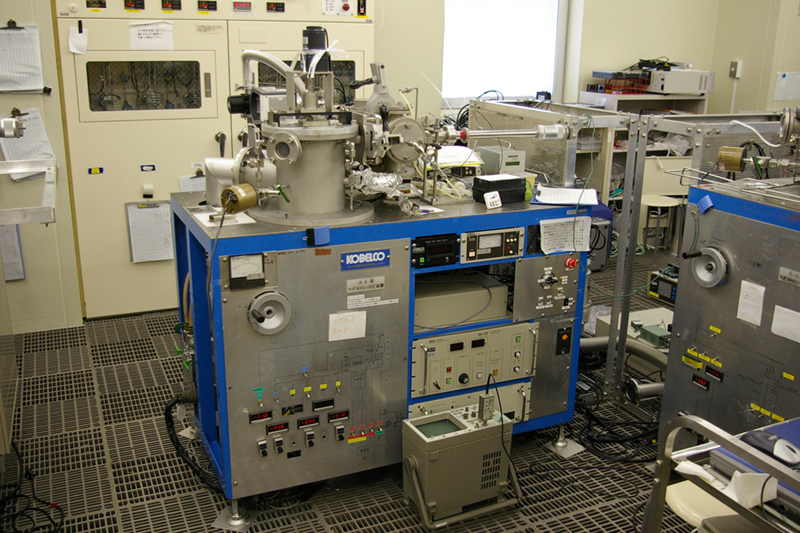
- メーカー名
- 神戸製鋼 (Kobe Steel, Ltd.)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut waferは2inchに貼り付けて対応可
SF6
- 設備ID
- RO-413
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- 住友精密工業 (Sumitomo Precision Products CO.,LTD.)
- 型番
- MUC-21
- 仕様・特徴
- 対応wafer:4inch以下
Bosch Processを用いた深掘エッチング装置, C4F8, SF6, O2, Ar使用可能
- 設備ID
- RO-414
- 設置機関
- 広島大学
- 設備画像
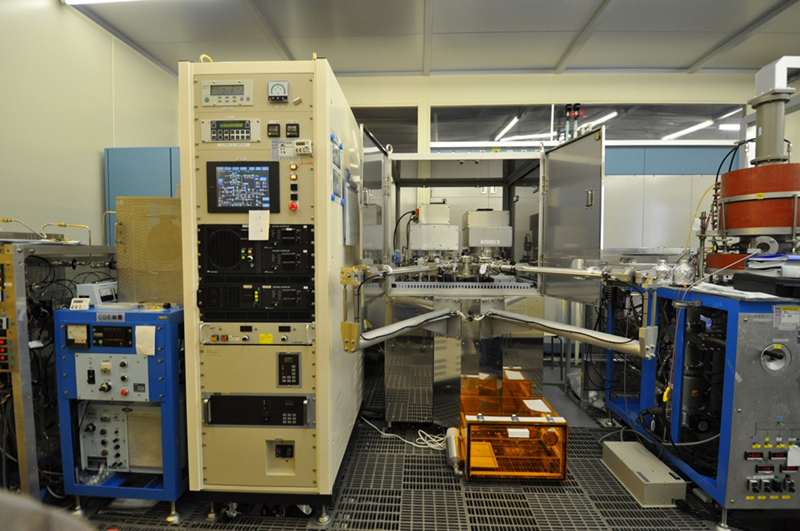
- メーカー名
- 株式会社ユーテック (YOUTECUniversal Technics Co.,Ltd )
- 型番
- 12-228PH
- 仕様・特徴
- 2inch、cut waferは2inchに貼り付けて対応可
Cl2, HBr, N2使用可能
- 設備ID
- RO-415
- 設置機関
- 広島大学
- 設備画像
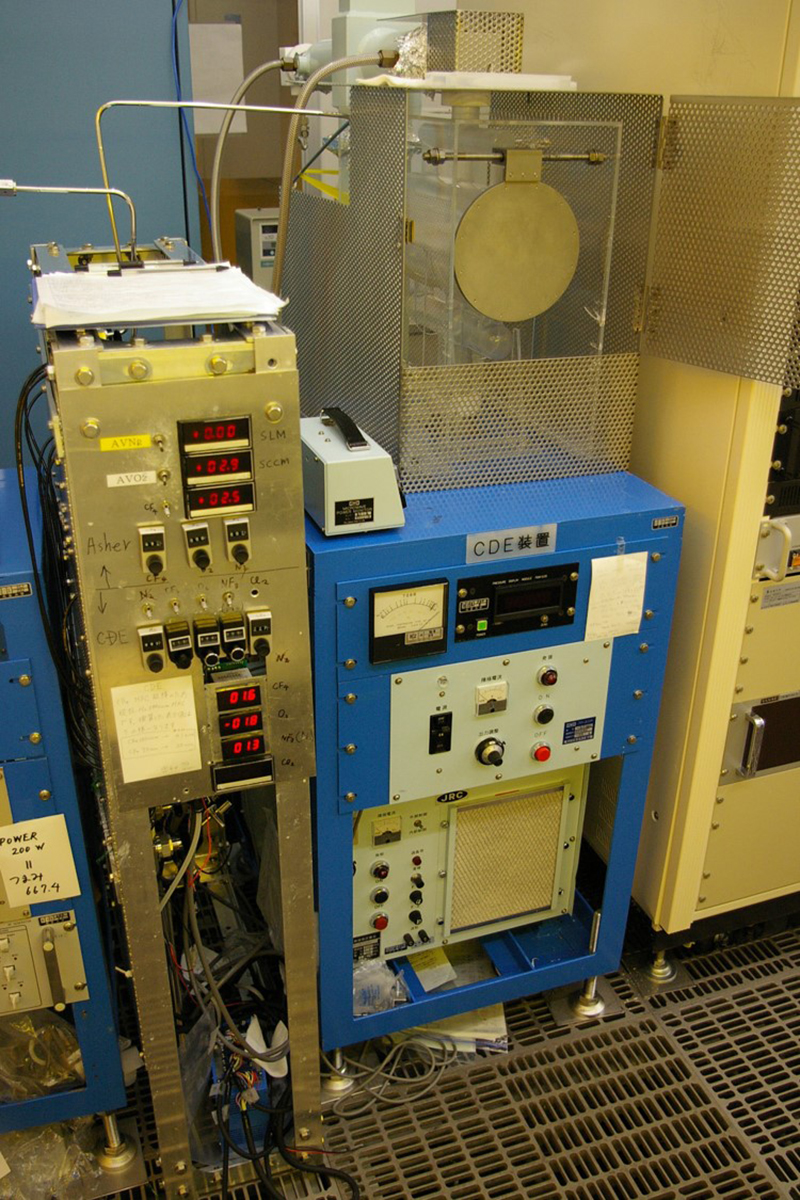
- メーカー名
- 神戸製鋼 (Kobe Steel, Ltd.)
- 型番
- 仕様・特徴
- 2,3inch、cut wafer
CF4, O2, N2使用可能
- 設備ID
- RO-416
- 設置機関
- 広島大学
- 設備画像
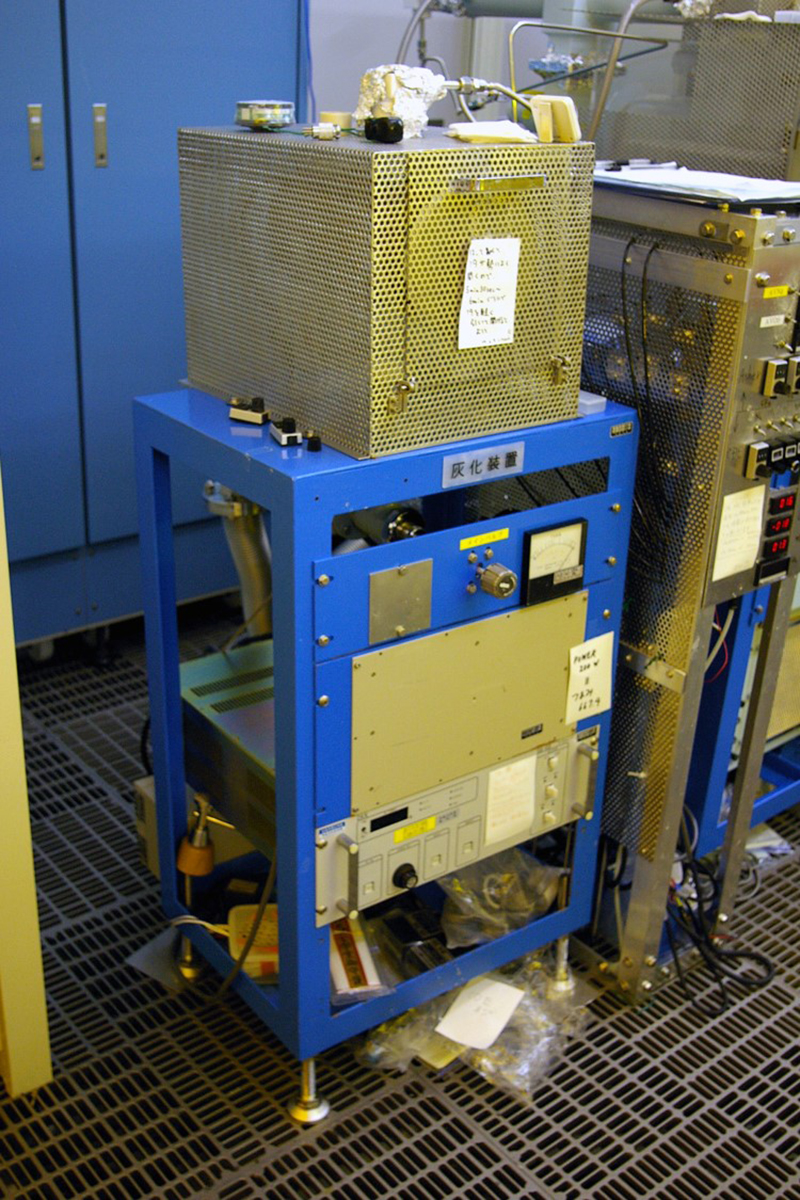
- メーカー名
- 神戸製鋼 (Kobe Steel, Ltd.)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
O2, N2使用可能 レジストアッシング用
- 設備ID
- RO-417
- 設置機関
- 広島大学
- 設備画像
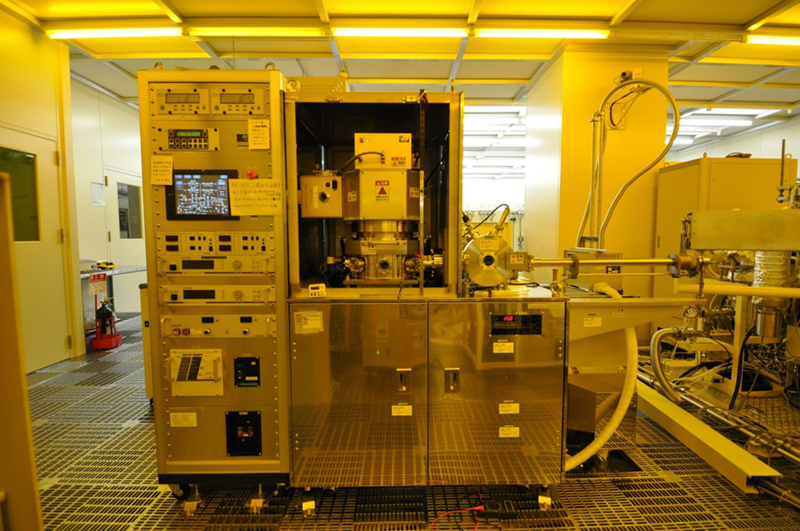
- メーカー名
- 株式会社ユーテック (YOUTECUniversal Technics Co.,Ltd )
- 型番
- 12-228PH
- 仕様・特徴
- 2inch、cut waferは2inchに貼り付けて対応可
Cl2, O2, N2, HBr使用可能
- 設備ID
- RO-418
- 設置機関
- 広島大学
- 設備画像
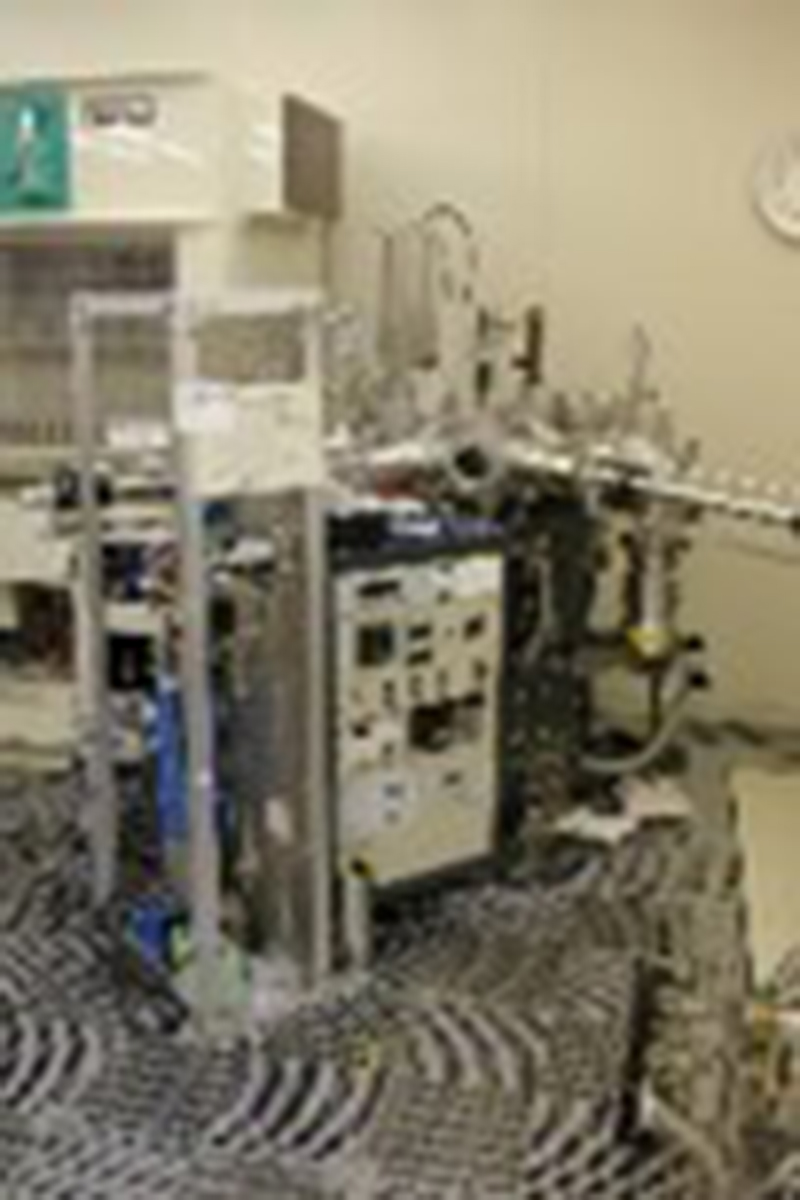
- メーカー名
- 株式会社エイコー (EIKO CORPORATION)
- 型番
- VX-20S
- 仕様・特徴
- 対応wafer:2inch、cut wafer
CF4, O2, N2使用可能
- 設備ID
- RO-511
- 設置機関
- 広島大学
- 設備画像
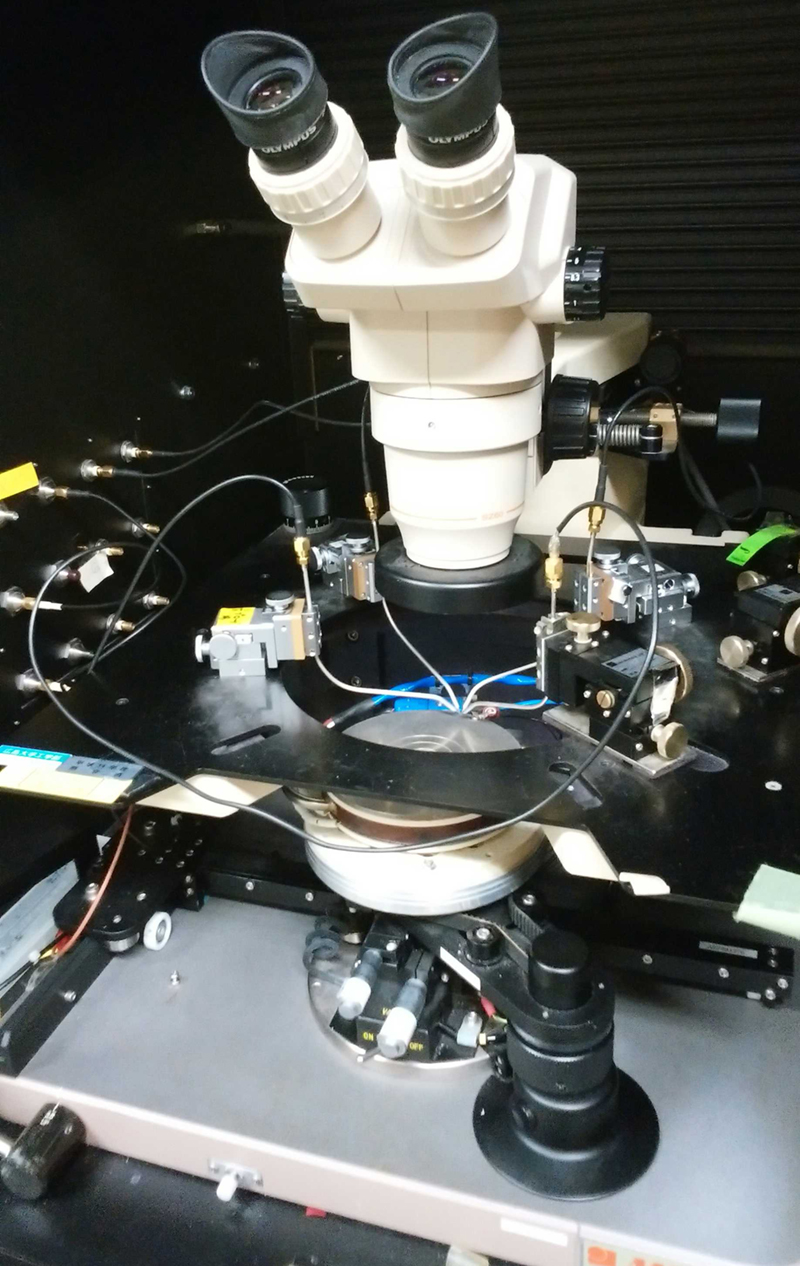
- メーカー名
- 日本マイクロニクス (Micronics Japan)
- 型番
- C-51
- 仕様・特徴
- 解析・評価を行うためのマニュアルプローバ
- 設備ID
- RO-512
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- アジレント (Agilent)
- 型番
- 4156他
- 仕様・特徴
- トランジスタ特性測定(HP4156、プローバ含む)、
電源3ユニット、最小測定電流0.1pA
- 設備ID
- RO-513
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- アジレント (Agilent)
- 型番
- 4284他
- 仕様・特徴
- 周波数 20Hz~1MHz 16048B
"広島大学"で検索した結果 56件
- 56件中 31~40件
- <
- 1
- 2
- 3
- 4
- 5
- 6
- >