共用設備検索
共用設備検索結果
"大阪大学"で検索した結果 32件
- 32件中 11~20件
- <
- 1
- 2
- 3
- 4
- >
- 設備ID
- OS-101
- 設置機関
- 大阪大学
- 設備画像
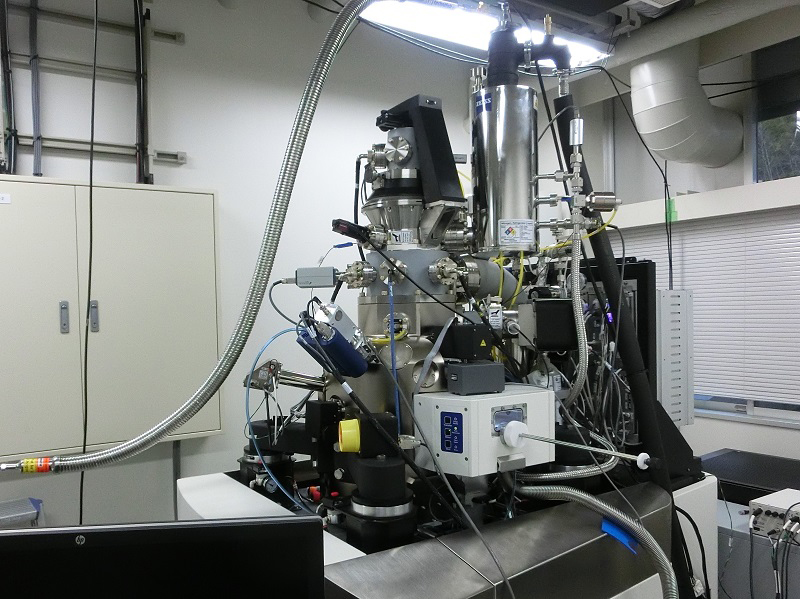
- メーカー名
- カールツァイス (Carl Zeiss)
- 型番
- ORION NanoFab
- 仕様・特徴
- 【特徴】
イオン源にHeガスを採用し、最小ビーム径0.5nmφ の分解能を有する。
FIB:10nm以下の微細加工が可能。
ヘリウムイオン顕微鏡:中和銃装備のため導電性処理無しで絶縁体の観察が可能。生体試料の観察にも適する。
【仕様】
イオン源:He / Ne (希ガス)
最小ビーム径:0.5 nm (He),1.9 nm (Ne)
加速電圧:10~40 kV
ET検出器:2次電子
電子中和銃(Flood gun)装備
GIS:Pt、SiO2、XeF2
試料サイズ: 45mmφ
- 設備ID
- OS-102
- 設置機関
- 大阪大学
- 設備画像

- メーカー名
- カールツァイス (Carl Zeiss)
- 型番
- Nvision 40D with NPVE
- 仕様・特徴
- 【特徴】
30kVのGa+イオンによるFIB加工及び加工時のSEM観察が可能。FIBによる気相蒸着によりPtおよびSiO2による配線の修復が可能。
【仕様】
ステージサイズ:max 8 inch
Pt銃、SiO2銃装備
FE-SEMユニット, 加速電圧:30kV
検出器:InLens, SE, Esb
FIBユニット, 加速電圧:30kV
最小ビーム径:4nm
- 設備ID
- OS-103
- 設置機関
- 大阪大学
- 設備画像
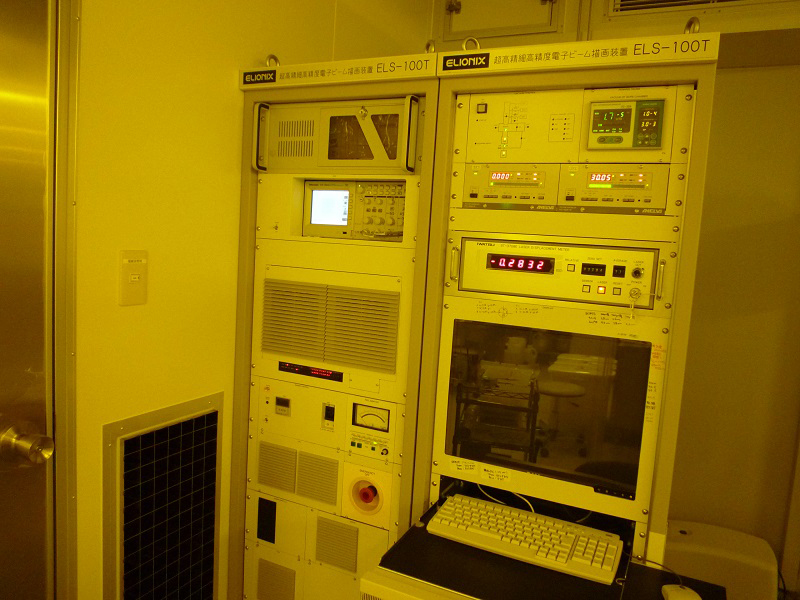
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-100T
- 仕様・特徴
- 【特徴】
最小ビーム径φ1.7nmにて線幅10nm以下の細線描画が可能。
【仕様】
描画最小線幅:5nm
繋ぎ重ね精度:15nm以下
電子銃:ZrO/W熱電界放射型
描画方式:ベクタースキャン方式
加速電圧:125kV, 100kV, 75kV, 50kV
描画フィールド:75µm□~2400µm□
最大試料サイズ:6inch
- 設備ID
- OS-104
- 設置機関
- 大阪大学
- 設備画像

- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-BODEN-OU4801
- 仕様・特徴
- 【特徴】
ZnO/W熱電解放射型電子銃の採用により、最小ビーム径1.5nmφの極細線用ビームを長時間安定して使用することができます。また最高150kVの加速電圧を採用し、最小線幅4nmの描画が可能です。
【仕様】
加速電圧:150kV
最小電子ビーム径:φ1.5nm
最小描画線幅:4nm
ビーム電流可変域:5pA-100nA
描画フィールドサイズ:□100μm、□250μm、□500μm
- 設備ID
- OS-105
- 設置機関
- 大阪大学
- 設備画像
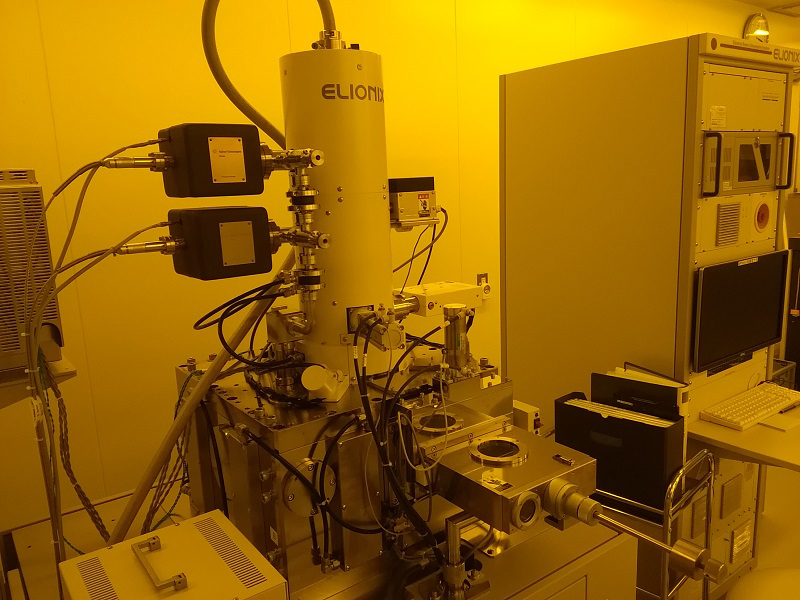
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-S50LBC
- 仕様・特徴
- 【特徴】
加速電圧50kVで1µAのビーム電流が得られる。最高クロック周波数100MHzの高速ビーム変更システムを搭載し、大面積を高スループットで描画することに特化。
【仕様】
電子銃:ZrO/W熱電界放出型(TFE)
描画方式:ベクタースキャン方式
加速電圧:20, 30, 50kV
ビーム電流:100pA~1µA
描画フィールド:100µm□~3000µm□
試料サイズ:10~25mm□、3インチ□、4インチ・6インチφウエハ
- 設備ID
- OS-107
- 設置機関
- 大阪大学
- 設備画像
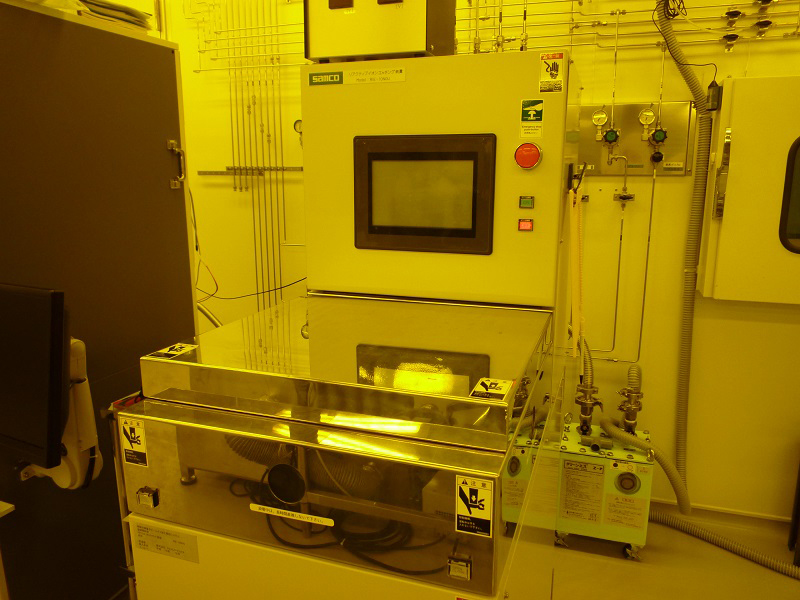
- メーカー名
- ミカサ (Mikasa)
- 型番
- MA-10
- 仕様・特徴
- 【特徴】
UV露光、マニュアルタイプ、コンタクト露光機。二視野顕微鏡採用によるスピーディで正確なアライメント。
【仕様】
試料は 2 inch φ、マスクは 3 inch角まで対応
水銀灯250W光源(ブロード波長)
二視野顕微鏡採用
- 設備ID
- OS-108
- 設置機関
- 大阪大学
- 設備画像
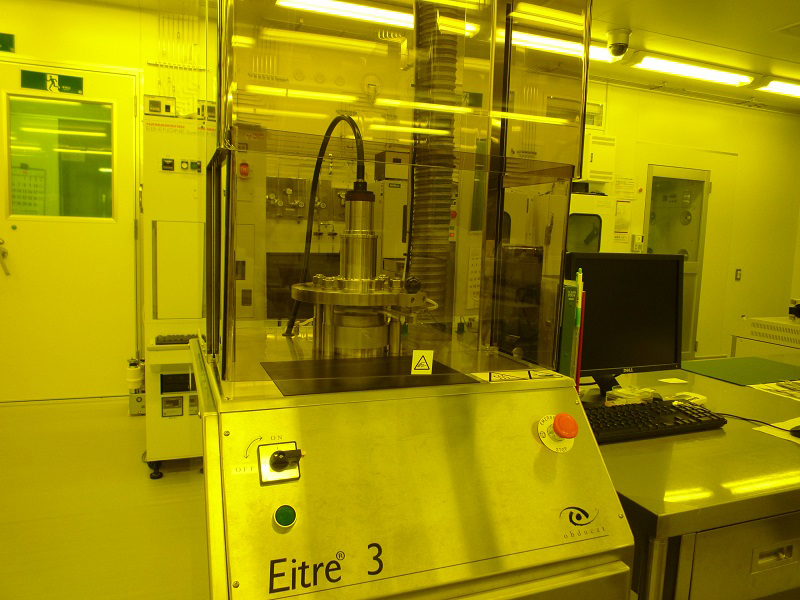
- メーカー名
- オブデュキャット (Obducat)
- 型番
- Eitre 3
- 仕様・特徴
- 【特徴】
UV(波長 365, 405, 436nm)と熱(室温~200℃)を使って、最大3インチの微細パターンを転写可能。エア加圧(最大50bar)なので基板全面に均一に転写でき、異物によるモールドの破損が少ない。鋳型準備が必要だが同じパターンを複数作製したいユーザーに最適。
【仕様】
熱・UVの両方式に対応
試料サイズ:3 inch
- 設備ID
- OS-109
- 設置機関
- 大阪大学
- 設備画像
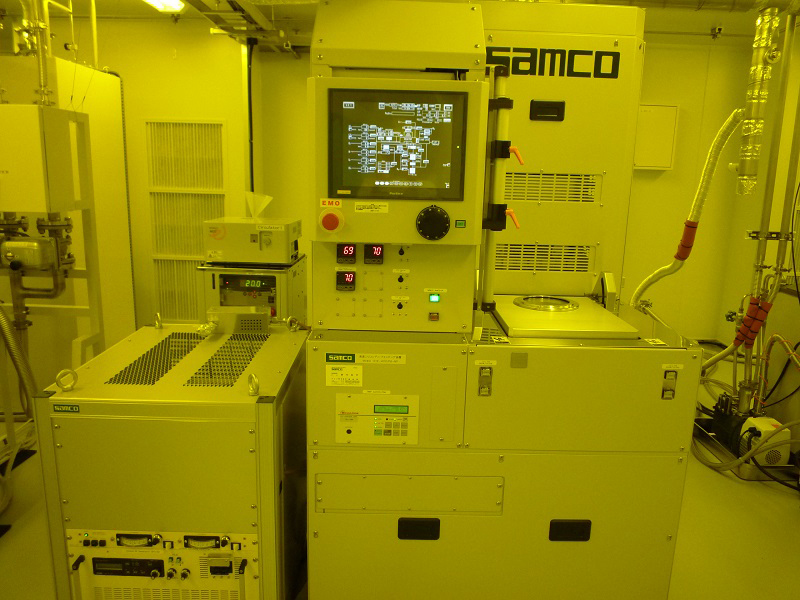
- メーカー名
- サムコ (Samco)
- 型番
- RIE-400iPB-NP
- 仕様・特徴
- 【特徴】
誘電結合方式(ICP)を採用したボッシュプロセス対応の高速シリコンディープエッチング装置。1分間に10μm以上のSiエッチングが可能。MEMS、電子部品等に求められるシリコンの高速かつ高異方性エッチングに対応。
【仕様】
試料サイズ:max 4inch
プロセスガス:CF4, C4F8, CHF3, SF6, O2, Ar
- 設備ID
- OS-110
- 設置機関
- 大阪大学
- 設備画像
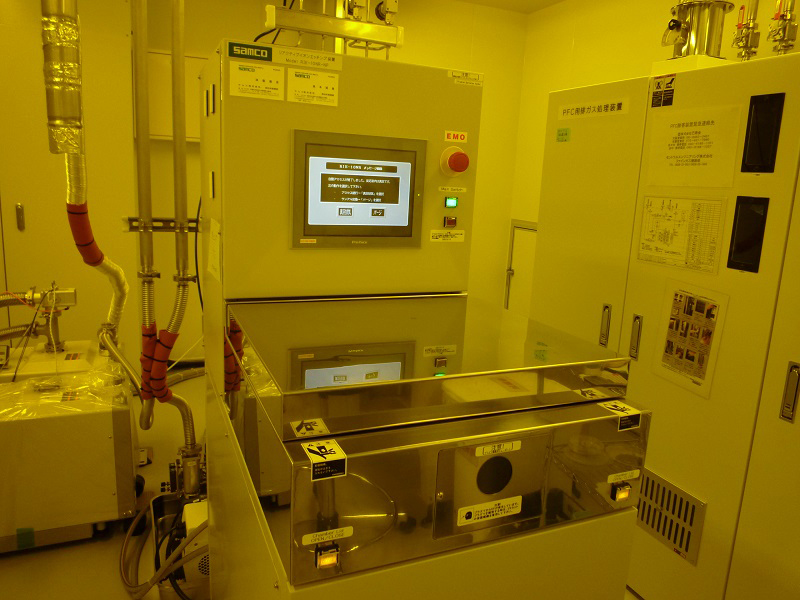
- メーカー名
- サムコ (Samco)
- 型番
- RIE-10NR-NP
- 仕様・特徴
- 【特徴】
Si、Poly-Si、SiO2、Si3N4などの各種シリコン薄膜の高精度エッチングを目的としたRIE(リアクティブイオンエッチング)装置
【仕様】
試料サイズ:max 8 inch
プロセスガス:CF4, CHF3, O2, Ar
- 設備ID
- OS-111
- 設置機関
- 大阪大学
- 設備画像
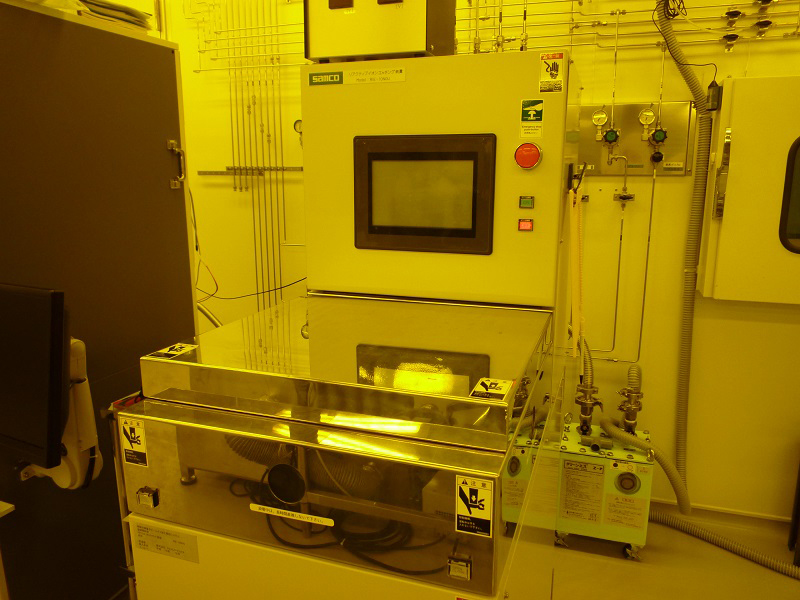
- メーカー名
- サムコ (Samco)
- 型番
- RIE-10NOU
- 仕様・特徴
- 【特徴】
Si、Poly-Si、SiO2、Si3N4などの各種シリコン薄膜の高精度エッチングを目的としたRIE(リアクティブイオンエッチング)装置
【仕様】
試料サイズ:max 8 inch
プロセスガス:CF4, O2, Ar, CHF3
"大阪大学"で検索した結果 32件
- 32件中 11~20件
- <
- 1
- 2
- 3
- 4
- >