共用設備検索結果
東京エレクトロン300mm ウェハプローバ (Tokyo Electron 300mm Wafer Prober)
- 設備ID
- IT-035
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- 東京エレクトロン (Tokyo Electron)
- 型番
- PrecioNanoPV00043
- 仕様・特徴
- 150mm, 200mm, 300mmウェハ対応プローバー
多数枚自動測定対応、シリコンフォトニクス受動デバイス静特性測定
FormFactor 300mm ウェハプローバ (FormFactor 300mm Wafer Prober)
- 設備ID
- IT-036
- 設置機関
- 東京工業大学
- 設備画像
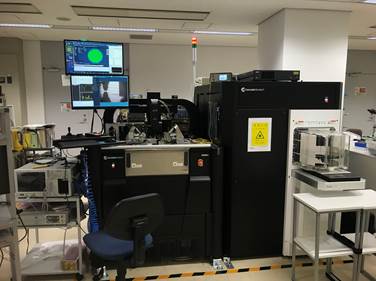
- メーカー名
- FormFactor (FormFactor)
- 型番
- CM300
- 仕様・特徴
- チップ~ 300mmウェハ対応プローバー
単枚自動測定対応、シリコンフォトニクス受動デバイス静/動特性測定
クリーンルーム付帯設備一式 (Equipments for clean room)
- 設備ID
- IT-037
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- KLA テンコール キーエンス キーエンス 等のメーカー (KLA Tencor Keyence Keyence and other manufacturers)
- 型番
- P-7 VHX-D510 VHX-7000
- 仕様・特徴
- 純水製造装置・薬品処理ドラフトチャンバー・レジスト処理装置・光学顕微鏡(デジタル含)、低真空SEM、触針式段差計などを含むクリーンルーム用設備群
・触針式段差計: Φ150mm電動ステージ > 長距離測定(最大150mm) 垂直測定レンジ(最大)327μm 垂直測定分解能(最高)0.001nm 段差測定再現性 1σ=0.4nm (1μm標準試料) 針圧範囲 0.5~50mg
・低真空SEM: レンズ:電子式超深度レンズ+光学 倍率:30-5000倍(垂直)、30-2000倍(傾斜)、50-500倍(光学) 観察像: 2次電子 試料サイス?: Φ100 mm 5軸(XYZ+傾斜+回転) 試料室200 mm ×200 mm 試料高さ 30 mm
・デジタル顕微鏡: ハイレゾリューションヘッド : 1/1.7 型 1,222万 画素 CMOSイメージセンサ 総画素 4,168 (H) × 3,062 (V) 実効画素 4,024 (H) × 3,036 (V)
電子ビーム露光装置 (Electron beam lithograph system)
- 設備ID
- IT-038
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- 日本電子 (JEOL)
- 型番
- JBX-8100
- 仕様・特徴
- スポットビーム、ベクタースキャン方式。 ビーム径3nm以下(100kV)、最小線幅8nm。つなぎ精度:仕様20nm/実測7.6nm(フィールドサイズ1000um)、重ね合わせ精度:仕様20nm/9.8nm(フィールドサイズ1000um)試料最大150㎜φウエーハまで 不定形も可能
JEOL01,51,52などの日本電子製電子ビーム露光用パターンデータファイルが入出力可能。
各露光基板形状に基づいたモンテカルロシミュレーションによって点拡がり関数(PSF)を導出でき、得られたPSFに基づく近接効果補正が可能なソフトウェア(GenISys Beamer)を含む。