共用設備検索
共用設備検索結果
"東京工業大学"で検索した結果 34件
- 34件中 11~20件
- <
- 1
- 2
- 3
- 4
- >
- 設備ID
- IT-012
- 設置機関
- 東京工業大学
- 設備画像
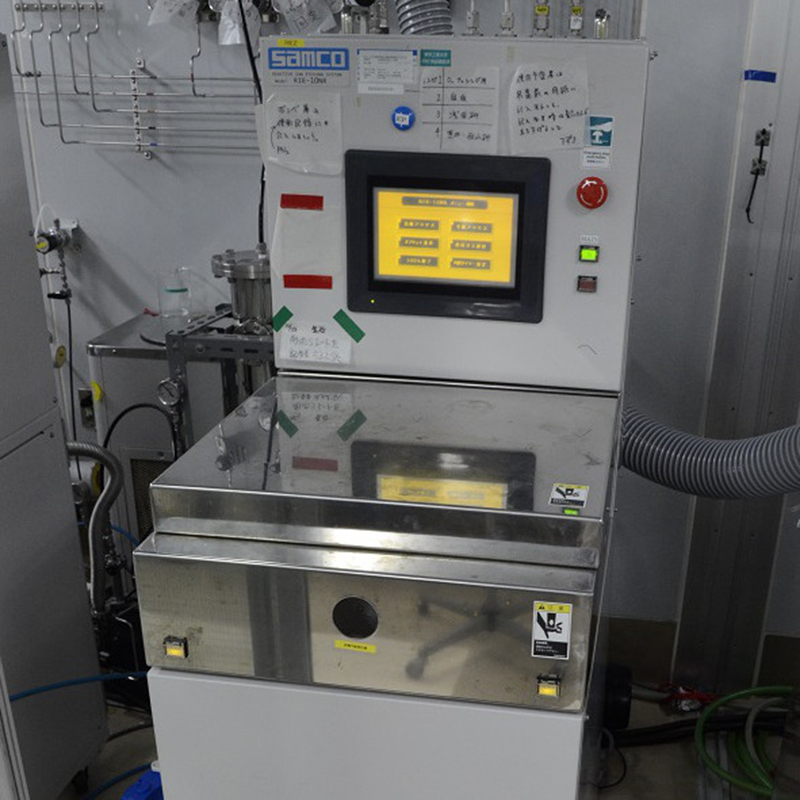
- メーカー名
- サムコ (Samco)
- 型番
- RIE_10NR
- 仕様・特徴
- ・各種シリコン薄膜(Si, SiO2, poly-Si, Si3N4等)の高精度エッチング装置
・グラフィックタッチパネルによる全自動運転 ・最大φ8インチウエハー加工可能
・高速排気エッチング ガスの種類:CH4, H2, O2, Ar,CF4, O2
- 設備ID
- IT-013
- 設置機関
- 東京工業大学
- 設備画像
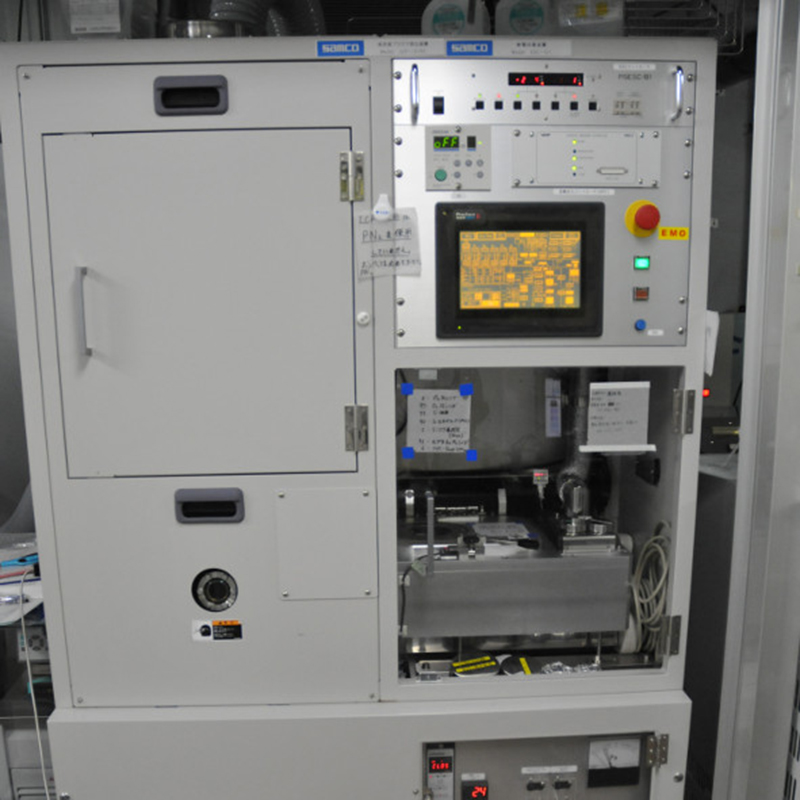
- メーカー名
- サムコ (Samco)
- 型番
- ICP-101RF
- 仕様・特徴
- ・使用ガス:CF4, SF6, CH4, H2, O2
・4-inchウエハまで対応 シリコン加工関連のみに限定対応
- 設備ID
- IT-014
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- サムコ (Samco)
- 型番
- ICP-400iP
- 仕様・特徴
- ダイヤモンドやシリコン、SiO2などを高密度プラズマでエッチングする装置です。また、屈折率差がある材料であれば、終点検知も可能です。最大4インチ, 2インチ以下なら不定形基板の取り扱いができます。ガス種:CHF3, O2, CF4
- 設備ID
- IT-015
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- サムコ (Samco)
- 型番
- PD-100ST
- 仕様・特徴
- PD-100ST 使用ガス: TEOS、O2、CF4 最大3インチまで
- 設備ID
- IT-016
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- 住友精密工業 (STS)
- 型番
- Multiplex-CVD
- 仕様・特徴
- シリコン窒化膜/アモルファスシリコンの成膜
- 設備ID
- IT-017
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- ケーサイエンス (K-science Inc)
- 型番
- KS-702-KM
- 仕様・特徴
- ゲージコントローラ、CDGコントローラ装備 ・膜厚計装備 ・スパッタコントローラ装備 ・Ti, W, TiW ロードロック付き装置
- 設備ID
- IT-018
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- ケーサイエンス (K-science Inc)
- 型番
- KS-702KAM
- 仕様・特徴
- ゲージコントローラ、CDGコントローラ装備
・膜厚計装備
・スパッタコントローラ装備
・SiN、Ta2O3、SiO2 最大2インチ程度まで
- 設備ID
- IT-019
- 設置機関
- 東京工業大学
- 設備画像
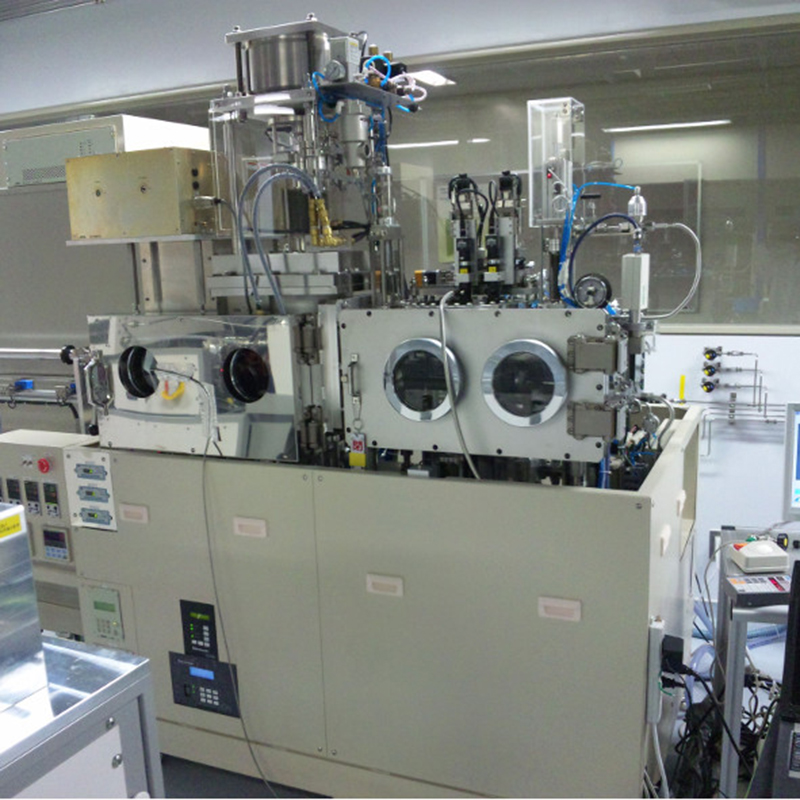
- メーカー名
- アユミ工業 (Ayumi Inc)
- 型番
- VE-07-18
- 仕様・特徴
- ・対応基板サイズ:2インチウェハ,2 cm×2 cm角,3 cm×3 cm角
・プラズマ反応ガス:Ar, N2, O2
・最大プラズマ強度:750W
・アライメント精度<±1.6 μm
・チャンバー真空度:~10-5 Pa
・最大加熱温度:500℃
・アライメント部 加重範囲:5~100 kgf
・加重部 加重範囲:50~1000 kgf
- 設備ID
- IT-020
- 設置機関
- 東京工業大学
- 設備画像
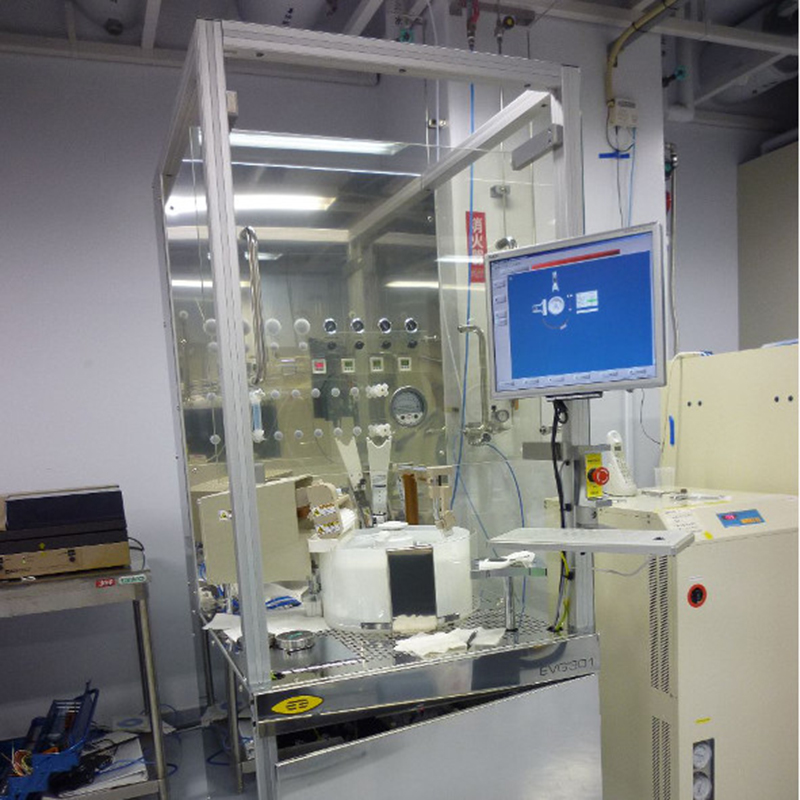
- メーカー名
- EVG (EVG)
- 型番
- EVG301
- 仕様・特徴
- ・PVA製スポンジブラシ洗浄 ・メガソニック洗浄(最大振動子出力:40 W) ・対応基板サイズ:2インチウェハ/2 cm×2 cm角/3 cm×3 cm角
- 設備ID
- IT-021
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- バイオ・ラッド ラボラトリーズ (Bio-rad)
- 型番
- POLARON PN4400
- 仕様・特徴
- ワイドバンドギャップ半導体評価も可能
"東京工業大学"で検索した結果 34件
- 34件中 11~20件
- <
- 1
- 2
- 3
- 4
- >