共用設備検索
共用設備検索結果
"東京工業大学"で検索した結果 34件
- 34件中 1~10件
- 1
- 2
- 3
- 4
- >
- 設備ID
- IT-039
- 設置機関
- 東京工業大学
- 設備画像
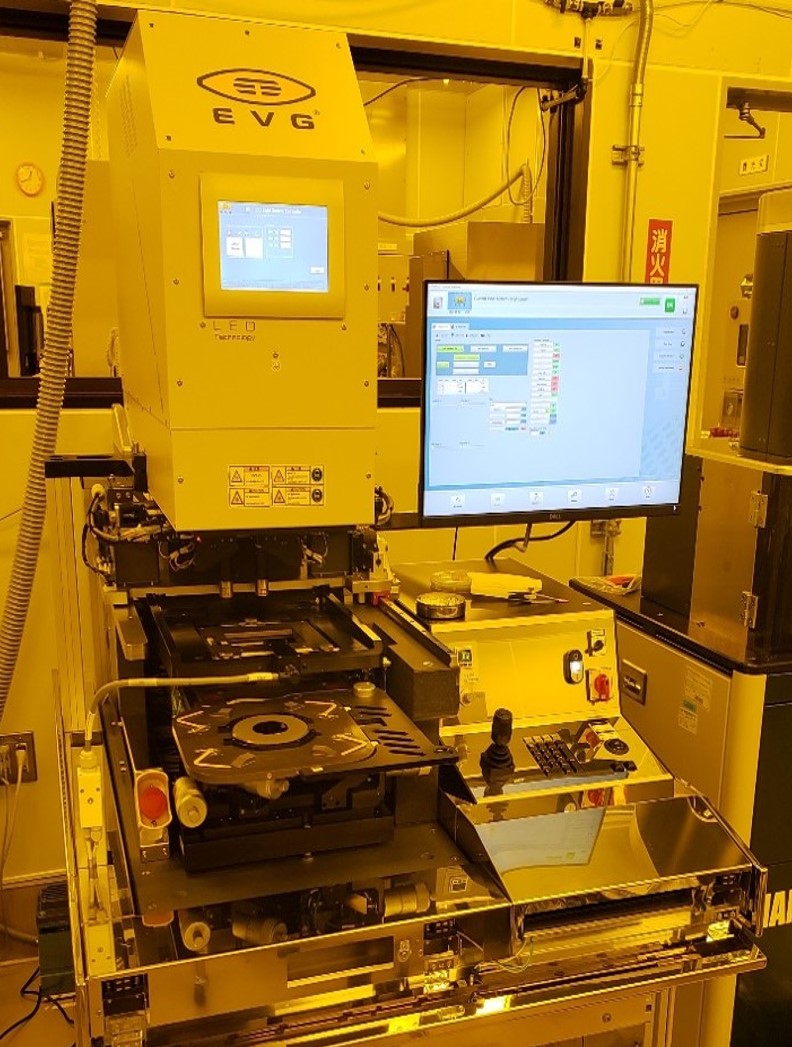
- メーカー名
- EVG (EVG)
- 型番
- EVG620NT
- 仕様・特徴
- UVによるナノインプリント露光装置。4inchまで対応。解像度限界 L/S 50nm。
- 設備ID
- IT-003
- 設置機関
- 東京工業大学
- 設備画像
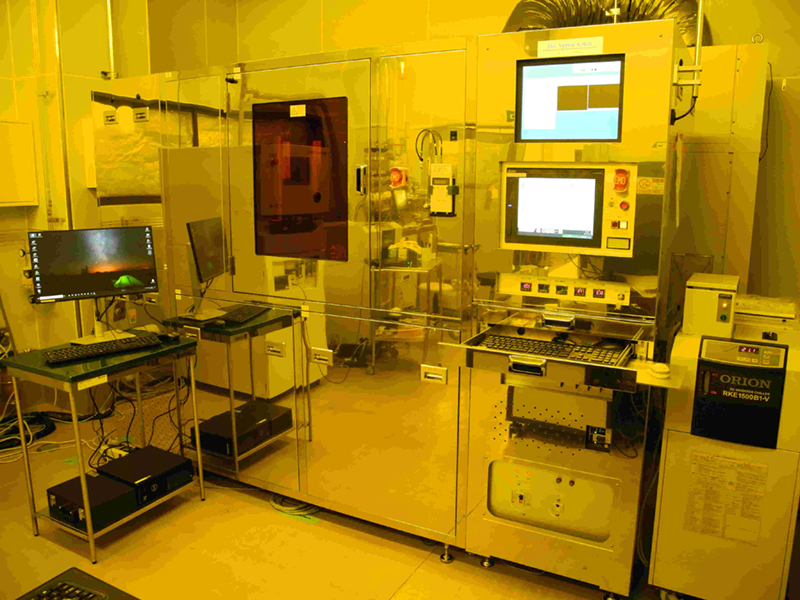
- メーカー名
- 大日本科研 (Japan Science Engineering Co., Ltd.)
- 型番
- MX-1205
- 仕様・特徴
- DMDによるパターン生成露光、100mm角露光サイズ、最小描画画素1μm、アライメント精度±0.15μm データ取り込み機能
- 設備ID
- IT-004
- 設置機関
- 東京工業大学
- 設備画像
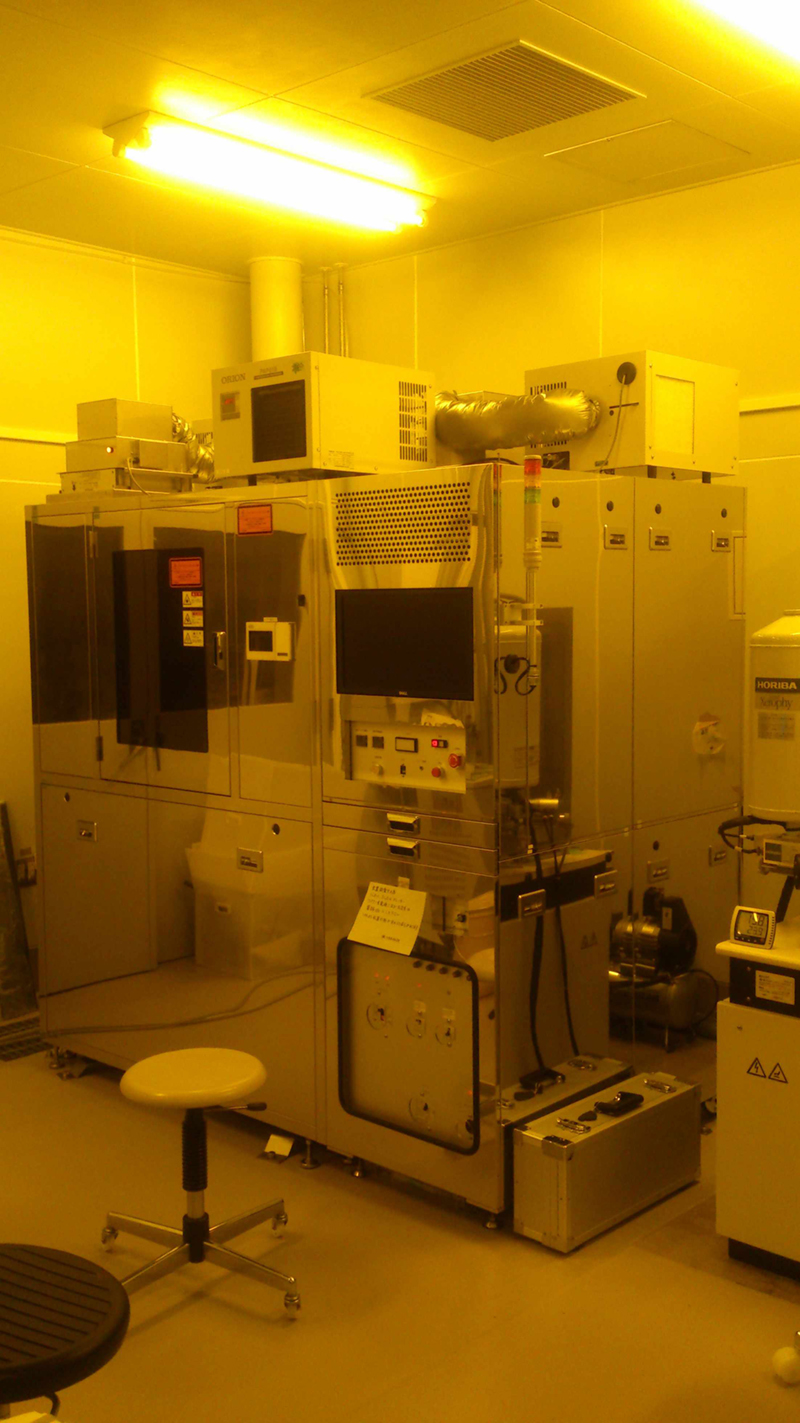
- メーカー名
- 大日本科研 (Japan Science Engineering Co., Ltd.)
- 型番
- MX-1204
- 仕様・特徴
- DMDによるパターン生成露光、150mm角露光サイズ、最小描画画素2μm、アライメント精度±0.15μm
- 設備ID
- IT-005
- 設置機関
- 東京工業大学
- 設備画像
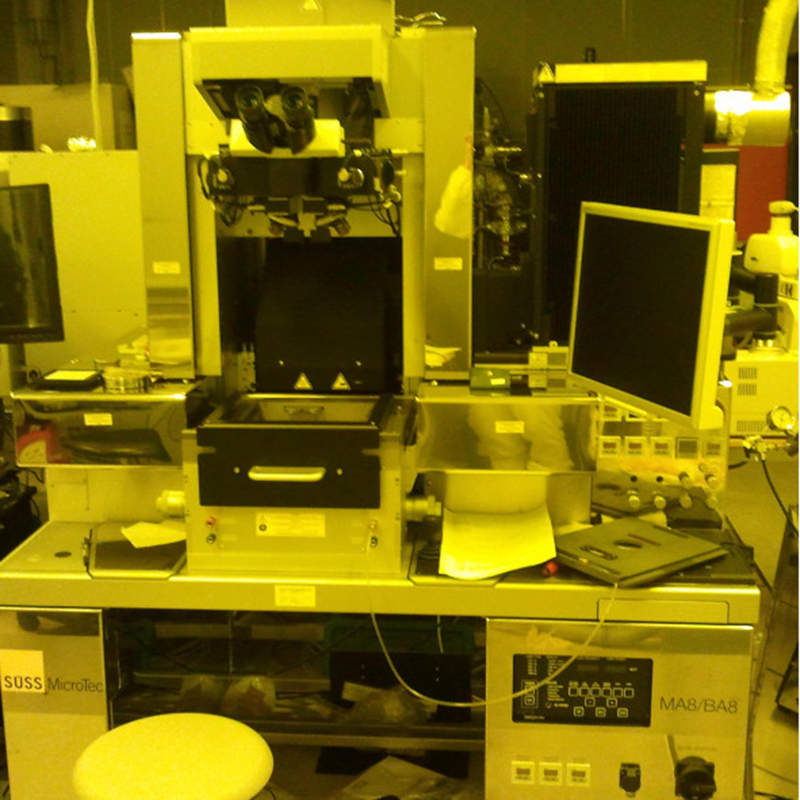
- メーカー名
- ズース ( Süss)
- 型番
- MA-8
- 仕様・特徴
- ・アシスト機能装備、TSA/BSA装備
・表面アライメント制度 TSA:±0.25μm以下 BSA:±1.00μm以下
・露光解像度 0.5μm
・対応基板 小片~直径2inch ウェハ
- 設備ID
- IT-006
- 設置機関
- 東京工業大学
- 設備画像
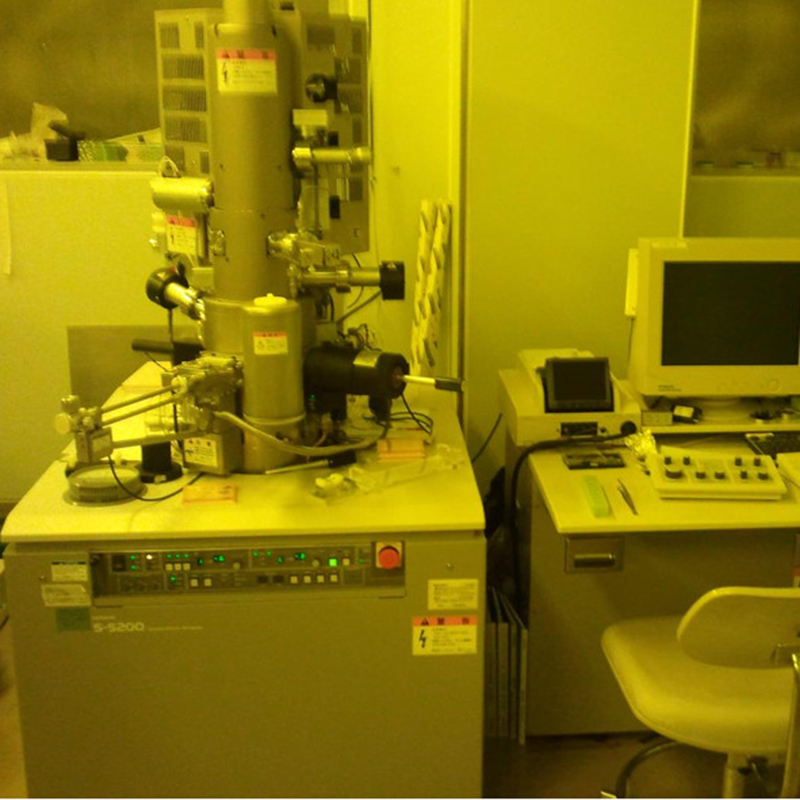
- メーカー名
- 日立 (Hitachi)
- 型番
- S5200
- 仕様・特徴
- 高解像度用インレンズ式高解像度用インレンズ式 加速電圧1kV~30kV 分解能0.5nm(30kV)~1.7nm(1kV) 倍率X100~X2000K STEMモード可
- 設備ID
- IT-007
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- 日立 (Hitachi)
- 型番
- S4500
- 仕様・特徴
- 電界放出型 ・冷陰極電界放出型電子銃 ・分解能:1.5 nm (加速電圧 15 kV WD=4mm) 4.0 nm (加速電圧1 kV WD=3mm) ・試料サイス:最大50 mm (直径)
- 設備ID
- IT-008
- 設置機関
- 東京工業大学
- 設備画像
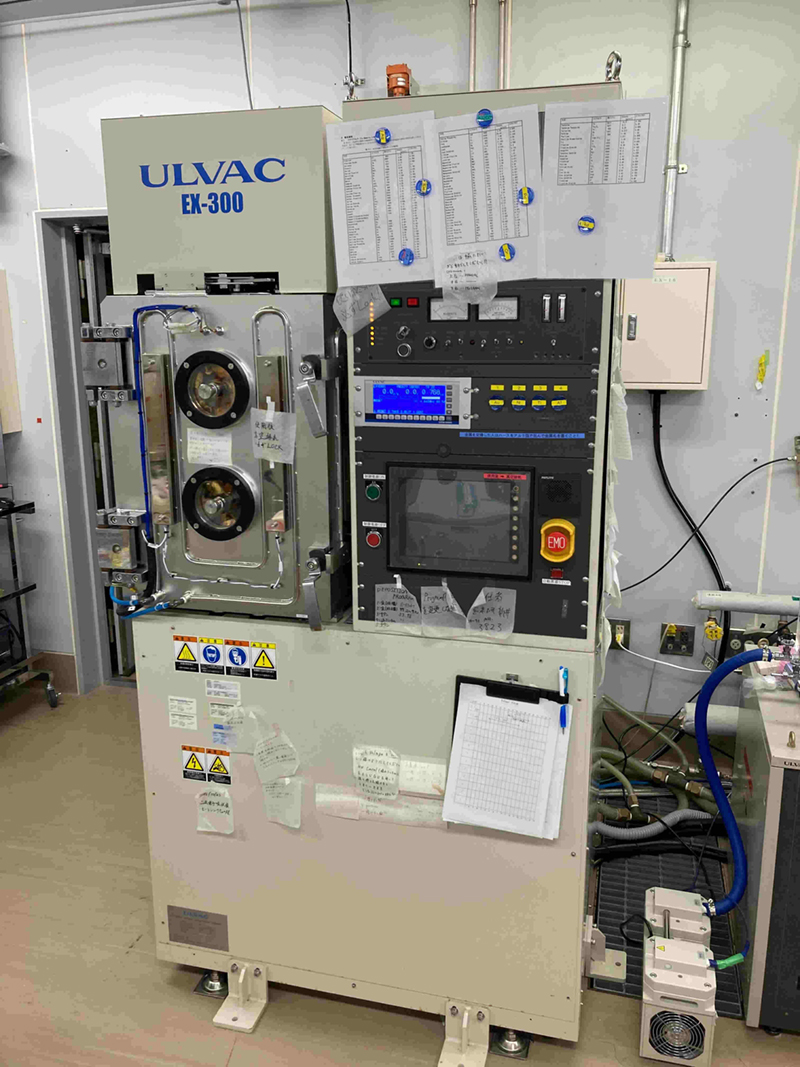
- メーカー名
- アルバック ( Ulvac)
- 型番
- EX-300
- 仕様・特徴
- 300mm対応 高速排気
- 設備ID
- IT-009
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- エイコーエンジニアリング ( Eiko-engineering)
- 型番
- 特注品
- 仕様・特徴
- ロードロックチャンバ付 6連E-gun 6kW 3連EBガン×2 到達真空度: 5e-8Torr以下 基板サイズ: 20mm角まで 蒸着原材料: Ti,Pd,Ni,Cr,Au
- 設備ID
- IT-010
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- 日本酸素 ( Nippon Sanso)
- 型番
- HR-3246
- 仕様・特徴
- InP用 ・ウェハトレイ:石英製2インチウェハトレイ ・III族材料:TEG,TMG,TMA,TMI,CBr4 ・V族材料:AsH3(100%),AsH3(1%),PH3(100%),Si2H6,C2H6Zn
- 設備ID
- IT-011
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- Ultratech/CamnbridgeNanotech (Ultratech/CamnbridgeNanotech)
- 型番
- FijiF20
- 仕様・特徴
- ロードロック機構付
プラズマ式/サーマル式の両方のモードでの原子層堆積が可能。化合物半導体等のMIS構造での低界面準位密度などに実績あり。(成膜温度で揮発し、装置を汚染する可能性のある材料は禁止) 酸素源:オゾンおよび水の両方の利用が可能
"東京工業大学"で検索した結果 34件
- 34件中 1~10件
- 1
- 2
- 3
- 4
- >