共用設備検索結果
赤外線ランプ加熱炉(RTA) (RTA Furnace)
- 設備ID
- AT-089
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- アドバンス理工 (ADVANCE RIKO)
- 型番
- RTP-6S
- 仕様・特徴
- ・型式:RTP-6S
・試料サイズ:小片~4インチφ
・到達真空度:-4乗Pa台
・加熱方式: 試料上面より放物面反射赤外線輻射加熱方式
・加熱制御方式:プログラム起電力比較クローズドループ・コントロール方式(PID3項制御)
・加熱範囲:150 mmφ
・温度範囲:RT~1000℃
・最大加熱速度:20℃/sec(SiCサセプタ使用時は10℃/sec)
・均熱精度:ΔT=10℃(@700℃保定時 N2ガスフロー中)
・温度センサ:熱電対(シースR熱電対)
・雰囲気 ガス:N2, Ar, O2
高圧ジェットリフトオフ装置 ((High Pressure Jet Lift-off Equipment)
- 設備ID
- AT-092
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- カナメックス (Kanamex)
- 型番
- KLO-150CBU
- 仕様・特徴
- ・型式:KLO-150CBU
・試料サイズ:小片20mm□~150mmφ
・回転数:0~2000rpm
・NMP処理温度:80℃
高速電子ビーム描画装置(エリオニクス) (Electron Beam Lithography System (Elionix))
- 設備ID
- AT-093
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-F130AN
- 仕様・特徴
- ・型式:LS-F130AN
・試料サイズ:~12インチφ、9インチ□のマスクブランクス
・電子銃:ZrO/W熱電界放射型
・加速電圧:130kV, 100kV, 50kV, 25kV
・最小ビーム径:1.7nm (@ 130kV)
・最小描画線幅:5nm (@ 130kV)
・最大スキャンクロック:100MHz
・ビーム電流強度:5pA~100nA
・フィールドサイズ:100μm □、250μm□、500μm□、1000μm□(100kV以下)、1500μm□(50kV以下)、3000μm□ (25kV以下)
・ビームポジション:1,000,000×1,000,000 (20bit DAC)
・位置決め分解能:0.1nm
・つなぎ精度:±10nm
・重ねあわせ精度:±15nm
・描画可能エリア:210mm×210mm
解析用PC(CAD及び近接効果補正用) (PC (PEC and CAD))
- 設備ID
- AT-094
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- ジェニシス (GenISys)
- 型番
- BEAMER
- 仕様・特徴
- ・型式:BEAMER
・近接効果補正
・パターン分割処理
・輪郭分離処理
・PSFシミュレーション
RF-DCスパッタ成膜装置(芝浦) (RF-DC Sputter Deposition Equipment(Shibaura))
- 設備ID
- AT-095
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
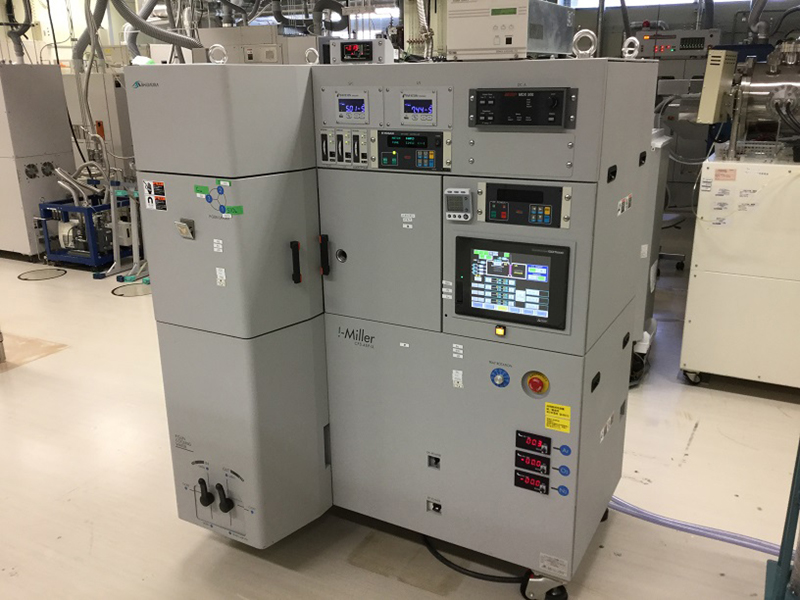
- メーカー名
- 芝浦メカトロニクス (SHIBAURA)
- 型番
- i-Miller
- 仕様・特徴
- ・型式:CFS-4EP-LL、i-Miller
・試料サイズ:8インチ
・スパッタ源:3インチマグネトロン×3式
・スパッタ方式:直流スパッタ、高周波スパッタ
・基板テーブル:回転機構付
・逆スパッタ:200W
・ターゲット-基板間距離:82 mm
・基板加熱:なし
・膜厚分布:±5%以内@膜厚~600nm(SiO2、170 mmφ)
・到達真空度:10-5 Pa台
・スパッタガス:Ar、O2、N2
・成膜時ガス圧(標準):0.5Pa
・常備ターゲット:Al, Al2O3, Au, Cr, Cu, Nb, Pt, SiO2, Ta, Ta2O5, Ti, TiN, TiO2, W
ECRスパッタ成膜・ミリング装置 (ECR sputter deposition and milling system)
- 設備ID
- AT-098
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
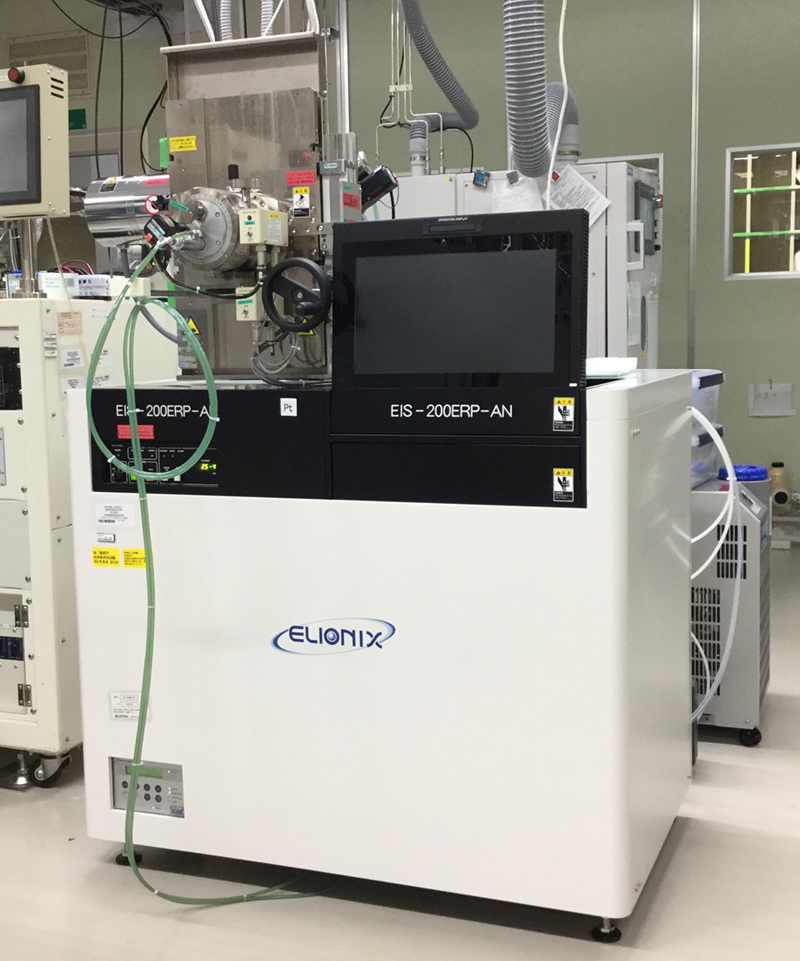
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- EIS-200ERP
- 仕様・特徴
- ・型式:EIS-200ERP
・試料サイズ:75 mmφ
・イオンソース:ECR方式
・ガス種:Ar (最大流量5sccm)
・圧力:0.01 Pa
・加速電圧:30~3000 V
・マイクロ波:最大100 W
・材料ターゲットサイズ:100 mmφ
サムコ原子層堆積装置_2[AD-100LP] (Atomic Layer Deposition_2〔AD-100LP〕)
- 設備ID
- AT-099
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
![サムコ原子層堆積装置_2[AD-100LP]](data/facility_item/AT-099.jpg)
- メーカー名
- サムコ (Samco)
- 型番
- AD-100LP
- 仕様・特徴
- ・型式: AD100-LP (サムコ株式会社)
・試料サイズ:4インチ(2インチは3枚まで搭載可能)
・ステージ温度:50 ~ 500℃
・放電方式: 誘導結合式ICPプラズマ(ダウンフロー型、リモート型)
・ICP高周波電源: 300W(13.56MHz)
・試料導入方式: ロードロック式
・キャリアガス:N2
・反応ガス:H2O, O2、ピュアオゾン, N2、NH3、H2、Ar
・材料ガス:TMA,BDEAS
Si深堀エッチング装置〔PlasmaPro_100〕 (Si Deep RIE)
- 設備ID
- AT-101
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
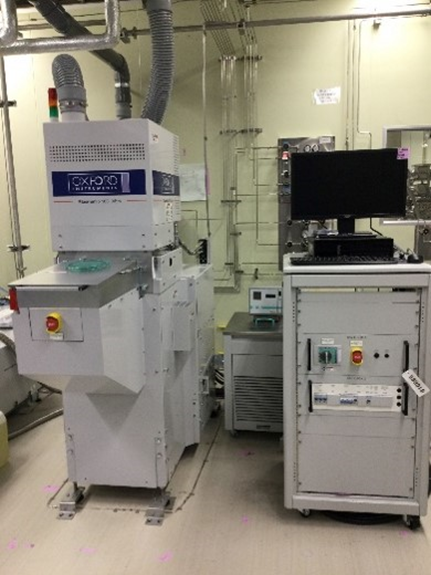
- メーカー名
- オックスフォードインスツルメント (Oxford Instruments Plasma)
- 型番
- PlasmaPro_100_Cobra
- 仕様・特徴
- ・型式:PlasmaPro_100_Cobra
・試料サイズ:4インチφ
・放電方式: 誘導結合式プラズマ(ICP)
・ICP高周波電源: 3kW(2 MHz)
・バイアス高周波電源: 300W(13.56MHz)、最小 15W
・試料導入方式: ロードロック式
・試料温度制御
・使用ガス: CF4, CHF3, SF6, C4F8, O2, Ar
原子層堆積装置_3〔FlexAL〕 (Atomic Layer Deposition_3〔FlexAL〕)
- 設備ID
- AT-102
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
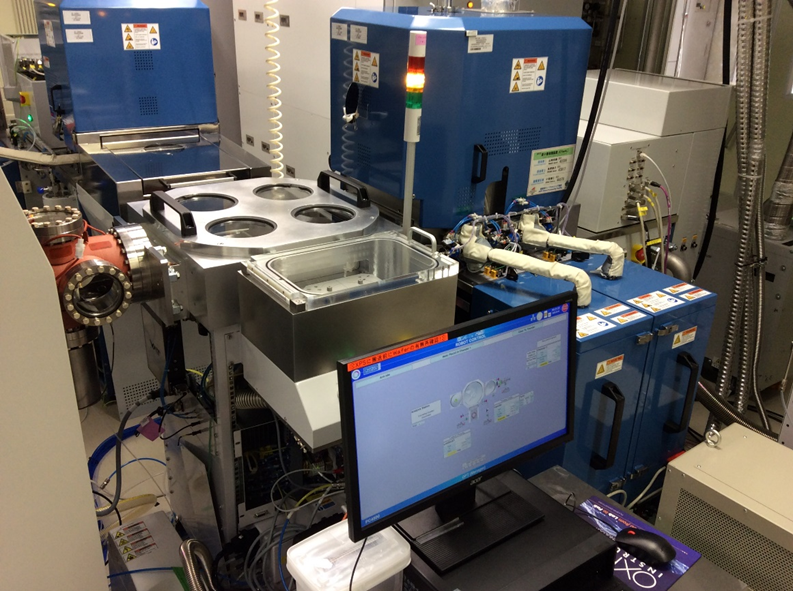
- メーカー名
- オックスフォードインスツルメント (Oxford Instruments Plasma)
- 型番
- FlexAL
- 仕様・特徴
- ・型式:FlexAL
・試料サイズ:4インチφ
・基板温度:100-550℃
・プラズマALD:600W(誘導結合型)
・基板バイアス:100W
・反応ガス:重水, O2, ピュアオゾン, N2, H2, D2, NH3, ND3
・材料ポート:8ポート
・キャリアガス:Ar
・表面分析用 in-situ XPS
・膜厚計測用 in-situ 分光エリプソ
原子層堆積装置_3付帯XPS装置(アルバック・ファイ) (X-ray Photoelectron Spectroscopy Analysis System (XPS))
- 設備ID
- AT-103
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
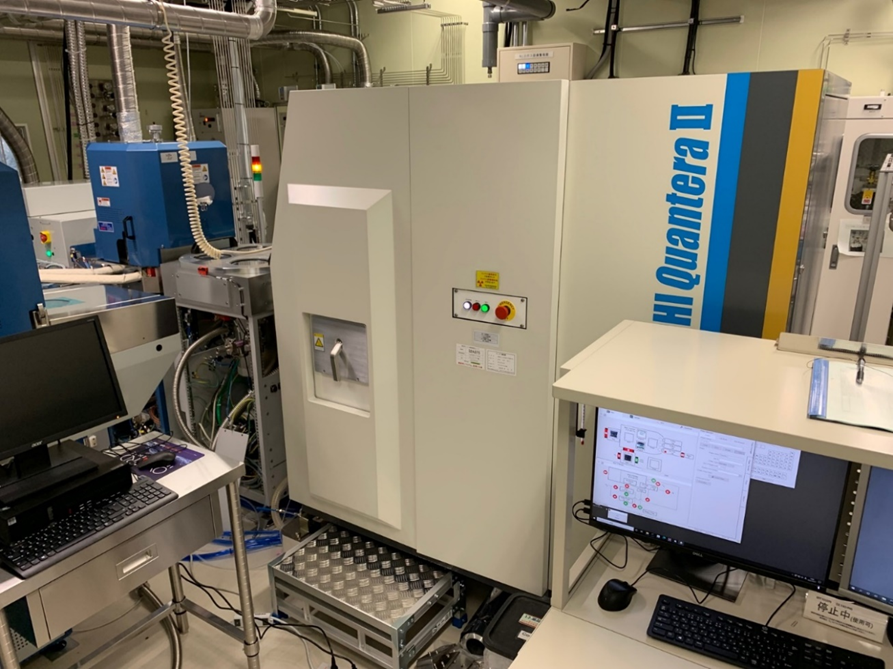
- メーカー名
- アルバック・ファイ (ULVAC-PHI,)
- 型番
- Quantera II
- 仕様・特徴
- ・型式:Quantera II
・試料サイズ:4インチφ
・X線源:単色化Al kα(ローランド直径 200 mm)
・光電子分光器:静電半球型(軌道直径279.4 mm)
・検出器:マルチチャネル検出器 (32 ch)
・スペクトル分析:0~1467 eV
・イメージング:最小ビーム径7.5μm, 最大走査範囲1.4 mmx1.4 mmのSXIイメージング
・最小スペクトル分析面積:7.5μmφ (20% - 80% knife edge法)
・エネルギ分解能:0.48 eV(Ag 3d5/2光電子ピーク半値幅)
・帯電中和:10 eV以下電子と5~10 eV Arイオン同時照射
・光電子取り出し角度:45°(標準)