共用設備検索結果
酸素窒素水素分析装置、炭素硫黄分析装置 (Oxygen/Nitrogen/Hydrogen Analyzer Carbon/Sulfur Analyzer)
- 設備ID
- NM-206
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- LECOジャパン合同会社 (LECO JAPAN CORPORATION)
- 型番
- ONH836CS844
- 仕様・特徴
- 酸素・窒素・水素解析部はインパルス加熱/赤外線検出方式及び熱伝導度検出方式である。
分析範囲:[酸素]10 ppm~3%,
[窒素]10 ppm~3%(試料重量1g時)
[水素]10 ppm~2500ppm(試料重量1g時)
炭素・硫黄解析部は高周波加熱炉/赤外線検出方式である。
分析範囲:[炭素]10 ppm~6%,
[硫黄]10 ppm~6%
(試料重量1g時)
電界放出形電子線プローブマイクロアナライザー装置 (Field Emission Electron Probe Micro-Analyzer (FE-EPMA))
- 設備ID
- NM-207
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
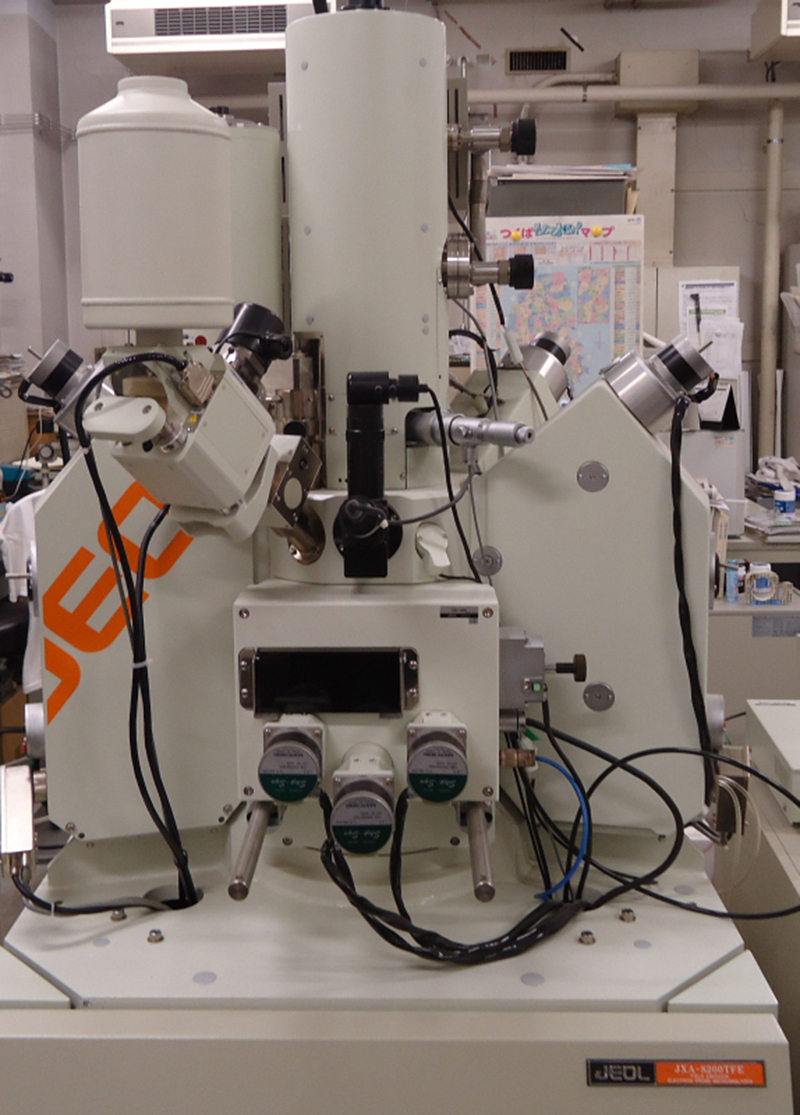
- メーカー名
- 日本電子 (JEOL)
- 型番
- JXA-8500F
- 仕様・特徴
- ・電界放出形電子銃
・加速電圧:1~30 kV
・照射電流:10 pA ~500 nA
・測定可能元素:Be~U
・最大試料サイズ:100 x 100 x 20 mm
走査型オージェ電子分光分析装置 (Scanning Auger Electron Microprobe (CHA Type AES))
- 設備ID
- NM-208
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
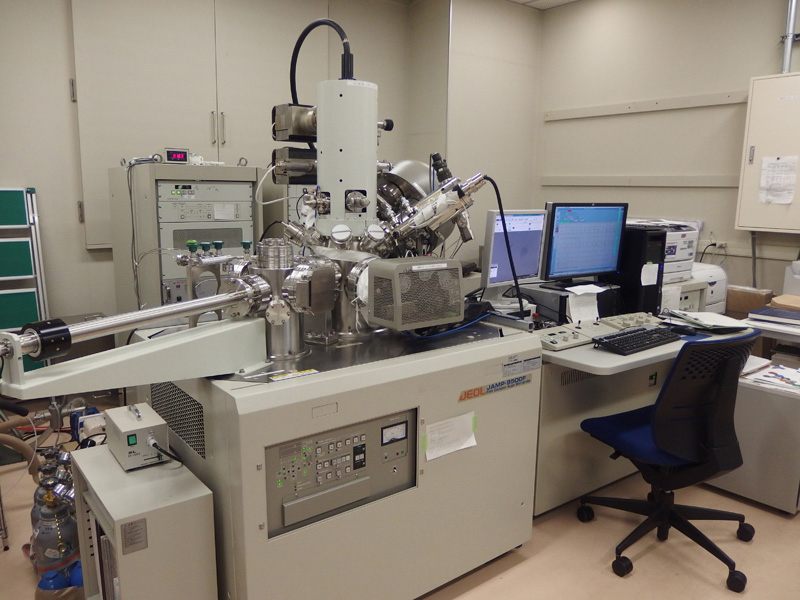
- メーカー名
- 日本電子 (JEOL)
- 型番
- JAMP-9500F
- 仕様・特徴
- ・ショットキー電界放射電子銃
・空間分解能:<8 nm
・加速電圧:0.5~30 kV
・照射電流:0.1~100 nA
・測定元素:Li~U
・最大試料サイズ:14 x 14 x 5 mm
・半球型アナライザー搭載
微細組織3次元マルチスケール解析装置 (Orthogonal FIB-SEM)
- 設備ID
- NM-302
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
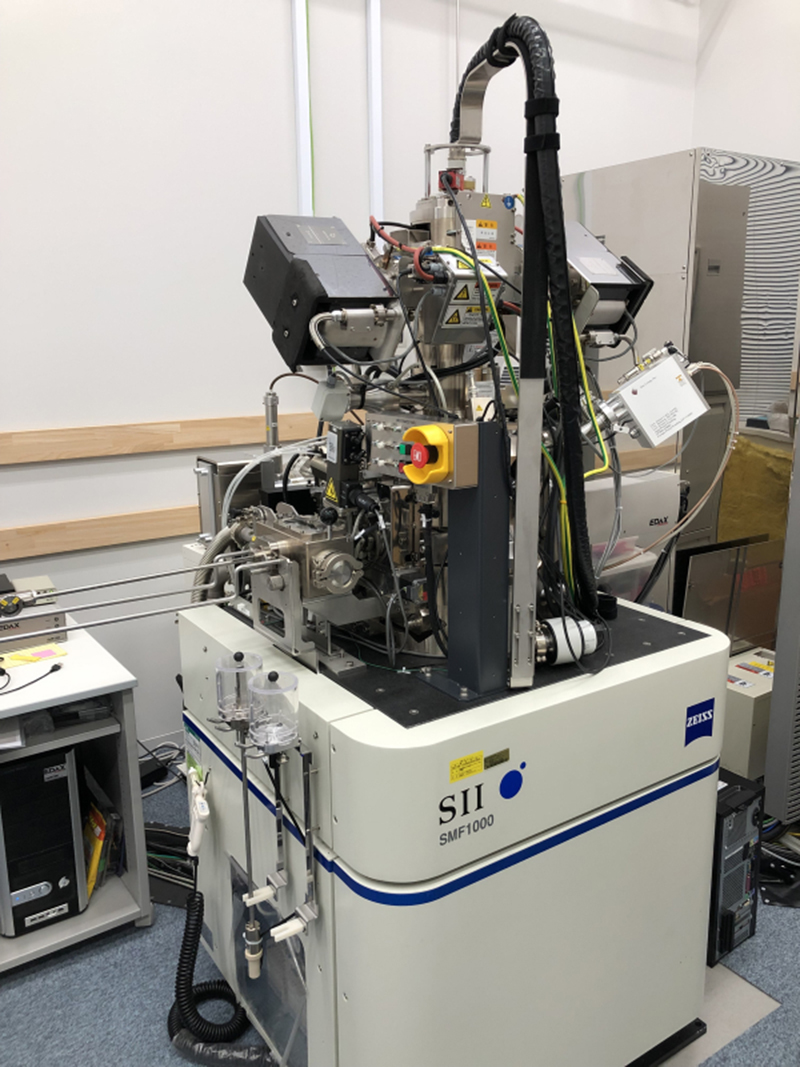
- メーカー名
- 日立ハイテク (Hitachi High-Tech)
- 型番
- SMF-1000
- 仕様・特徴
- 最高1nmピッチで制御可能で,加工と観察を繰り返すこと(シリアルセクショニング)で3D像再構築が可能.更にEBSDを併用した3D-EBSDやTEM試料作製も対応可能.
・SEM:ZEISS Gemini
・EDS:EDAX
・EBSD:EDAX TSL Hikari
・Ar-ion gun
・Depo. gas:Carbon
TEM試料自動作製FIB-SEM複合装置 (FIB-SEM combined apparatus for automatic preparation of TEM specimens)
- 設備ID
- NM-403
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- 日立ハイテク (Hitachi High-Tech)
- 型番
- NX5000
- 仕様・特徴
- ・FIB: Ga液体金属イオン源、加速電圧0.5-30kV、分解能4nm (30kV)、最大ビーム電流100nA
・SEM: 冷陰極電界放射型電子銃、加速電圧0.1-30kV、分解能0.7nm (15kV)、最大ビーム電流10nA
・低加速Arイオンビーム:加速電圧0.5-2kV、最大ビーム電流20nA
無損傷電子顕微鏡試料薄片化装置 (Damage-less TEM specimen milling apparatus)
- 設備ID
- NM-404
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
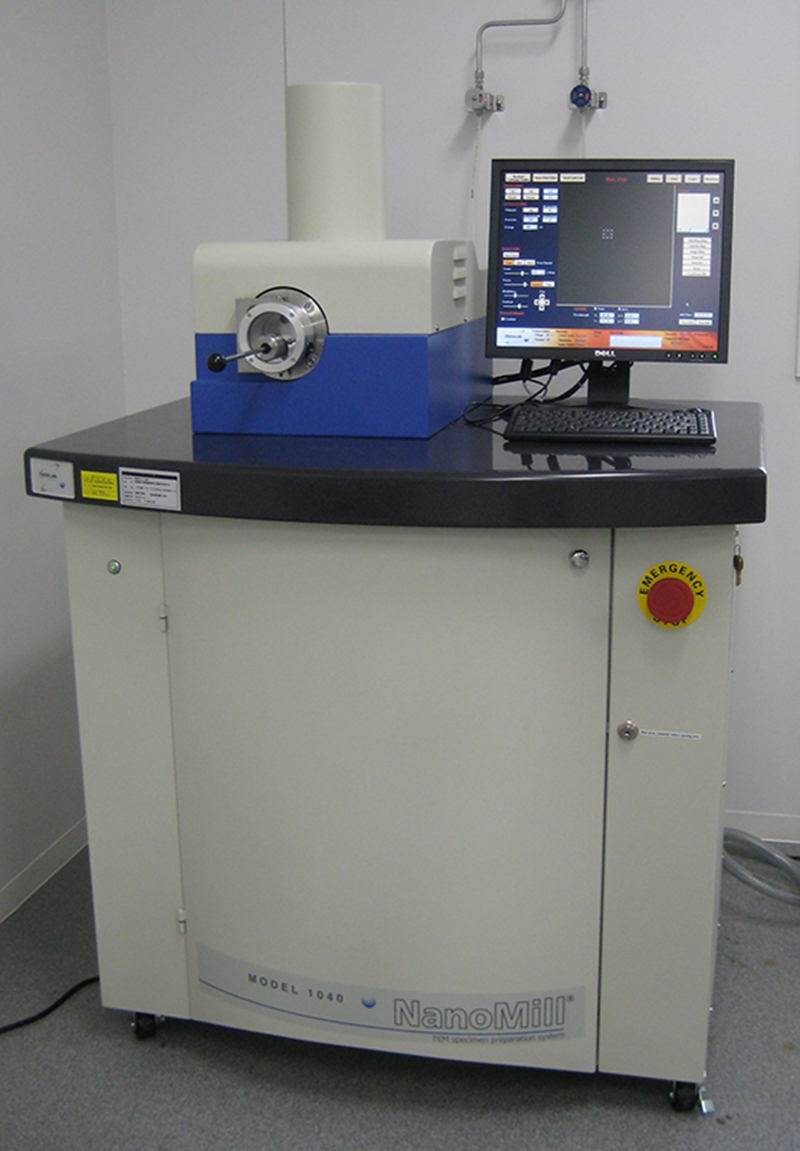
- メーカー名
- フィッシオーネ (Fischione)
- 型番
- Model 1040 Nanomill
- 仕様・特徴
- ・イオン:アルゴン
・イオンエネルギー:50~2000eV 可変
・イオン電流:1mA/cm2
・イオンビームサイズ:2μm
セラミックス試料作製装置群 (Ceramics sample preparation facilities)
- 設備ID
- NM-407
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- ガタン日立ハイテク真空デバイスマルトーTECHNOORG-LINDA (GatanHitachi High-TechVacuum DeviceMarutoTECHNOORG-LINDA)
- 型番
- 695PIPS II(精密イオン研磨装置)656 DimpleGrinder(ディンプルグラインダ)TM4000Plus II(卓上SEM)VES-30T(マルチコーター)ML-180 DoctorLap(卓上研磨機)MS2 MICROSAW(小型精密切断器)
- 仕様・特徴
- ・精密イオン研磨装置:イオンビームエネルギー: 0.1~8 keV、試料冷却が可能、観察用デジタルズームカメラ付属
・ディンプルグラインダ:研磨ホイール径 15 mm、研磨荷重 0~40 g、自動停止機構付属
・卓上SEM:加速電圧:5-20kV、二次電子検出器および反射電子検出器
・マルチコーター:蒸着、イオンスパッタ、親水化処理
・卓上研磨機:研磨回転数 50~500 rpm
・小型精密切断器:50mmダイヤモンド回転刃
実動環境対応物理分析電子顕微鏡 (Real working environment physical characterization TEM)
- 設備ID
- NM-501
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- 日本電子 (JEOL)
- 型番
- JEM-ARM200F-G
- 仕様・特徴
- ・照射系レンズ収差補正、結像系レンズ収差補正
・ショットキーFEG
・加速電圧: 80, 120, 200 kV
・TEM, STEM, EDS, EELS, 電子線ホ口グラフイー, 電子線トモグラフィー
実動環境対応電子線ホログラフィー電子顕微鏡 (Real working environmental electron holography microscope)
- 設備ID
- NM-502
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- 日本電子 (JEOL)
- 型番
- JEM-ARM200F-B
- 仕様・特徴
- ・照射系レンズ収差補正、結像系レンズ収差補正
・Cold FEG
・加速電圧: 60, 80, 200 kV
・TEM, STEM, EDS, EELS, 電子線ホ口グラフイー, 電子線トモグラフィー
200kV電界放出形透過電子顕微鏡(JEM-2100F1) (200kV field emission transmission electron microscope)
- 設備ID
- NM-503
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
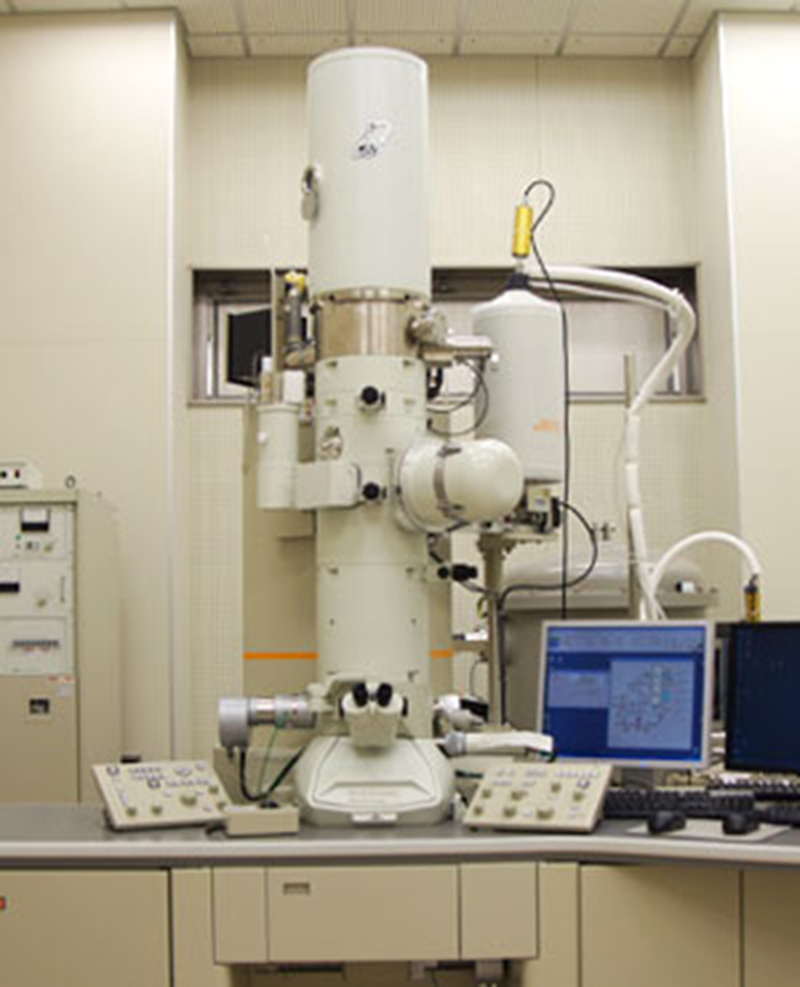
- メーカー名
- 日本電子 (JEOL)
- 型番
- JEM-2100F1
- 仕様・特徴
- ・ショットキーFEG
・加速電圧: 100, 120, 200 kV
・TEM, STEM, EDS, EELS, 電子線トモグラフィー