共用設備検索結果
FIB/SEM精密微細加工装置(Helios 650) (FIB/SEM microfabrication instrument)
- 設備ID
- NM-517
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
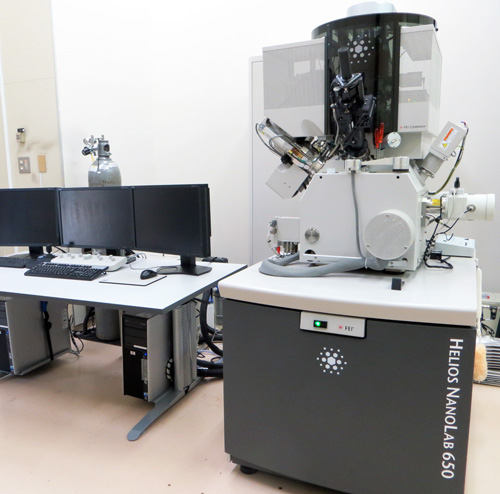
- メーカー名
- 日本エフイー・アイ株式会社 (FEI Company Japan Ltd.)
- 型番
- Helios 650
- 仕様・特徴
- 1. SIM像分解能5nm(@30kV)、最大電流65nA
2. SEM像分解能1.5nm(@1kV)、最大電流26nA
3. E-beam: 350V~30 kV、I-Beam: : 500V~30 kV
4. 試料ステージ: XY150 mm、Z10 mm、T: -9°~+57°、R: 360°
5. Ptデポ
6. サンプルリフトアウトシステム
【特徴】
1.集束イオンビーム(FIB)加工が可能 2.走査型電子顕微鏡(SEM)観察が可能 3.カラム内で加工薄片をリフトアウト(マイクロサンプリング)可能
卓上型X線回折計_Cu_SMF (pXRD_Cu_SMF)
- 設備ID
- NM-215
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- リガク (Rigaku)
- 型番
- MiniFlex600_Cu
- 仕様・特徴
- ・X線発生装置:最大出力0.6 kW
・X線波長:Cu Kα
・X線検出器:1次元型半導体式
卓上型粉末回折計_Cr_SCR (pXRD_Cr_SCR)
- 設備ID
- NM-214
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- リガク (Rigaku)
- 型番
- MiniFlex600_Cr
- 仕様・特徴
- ・X線発生装置:最大出力0.6 kW
・X線波長:Cr Kα
・X線検出器:1次元型半導体式
卓上型粉末回折計_Cu_ASC_NC2 (pXRD_Cu_ASC_NC2)
- 設備ID
- NM-213
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- リガク (Rigaku)
- 型番
- MiniFlex600_Cu
- 仕様・特徴
- ・X線発生装置:最大出力0.6 kW
・X線波長:Cu Kα
・試料部:試料水平型
・X線検出器:1次元型半導体式
・6連自動試料交換機
卓上型粉末回折計_Cu_ASC_NC1 (pXRD_Cu_ASC_NC1)
- 設備ID
- NM-212
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- リガク (Rigaku)
- 型番
- MiniFlex600_Cu
- 仕様・特徴
- ・X線発生装置:最大出力0.6 kW
・X線波長:Cu Kα
・試料部:試料水平型
・X線検出器:1次元型半導体式
・6連自動試料交換機
高速・高感度型粉末X線回折装置_Cu_ASC_NS3 (pXRD_Cu_ASC_NS3)
- 設備ID
- NM-211
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
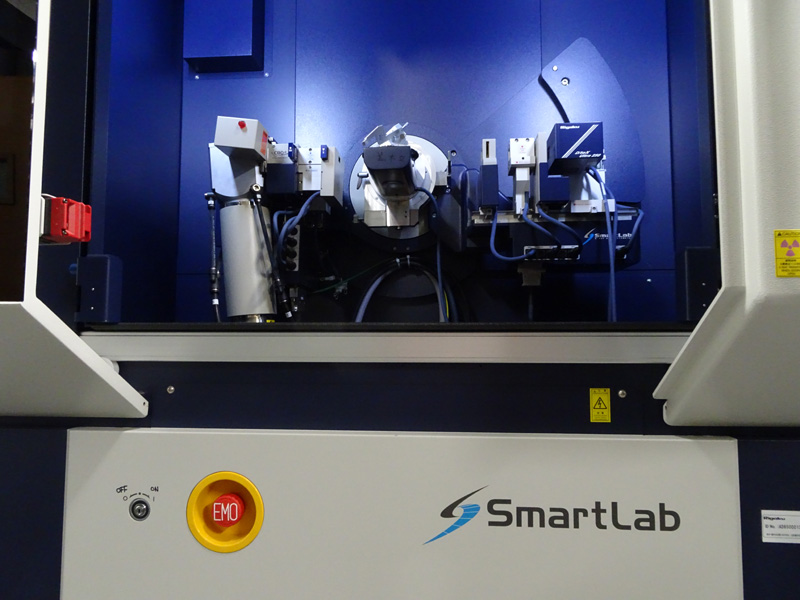
- メーカー名
- リガク (Rigaku)
- 型番
- SmartLab3
- 仕様・特徴
- ・X線発生装置:最大出力3.0 kW
・X線波長:Cu Kα
・X線検出器:1次元型半導体式
・試料部:試料水平型
・6もしくは48連自動試料交換機
温度可変型粉末X線回折装置_Cu1_NTS (pXRD_LT/HT_Cu1_R_NTS)
- 設備ID
- NM-210
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像

- メーカー名
- リガク (Rigaku)
- 型番
- SmartLab 9 kW with cryostat/furnace
- 仕様・特徴
- ・高輝度X線発生装置:最大出力9 kW
・X線波長:Cu Kα1
・X線検出器:高性能1次元型半導体検出器(D/teX ULTRA 250)
・試料部:試料水平型
・低温装置:2.6 K~室温(真空)
・高温装置:室温~1500℃(空気、He、N2、O2、Ar、真空)
2波長Pilatus低温単結晶X線回折装置_NSC (sXRD_R_DW_LT_Pilatus_NSC)
- 設備ID
- NM-209
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
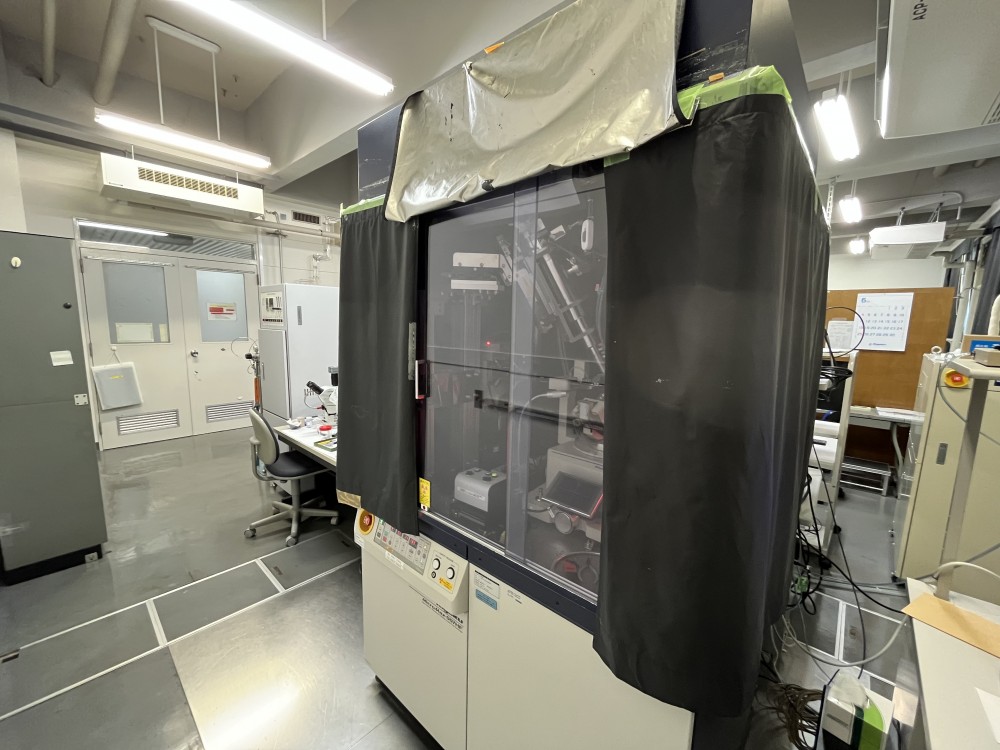
- メーカー名
- リガク (Rigaku)
- 型番
- VariMax DW AFC11 with Pilatus
- 仕様・特徴
- ・X線波長:MoもしくはCu(自動切り替え)
・高輝度X線源:試料部輝度 31 kW/mm2
・X線検出器:高感度・低ノイズ型半導体検出器PILATUS200K
・角度分解能可変:カメラ長 40~115 mm
・30 K迄の極低温でのデータ収集が可能
分光エリプソメーター [UNECS-2000A] (Spectroscopic Ellipsometer [UNECS-2000A])
- 設備ID
- NM-663
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![分光エリプソメーター [UNECS-2000A]](data/facility_item/1709196827_11.jpg)
- メーカー名
- アルバック (ULVAC)
- 型番
- UNECS-2000A
- 仕様・特徴
- 1. 光源:ハロゲンランプ
2. 波長範囲:530~750 nm
3. スポット径:1mm
4. 入射角:70°固定
5. 試料サイズ:最大φ200mm
低ダメージ精密エッチング装置 [Spica] (ICP-RIE [Spica])
- 設備ID
- NM-662
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![低ダメージ精密エッチング装置 [Spica]](data/facility_item/1707787439_11.jpg)
- メーカー名
- 住友精密工業 (Sumitomo Precision Products)
- 型番
- Spica
- 仕様・特徴
- プラズマ励起方式:誘導結合型
ICP出力:最大1kW
バイアス出力:最大300W
フッ素系ガスユニット:CHF3, CF4, C4F8, SF6, Ar, O2, N2
塩素系ガスユニット:Cl2, SiCl4, SF6, Ar, O2, N2
試料ステージ温度:10℃~30℃
最大試料サイズ:6インチΦ