共用設備検索結果
中分類から探す
表示件数
高輝度放射光XAFSシステム (XAFS measuring station)
- 設備ID
- AE-003
- 設置機関
- 日本原子力研究開発機構(JAEA)
- 設備画像

- メーカー名
- カスタム (Home-made)
- 型番
- なし
- 仕様・特徴
- 試料中の特定元素の原子価や局所構造を決定
・エネルギー範囲:4~72keV
・測定方法:通常の透過法/微量元素用の蛍光法、通常のStepScan/高速計測対応(QuickScan)
・試料:少量核燃物質、国際規制物資、RI・アクチノイド試料
・KBミラーによる数十μm程度の空間分解能
・クライオスタットによる低温測定
・電気炉による高温測定
- 設備状況
- 稼働中
カッパ型多軸回折計 (κ-type X-ray diffractometer)
- 設備ID
- AE-005
- 設置機関
- 日本原子力研究開発機構(JAEA)
- 設備画像

- メーカー名
- ニューポート (Newport)
- 型番
- 特注
- 仕様・特徴
- 通常の回折計のような6軸に加え回転軸を持ち表面の構造解析も可能
・長い2thetaアーム(による高分解能性
・堅牢な回折計
・広いオープンスペースによる試料選択の柔軟性
・試料温度:10-1000K
・試料:固体(誘電体、非晶質)や薄膜
・電気化学同時測定
- 設備状況
- 稼働中
エネルギー分散型XAFS装置 (Energy-dispersive XAFS measuring station)
- 設備ID
- AE-006
- 設置機関
- 日本原子力研究開発機構(JAEA)
- 設備画像
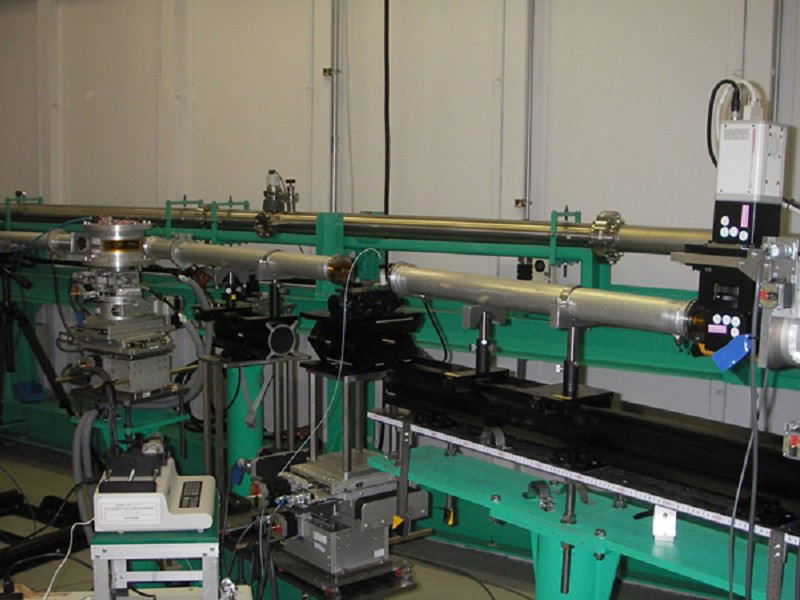
- メーカー名
- カスタム (Home-made)
- 型番
- なし
- 仕様・特徴
- 元素の局所構造・電子状態を時間分解観測
・観測可能元素:Ti以上
・温度:20-1000 K
・測定レート:最大100 Hz
・ガスフロー制御システムあり
・ポテンシオスタットによる電気化学測定可能
- 設備状況
- 稼働中
軟X線光電子分光装置 (Soft X-ray photoelectron spectrometer)
- 設備ID
- AE-007
- 設置機関
- 日本原子力研究開発機構(JAEA)
- 設備画像

- メーカー名
- カスタム(電子分析アナライザー: VG Scienta) (Home-made (Electron Analyzer: VG Scienta))
- 型番
- 電子分析アナライザー: SES-2002
- 仕様・特徴
- 角度分解光電子分光(ARPES)測定も可能な光電子分光装置。希土類及び3d遷移金属化合物の詳細な電子構造を調べることができる。
・光エネルギー:400-1500 eV
・エネルギー分解能:50-200 meV
・試料温度:6-300 K
- 設備状況
- 稼働中
硬X線光電子分光装置 (Hard X-ray photoelectron spectrometer)
- 設備ID
- AE-008
- 設置機関
- 日本原子力研究開発機構(JAEA)
- 設備画像

- メーカー名
- シエンタオミクロン社 (Scienta Omicron, Inc.)
- 型番
- 光電子アナライザー: EW4000-10keV
- 仕様・特徴
- 硬X線を励起光として用いることで、バルク敏感な電子状態の観測ができる。
・励起光エネルギー:6, 8, 10keV選択可能
・KBミラーによる数十μm程度の空間分解能
・試料温度:RT-900K
・中和銃による絶縁物測定
- 設備状況
- 稼働中
走査型透過X線顕微鏡 (Scanning Transmission X-ray microscopy apparatus)
- 設備ID
- AE-009
- 設置機関
- 日本原子力研究開発機構(JAEA)
- 設備画像
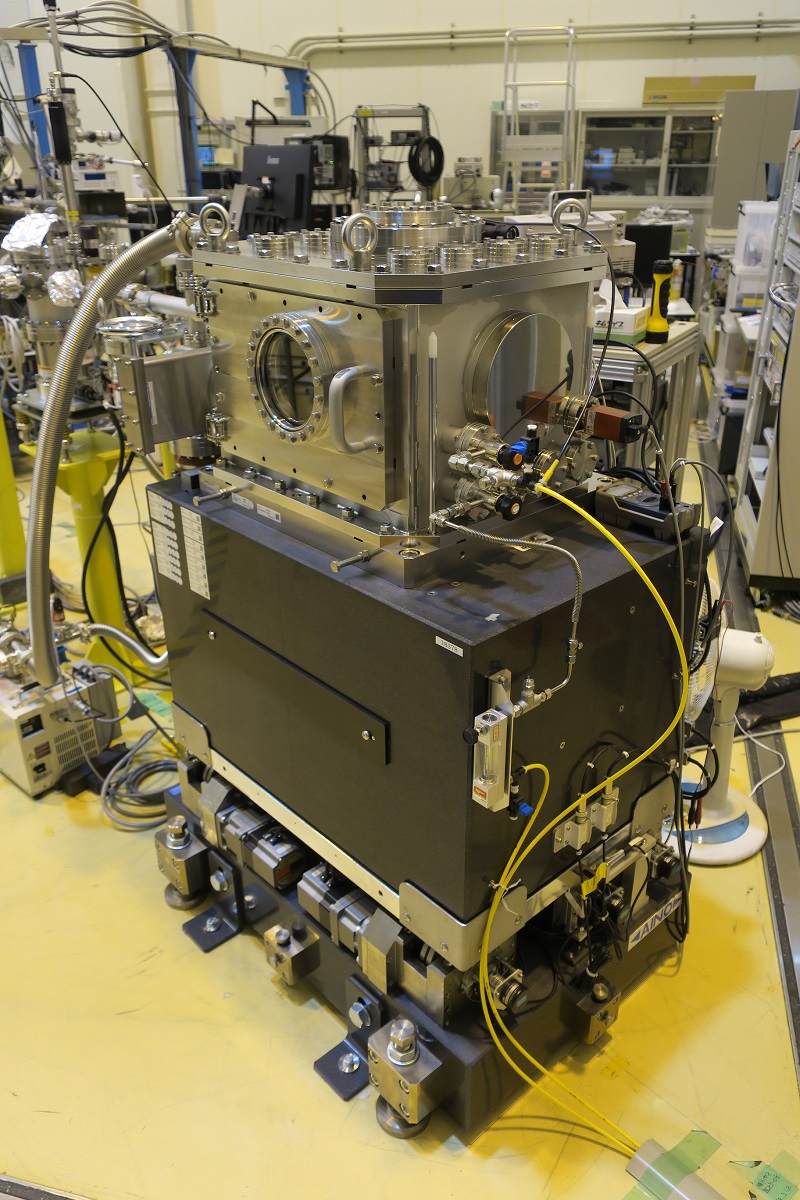
- メーカー名
- カスタム (Home-made)
- 型番
- なし
- 仕様・特徴
- N, OのK吸収端, および遷移金属L2,3吸収端、希土類M4,5吸収端など、400~1900eVに吸収端のある元素の実空間2次元マッピングが可能で、場所ごとの吸収スペクトルを得ることができる。
・空間分解能:~50 nm
・試料温度:室温のみ
・検出方法:透過法のみ
- 設備状況
- 稼働中
表面化学実験ステーション (Surface chemistry experimental apparatus)
- 設備ID
- AE-010
- 設置機関
- 日本原子力研究開発機構(JAEA)
- 設備画像

- メーカー名
- オミクロン (Scienta Omicron, Inc.)
- 型番
- Hipp-3
- 仕様・特徴
- "表面界面の電子状態の精密分析や時分割観察が可能
・高輝度・高エネルギー分解能高輝度軟X線放射光(400~1700eV)
・複合表面分析(LEED、Arスパッター、SPM、蒸着(実績:Hf、Ge、Cs、Auなど)
・超高真空(2×10-8Pa)~ガス雰囲気(10-3Pa)
室温~1150℃加熱中の光電子分光観察
・材料プロセスの時分割観察、超音速分子線を使った反応ダイナミクス
・測定試料:半導体(Si、Ge、SiC、GaN etc)、金属(Cu、Ni、各種合金)、グラフェン等の新材料、ナノ粒子、機能物質など。単結晶、多結晶、アモルファス、薄膜等の固体試料
・導入ガス:酸素、水素、水、ギ酸、一酸化窒素、メタン、エタン、塩化メチル、NO2、COなど"
- 設備状況
- 稼働中
電界放出形走査電子顕微鏡[S4800_FE-SEM] (Field Emission SEM〔S4800/FE-SEM, HITACHI〕)
- 設備ID
- AT-004
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
![電界放出形走査電子顕微鏡[S4800_FE-SEM]](data/facility_item/1651474199_14.jpg)
- メーカー名
- 日立ハイテクノロジーズ (Hitachi High-Tech)
- 型番
- S4800
- 仕様・特徴
- ・型式:S-4800
・試料サイズ:15~150 mmφ
・電子銃:冷陰極電界放出型電子銃
・加速電圧:0.5~30 kV
・分解能:1.0 nm(加速電圧15 kV, WD = 4 mm)
・試料ステージ制御:5軸モーター制御
・可動範囲:X,Y:0~110 mm、Z:1.5~40 mm、R:360°、T:-5~70°
・検出器:2次電子検出器、エネルギー分散型X線検出器(EDX)
- 設備状況
- 稼働中
低真空走査電子顕微鏡 (Low Vacuum SEM (HITACHI))
- 設備ID
- AT-005
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- 日立ハイテクノロジーズ (Hitachi High-Tech)
- 型番
- S-3500N
- 仕様・特徴
- ・型式:S-3500N(日立ハイテク)
・試料サイズ:15~150 mmφ
・電子銃:熱電子放出型Wヘアピンフィラメント
・加速電圧:0.3~30 kV
・分解能:高真空二次電子像:3.0 nm
・低真空反射電子像:5 nm
・低真空モードでの真空度設定:1~270 Pa
・試料ステージ:五軸モーター駆動
・可動範囲:100 mm×50 mm
・元素分析:エネルギー分散型X線検出器(EDX)
- 設備状況
- 稼働中
マスクレス露光装置 (Maskless Lithography System)
- 設備ID
- AT-006
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- ナノシステムソリューション (Nano System-Solutions)
- 型番
- DL1000
- 仕様・特徴
- ・型式:DL1000
・試料サイズ:4インチφ、100mm□
・光源:波長405nm(LED)
・露光最小画素:1μm□
・最大露光領域:100mm□
・重ね合わせ精度:±1μm
- 設備状況
- 稼働中