共用設備検索結果
表示件数
超高精度電子ビーム描画装置 (Ultra high precision electron beam lithography system)
- 設備ID
- RO-111
- 設置機関
- 広島大学
- 設備画像
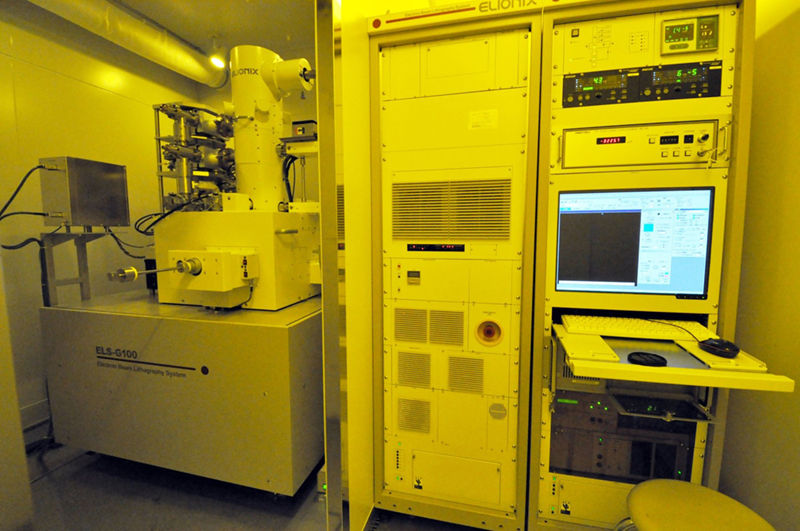
- メーカー名
- エリオニクス (Elionix)
- 型番
- ELS-G100
- 仕様・特徴
- 試料サイズ:2~6インチ直径の定型ウエハ
加速電圧:100kV,50kV, 25kV
電子ビームの最小スポットサイズ:ビーム電流1nAにおいて2.0nm以下
最小線幅:6nm
- 設備状況
- 稼働中
マスクレス露光装置 (Maskless photolithography system)
- 設備ID
- RO-112
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- 株式会社ナノシステムソリューションズ (NanoSystem Solutions, Inc.)
- 型番
- DL-1000
- 仕様・特徴
- 対応wafer:2~4inch、cut wafer他
DMDを用いたレーザー露光装置
最小画素:1μm
- 設備状況
- 稼働中
マスクレス露光装置 (Maskless photolithography system)
- 設備ID
- RO-113
- 設置機関
- 広島大学
- 設備画像
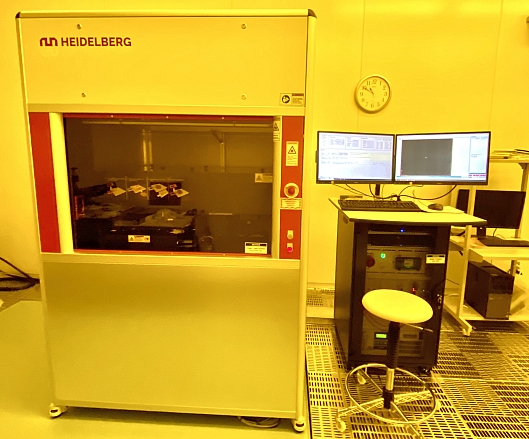
- メーカー名
- ハイデルベルグ・インストルメンツ (Heidelberg Instruments)
- 型番
- MLA150
- 仕様・特徴
- 対応wafer:2~6inch、cut wafer他
DMDを用いたレーザー露光装置
レーザ光源:375nm 7.2W 最小画素:1μm
- 設備状況
- 稼働中
スピンコータ (Spin Coater)
- 設備ID
- RO-121
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- タツモ(株) (TAZMO)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
レジスト塗布
- 設備状況
- 稼働中
プログラム・ホットプレート (Program hot plate)
- 設備ID
- RO-122
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- アズワン株式会社 (AS ONE)
- 型番
- EC-1200NP
- 仕様・特徴
- ・16ステップ以内のプログラムを4パターン記憶
・制御可能温度範囲:室温+50 ~ 300℃
・プレート面積:412*312mm
- 設備状況
- 稼働中
インビトロシェーカー (inVitro shaker)
- 設備ID
- RO-123
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- タイテック株式会社 (TAITEC CORPORATION)
- 型番
- Wave-PR2
- 仕様・特徴
- ・振とう方式:波動形揺動(マイルド振とう)
・振とう速度/角度:5~50r/min、2~6°
・架台有効寸法:300×200mm
- 設備状況
- 稼働中
レイアウト設計ツール (Mask layout design tool)
- 設備ID
- RO-131
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- Tanner (Tanner)
- 型番
- L-Edit
- 仕様・特徴
- リソグラフィマスク設計用レイアウトエディター
IC,MEMSデバイス設計用ソフト。Tanner社L-Edit
- 設備状況
- 稼働中
MEMS設計ツール(IntelliSuite) (MEMS design tools)
- 設備ID
- RO-132
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- インテリセンス (IntelliSense)
- 型番
- IntelliSuite
- 仕様・特徴
- 工程データ、フローデータ、材料データ、2Dマスクデータ、3Dモデルデータの利活用に有効。
- 設備状況
- 稼働中
高温イオン注入装置 (Ion implanter)
- 設備ID
- RO-212
- 設置機関
- 広島大学
- 設備画像
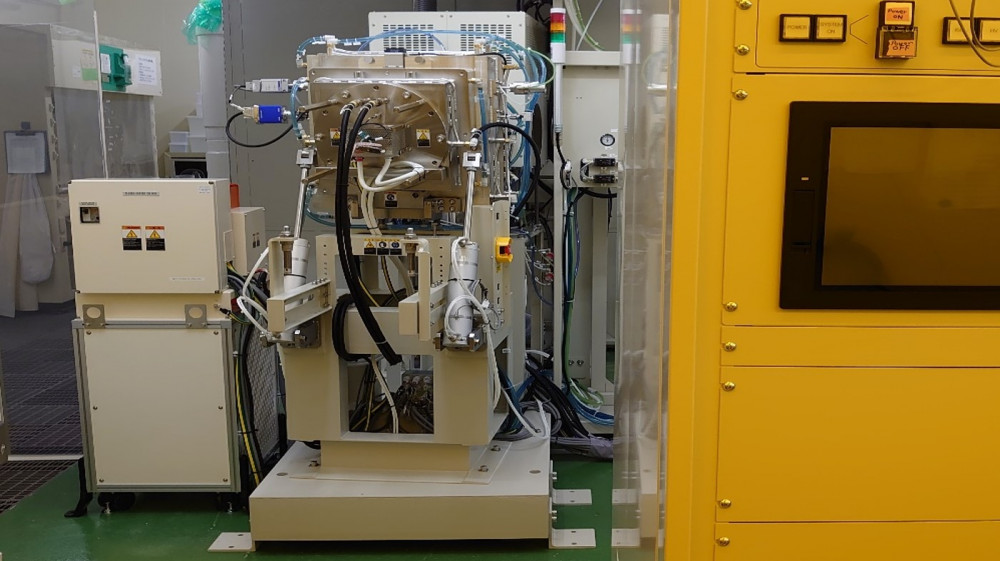
- メーカー名
- アルバック (ULVAC, Inc.)
- 型番
- IMX-3500(手動高温仕様)
- 仕様・特徴
- 対応wafer:~6inch、cut wafer
温度:常温、200~500℃、 加速電圧:10~200kV、
最大ビーム電流:100μA以上(@B+、P+)、
:10μA以上(@Al+)
Al,B,As,P,F,BF2,Ar,(Si,N,He) 等注入可能
- 設備状況
- 稼働中
酸化炉 (Oxidation furnaces)
- 設備ID
- RO-221
- 設置機関
- 広島大学
- 設備画像
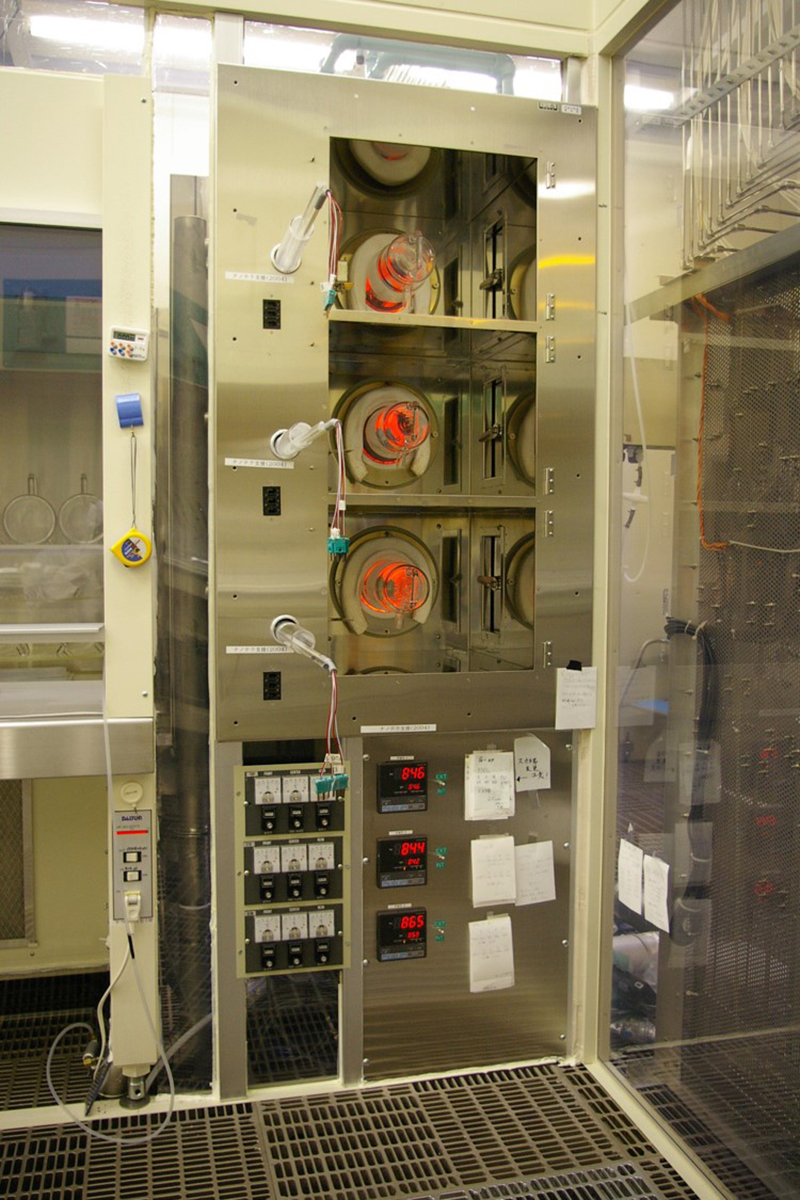
- メーカー名
- 東京エレクトロン (Tokyo Electron)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
最高使用温度1150℃
ドライ酸化、パイロジェニック酸化
- 設備状況
- 稼働中